Условные обозначения полевых транзисторов
В электронике полевым транзистором называется электронный компонент, в котором ток проходящий через канал регулируется электрическим полем, образующимся в результате подачи напряжения между его истоком и затвором. Основным отличием полевого транзистора от транзистора биполярного является то, что выходное и входное сопротивление у него существенно выше.
Плевые транзисторы нередко именуют униполярными, поскольку основным принципом их действия является перемещение при помощи поля носителей зарядов одного и того же типа. Конструктивно эти приборы представляют собой изготовленные из полупроводниковых материалов пластинки одного типа проводимости, на противоположных сторонах которых способом диффузии создается область другого типа проводимости. На их границах образуется обладающий большим сопротивлением p—n-переход.
В полевых транзисторах существуют области полупроводника которые называют каналами.
Структура полевого транзистора
с управляющим p—n-переходом и каналом n-типа
В случае, если между p-областью и n-областью приложить некоторое напряжение Uзи., как показано на рисунке выше, то p—n-переход окажется включенным в обратном направлении, следовательно его толщина увеличится, а толщины канала уменьшается. При этом принято p-область называть затвором Ucи., то через него начнёт протекать ток в направлении от нижнего к верхнему участку n-области. Часть этой области, от которой основные носители зарядов начинают свое движение, называется истоком, а та часть, по направлению к которой они перемещаются – стоком.
Что касается величины тока, который протекает через канал, то определяющим для нее является сопротивление. Оно, в свою очередь, напрямую зависит от толщины канала. Таким образом, если изменяется величина приложенного к каналу напряжения, то вслед за этим происходит изменение величины тока.
В тех случаях, когда для производства этого электронного компонента в качестве основы берут полупроводник p-типа, то получается полевой транзистор, имеющий канал р-типа и управляющий p—n-переход. Канал в нем образуется n-областью.
Структура и схема подключения МДП-транзистора
с индуцированным каналом
Полевые транзисторы с изолированным затвором
Помимо тех полевых транзисторов, которые имеют в своей конструкции управляющий затвор, имеются и такие, у которых он изолирован. В электронике для обозначения таких транзисторов используют аббревиатуры МДП (металл-диэлектрик-полупроводник). Соответственно, такие приборы называют
Соответственно, такие приборы называют МОП-транзисторами или МДП-транзисторами.
Для МДП—транзистора характерно то, что в нем между истоком и стоком располагается n-область, представляющая собой подложку. Поэтому образуется два p—n-перехода, которые включены навстречу друг другу. При этом вне зависимости от того, какую именно полярность имеет питающее напряжение, один из этих переходов всегда закрыт, так что в в направлении «исток-сток» ток равен нулю.
Если на затвор подается отрицательное напряжение, то ток в цепи начинает течь. Дело в том, что на расположенные в подложке электроны действует электрическое поле, и они начинают передвигаться вглубь нее.
Существует некоторое пороговое значение напряжения, при котором количество дырок, расположенных у самой поверхности подложки, становится существенно больше, чем электронов. В результате этого происходит так называемая инверсия типа электроповодности: она обретает p-тип.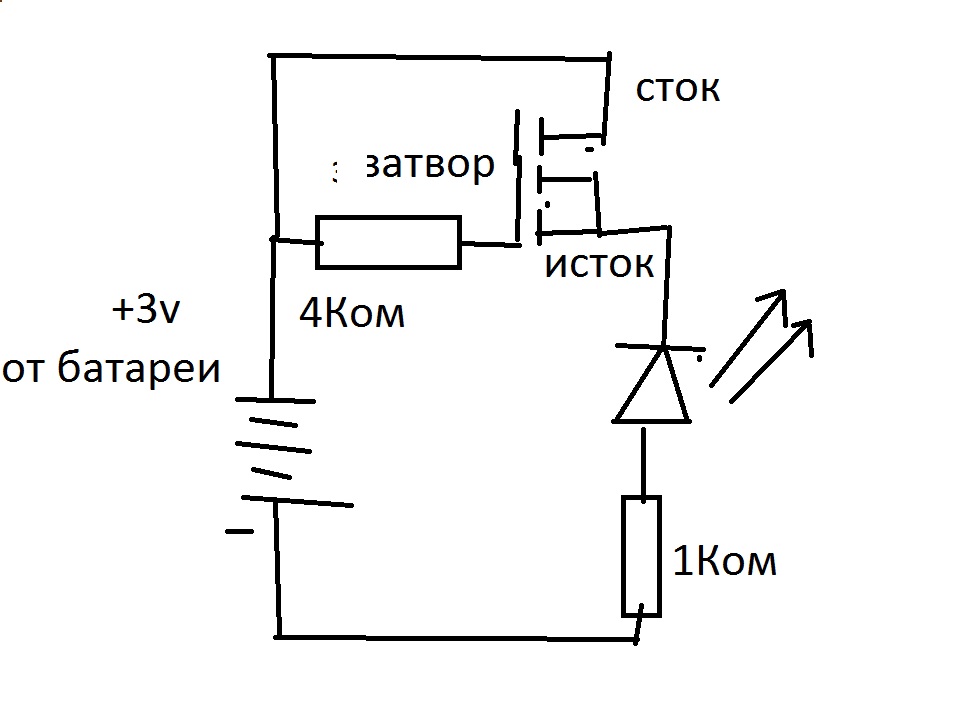 В результате этого между стоком и истоком получается канал, связывающий их. Его толщина зависит от того, какое именно значение имеет приложенное напряжение. Если изменять его, то можно регулировать и толщину канала, поскольку сопротивление участка, располагающегося между истоком и стоком, также будет изменяться.
В результате этого между стоком и истоком получается канал, связывающий их. Его толщина зависит от того, какое именно значение имеет приложенное напряжение. Если изменять его, то можно регулировать и толщину канала, поскольку сопротивление участка, располагающегося между истоком и стоком, также будет изменяться.
Обозначения полевых транзисторов на схеме
Разработка моста для режима жестких переключений на нитрид-галлиевых транзисторах Transphorm
16 июня 2017
Компания Transform произвела настоящую революцию в схемотехнике силовых преобразовательных устройств, представив на рынке мощные каскодные GaN-транзисторы на кремниевой подложке. Это позволило начать применение мостовых схем с жесткой коммутацией, в которых уменьшено и сопротивление в открытом состоянии, и емкость затвора, а КПД достигает 99%.
Согласно аналитическим прогнозам, мировой доход от продаж силовых полупроводниковых приборов (п/п), изготовленных по технологиям SiC (карбид кремния) и GaN (нитрид галлия), вырастет к 2025 году до 3,7 млрд. долларов США по сравнению с 210 млн. в 2015 году. Ожидается, что основными областями применения новых технологий будут электротранспорт, в том числе гибридные автомобили, а также источники питания и преобразователи напряжения (инверторы), работающие с фотоэлектрическими батареями. Возрастающий интерес к новым технологиям производства силовых п/п обусловлен требованиями увеличения КПД и удельной мощности силовых преобразователей. Например, использование GaN-транзисторов производства компании Transphorm в инверторе мощностью 4,5 кВт позволило уменьшить габариты устройства на 40% (рисунок 1) и повысить КПД с 96,5% до 98% по сравнению с инвертором на кремниевых МОП-транзисторах.
долларов США по сравнению с 210 млн. в 2015 году. Ожидается, что основными областями применения новых технологий будут электротранспорт, в том числе гибридные автомобили, а также источники питания и преобразователи напряжения (инверторы), работающие с фотоэлектрическими батареями. Возрастающий интерес к новым технологиям производства силовых п/п обусловлен требованиями увеличения КПД и удельной мощности силовых преобразователей. Например, использование GaN-транзисторов производства компании Transphorm в инверторе мощностью 4,5 кВт позволило уменьшить габариты устройства на 40% (рисунок 1) и повысить КПД с 96,5% до 98% по сравнению с инвертором на кремниевых МОП-транзисторах.
Рис. 1. Инверторы мощностью 4,5 кВт, изготовленные с использованием кремниевых и GaN-транзисторов
Показателем качества, характеризующим различные технологии изготовления высоковольтных ключей для силовой преобразовательной техники, является комбинация максимального напряжения (напряжения пробоя) и удельного сопротивления ключа в открытом состоянии.

Рис. 2. Показатели качества различных технологий изготовления высоковольтных транзисторов
Таблица 1. Сравнительные характеристики различных технологий производства силовых подупроводниковых ключей
| Наименование параметра | Технология производства силовых п/п-ключей | ||
| Si | 4H-SiC | GaN | |
| Максимальная напряженность электрического поля, 106 В/см | 3 | 30 | 30 |
| Подвижность носителей заряда, см2/В•с | 1500 | 700 | 2000 |
| Коэффициент теплопроводности, Вт/см•К | 1,5 | 4,5 | 1,5 |
Особенности применения GaN-транзисторов в мостовых схемах
Широкому применению GaN-транзисторов до недавнего времени препятствовали технологические трудности получения нитрид-галлиевых структур, а также инверсная логика управления – поскольку базовая структура GaN-транзистора является нормально открытым ключом.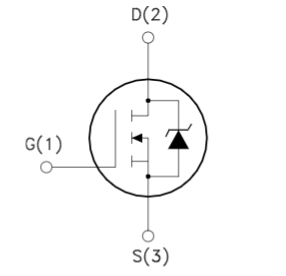 Силовые высоковольтные ключи производства компании Transphorm представляют собой каскодную структуру, состоящую из нормально-закрытого низковольтного МОП-транзистора и высоковольтного GaN-транзистора с высокой подвижностью электронов (рисунок 3). Благодаря этому для управления GaN-транзисторами Transphorm могут использоваться такие же драйверы затвора, как и для обычных транзисторов с изолированным затвором.
Силовые высоковольтные ключи производства компании Transphorm представляют собой каскодную структуру, состоящую из нормально-закрытого низковольтного МОП-транзистора и высоковольтного GaN-транзистора с высокой подвижностью электронов (рисунок 3). Благодаря этому для управления GaN-транзисторами Transphorm могут использоваться такие же драйверы затвора, как и для обычных транзисторов с изолированным затвором.
Рис. 3. Каскодный GaN-транзистор производства компании Transphorm: а) внутренняя структура; б) эквивалентная схема в виде нормально-закрытого ключа
Работа GaN-транзисторов в мостовой схеме без антипараллельных диодов
Особенность мощных кремниевых МОП-транзисторов – наличие в их структуре паразитного p-n-перехода, который при работе транзистора в мостовой схеме способен проводить ток в паузах между импульсами коммутации, то есть выполнять функции антипараллельного диода. Однако при прохождении тока через внутренний диод МОП-транзистора в его p-n-переходе происходит накопление неосновных носителей заряда, в результате чего при коммутации МОП-транзистора в цепи «сток-исток» образуются импульсы обратного тока восстановления диода. Эта проблема особенно актуальна в высоковольтных мостовых схемах, где паразитный внутренний диод МОП-транзистора при прямом прохождении тока накапливает значительный заряд, что приводит к большой амплитуде импульсов обратного тока и длительному времени рассасывания неосновных носителей в p-n-переходе внутреннего диода. В традиционных мостовых схемах, выполненных на транзисторах с изолированным затвором, параллельно внутреннему диоду устанавливают внешний быстродействующий антипараллельный диод (рисунок 4а), что увеличивает габариты печатной платы и стоимость изделия.
Эта проблема особенно актуальна в высоковольтных мостовых схемах, где паразитный внутренний диод МОП-транзистора при прямом прохождении тока накапливает значительный заряд, что приводит к большой амплитуде импульсов обратного тока и длительному времени рассасывания неосновных носителей в p-n-переходе внутреннего диода. В традиционных мостовых схемах, выполненных на транзисторах с изолированным затвором, параллельно внутреннему диоду устанавливают внешний быстродействующий антипараллельный диод (рисунок 4а), что увеличивает габариты печатной платы и стоимость изделия.
Рис. 4. Полумостовая схема: а) на обычных транзисторах с изолированным затвором; б) на и каскодных GaN-транзисторах Transp
В гибридных каскодных ключах производства компании Transphorm нитрид-галлиевый транзистор выполнен на основе чистого беспримесного полупроводникового материала, вследствие чего в нем отсутствует паразитный p-n-переход и в канале может протекать в обоих направлениях ток, состоящий только из основных носителей. При работе в мостовой схеме ток в паузе между импульсами коммутации протекает через паразитный диод внутреннего МОП-транзистора, однако инжектируемый в него заряд имеет малую величину благодаря низкому рабочему напряжению МОП-транзистора. Вследствие этого нитрид-галиевые транзисторы Transphorm с высокой подвижностью электронов (HEMT) представляют собой практически идеальные ключевые элементы для мостовых схем благодаря способности коммутировать ток в паузах между импульсами без использования дополнительных антипараллельных диодов (рисунок 4б).
При работе в мостовой схеме ток в паузе между импульсами коммутации протекает через паразитный диод внутреннего МОП-транзистора, однако инжектируемый в него заряд имеет малую величину благодаря низкому рабочему напряжению МОП-транзистора. Вследствие этого нитрид-галиевые транзисторы Transphorm с высокой подвижностью электронов (HEMT) представляют собой практически идеальные ключевые элементы для мостовых схем благодаря способности коммутировать ток в паузах между импульсами без использования дополнительных антипараллельных диодов (рисунок 4б).
На рисунке 5 показано протекание тока в каскодном GaN-транзисторе в трех режимах работы:
- При напряжении «сток-исток» VDS > 0 и напряжении на затворе больше порогового VGS > VTH транзистор открыт в прямом направлении (рисунок 5а). Падение напряжения «сток-исток» в прямом направлении протекания тока определяется формулой 1:
, (1)
где RDS(on),Si и RDS(on),GaN – сопротивление в открытом состоянии МОП- и GaN-транзисторов соответственно.
- Протекание тока в обратном направлении происходит при напряжении VDS < 0, при этом возможны два режима работы в зависимости от напряжения «затвор-исток». При напряжении VGS < VTH (рисунок 5б) МОП-транзистор закрыт и ток протекает через внутренний диод МОП-транзистора и нормально-открытый GaN-транзистор. Падение напряжения «исток-сток» в обратном направлении определяется формулой 2:
, (2)
где VSD-Si – падение напряжения на внутреннем диоде МОП-транзистора, IF – ток истока.
- Падение напряжения «исток-сток» в обратном включении можно уменьшить, подав на затвор МОП-транзистора отпирающее напряжение VGS > VTH (рисунок 5в), при этом падение напряжения «исток-сток» будет определяться формулой 3:
(3)
В качестве примера: при обратном токе IF = 5 А уменьшение падения напряжения «исток-сток» в режиме работы в) по сравнению с режимом работы б) составит примерно 0,8 В. При использовании режима работы в) необходимо обеспечить задержку между выключением одного транзистора полумоста и включением другого («мертвое» время) для предотвращения сквозных токов.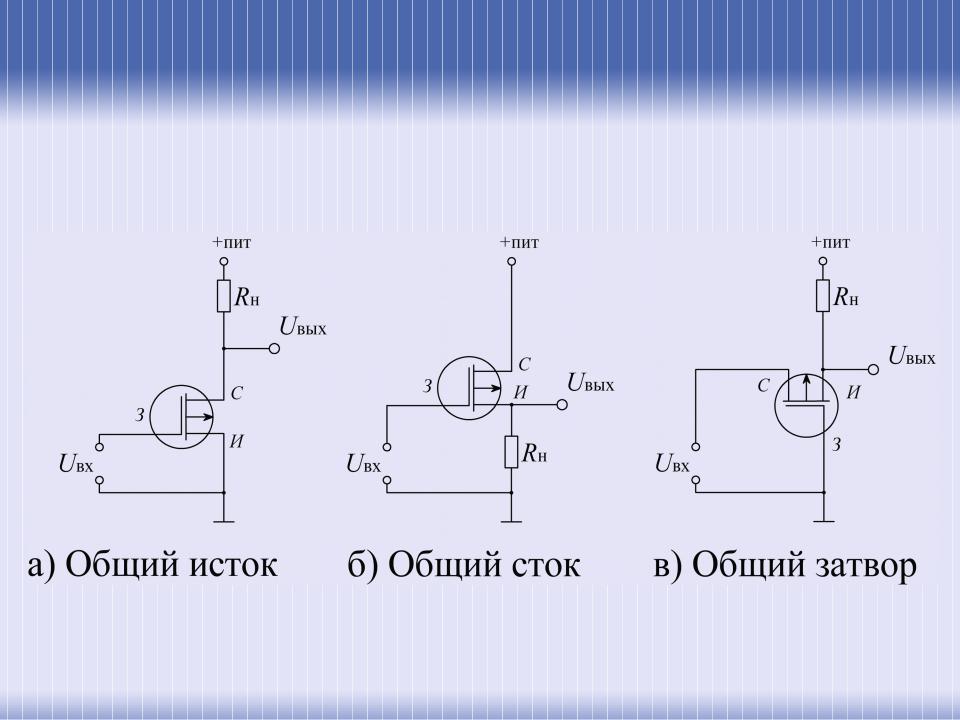
Рис. 5. Протекание тока при трех режимах работы каскодного GaN-транзистора
Современные техпроцессы изготовления кремниевых МОП-транзисторов позволяют сформировать в полупроводниковой структуре p-n-переход, который может выполнять функции антипараллельного диода благодаря пониженному значению заряда обратного восстановления QRR. Однако даже у специальных серий МОП-транзисторов с быстрым внутренним диодом величина Qrr превышает этот же параметр GaN-транзисторов в 20 и более раз при одинаковых сопротивлениях канала в открытом состоянии (рисунок 6).
Рис. 6. Процесс обратного восстановления: а) кремниевого МОП -транзистора, б) каскодного GaN-транзистора производства компании Transphorm (закрашенные области на графиках показывают величину заряда обратного восстановления диода)
Особенности топологии печатных плат
Выходные цепи
Рис. 7. Эквивалентная схема выходных цепей полевых транзисторов с учетом паразитных элементов печатной платы
Паразитные индуктивности цепей затвора и стока значительно влияют на перенапряжения, переходные колебательные процессы и, в целом, на устойчивость работы мостовых схем. Несмотря на малые величины зарядов восстановления каскодных GaN-транзисторов, они все же не равны нулю, и при перезаряде емкостей в цепи стока протекают токи с большой скоростью изменения. Для уменьшения амплитуды переходных колебательных процессов необходимо минимизировать паразитные индуктивности, обозначенные на рисунке 7 как LS1, LD1, LS2 и LD2, используя для этого низкоимпедансные силовые и земляные проводники (полигоны) и размещая фильтрующие конденсаторы как можно ближе к транзисторам. Влияние паразитной индуктивности LOUT при этом незначительно, так как она включена последовательно с индуктивностью нагрузки и в первом приближении просто добавляет к ней некоторую величину. Необходимо также минимизировать длину проводника между истоком верхнего ключа (Q1) и стоком нижнего ключа (Q2), что достигается размещением обоих транзисторов на общем радиаторе «спина к спине», как показано на рисунке 8а. Для уменьшения паразитной индуктивности сток Q1 подключен непосредственно к плюсовой шине питания, а исток Q2 – к шине земли (рисунок 8а).
Несмотря на малые величины зарядов восстановления каскодных GaN-транзисторов, они все же не равны нулю, и при перезаряде емкостей в цепи стока протекают токи с большой скоростью изменения. Для уменьшения амплитуды переходных колебательных процессов необходимо минимизировать паразитные индуктивности, обозначенные на рисунке 7 как LS1, LD1, LS2 и LD2, используя для этого низкоимпедансные силовые и земляные проводники (полигоны) и размещая фильтрующие конденсаторы как можно ближе к транзисторам. Влияние паразитной индуктивности LOUT при этом незначительно, так как она включена последовательно с индуктивностью нагрузки и в первом приближении просто добавляет к ней некоторую величину. Необходимо также минимизировать длину проводника между истоком верхнего ключа (Q1) и стоком нижнего ключа (Q2), что достигается размещением обоих транзисторов на общем радиаторе «спина к спине», как показано на рисунке 8а. Для уменьшения паразитной индуктивности сток Q1 подключен непосредственно к плюсовой шине питания, а исток Q2 – к шине земли (рисунок 8а). Полигоны земли и питания находятся на внутренних слоях печатной платы и на рисунке не показаны. Выходная цепь коммутации образована широким проводником, соединяющим исток Q1 со стоком Q2. Необходимо обратить внимание на то, что GaN-транзисторы HEMT производства Transphorm в корпусе TO220 имеют конфигурацию выводов G-S-D, в отличие от традиционной для МОП-транзисторов конфигурации G-D-S. Расположение вывода истока в средней части корпуса уменьшает паразитную связь между входными и выходными цепями. Высоковольтные фильтрующие конденсаторы SMD размещены на нижней стороне печатной платы (рисунок 8б), что позволяет уменьшить паразитную индуктивность проводников.
Полигоны земли и питания находятся на внутренних слоях печатной платы и на рисунке не показаны. Выходная цепь коммутации образована широким проводником, соединяющим исток Q1 со стоком Q2. Необходимо обратить внимание на то, что GaN-транзисторы HEMT производства Transphorm в корпусе TO220 имеют конфигурацию выводов G-S-D, в отличие от традиционной для МОП-транзисторов конфигурации G-D-S. Расположение вывода истока в средней части корпуса уменьшает паразитную связь между входными и выходными цепями. Высоковольтные фильтрующие конденсаторы SMD размещены на нижней стороне печатной платы (рисунок 8б), что позволяет уменьшить паразитную индуктивность проводников.
Паразитная емкость выходной цепи коммутации, обозначенная на рисунке 7 как COUT, увеличивает коммутационные потери, поэтому необходимо стремиться к уменьшению общей площади проводников, образующих выходную цепь коммутации, не допуская при этом значительного увеличения индуктивности цепи. Типичная 4-слойная плата с расстоянием 0,3 мм между внешним слоем и внутренним земляным полигоном добавляет распределенную емкость примерно 15 пФ/см2, следовательно, при частоте коммутации 100 кГц каждый см² площади проводника добавит P = 1/2•C•V2•fs = 120 мВт коммутационных потерь.
Рис. 8. Пример разводки печатной платы: а) силовые шины, б) размещение фильтрующих конденсаторов
Существенным моментом при разработке печатных плат является использование отдельных земляных полигонов для силовых и сигнальных цепей – они должны соединяться между собой только в одной точке.
Цепи управления
Рис. 9. Эквивалентная схема цепи управления, включающая в себя паразитные индуктивности выводов транзистора и внешних цепей
Для входных цепей, соединяющих выход драйвера и затвор МОП-транзистора, также необходимо минимизировать паразитные индуктивности, особенно индуктивность в цепи истока (LS2 на рисунке 9), которая является общей для силовой цепи и цепи управления. При изменении тока стока dID/dt на его паразитной индуктивности формируется напряжение, которое добавляется последовательно с выходным напряжением драйвера в цепи управления. Вследствие этого для цепи истока необходимо использовать низкоимпедансные проводники печатной платы. Основная проблема состоит в том, что последовательно с индуктивностью проводников включена паразитная индуктивность вывода истока корпуса TO220 (рисунок 6), которую невозможно уменьшить, однако, как будет показано далее, можно оценить ее влияние для минимизации обусловленных ею негативных эффектов.
Рис. 10. Осциллограммы напряжений «сток-исток» Vds и «затвор-исток» Vgs транзистора нижнего плеча (Q2) повышающего преобразователя 200…400 В
В начальном интервале переходного процесса включения транзистора ток стока увеличивается с нуля до величины тока нагрузки (0 < ID < ILOAD), при этом скорость изменения dID/dt определяется током затвора. Поскольку напряжение VDS в этом интервале времени практически не меняется, в токе ID отсутствует составляющая, разряда выходной емкости. На индуктивности истока формируется напряжение V = LdI/dt, которое вычитается из напряжения на затворе. При меньшем значении тока затвора IG переходный процесс dI/dt становится более медленным, вследствие чего уменьшаются напряжение на паразитной индуктивности истока и амплитуды связанных с этой индуктивностью паразитных резонансов. Установка резистора в цепи затвора (ZG на рисунке 10) позволяет уменьшать IG, однако вследствие малой величины емкости обратной связи CRSS каскодной схемы не может обеспечить ограничение скорости изменения напряжения выходной цепи d(VDS)/dt. Обычный способ ограничения разряда CRSS с помощью резистора в цепи затвора малоэффективен, поскольку основная выходная емкость CDS не разряжается через резистор затвора. Более предпочтительным является выбор драйвера затвора с меньшим выходным током для ограничения IG и dI/dt. В процессе включения каскодного GaN-транзистора при достижении током стока величины тока нагрузки (ID > ILOAD), происходит быстрый переходный процесс со скоростью dV/dt порядка 100 В/нс. Емкостной ток COSS, обусловленный изменением напряжения d(VDS)/dt, протекает через паразитную индуктивность истока, вызывая колебательный процесс. Пульсации напряжения на паразитной индуктивности через входную емкость транзистора CISS воздействуют на входную цепь и влияют на изменение тока в ней. Установка небольшой ферритовой бусины SMD в качестве ZG разрывает паразитную емкостную связь и препятствует возникновению колебательных процессов тока затвора, не ухудшая существенно форму импульсов напряжения на затворе. В качестве примера на рисунке 10 показаны осциллограммы напряжений «сток-исток» и «затвор-исток» с ферритовой бусиной, имеющей импеданс 120 Ом на частоте 100 МГц, а на рисунке 11 – результаты моделирования тока затвора с ферритовой бусиной и без нее.
Обычный способ ограничения разряда CRSS с помощью резистора в цепи затвора малоэффективен, поскольку основная выходная емкость CDS не разряжается через резистор затвора. Более предпочтительным является выбор драйвера затвора с меньшим выходным током для ограничения IG и dI/dt. В процессе включения каскодного GaN-транзистора при достижении током стока величины тока нагрузки (ID > ILOAD), происходит быстрый переходный процесс со скоростью dV/dt порядка 100 В/нс. Емкостной ток COSS, обусловленный изменением напряжения d(VDS)/dt, протекает через паразитную индуктивность истока, вызывая колебательный процесс. Пульсации напряжения на паразитной индуктивности через входную емкость транзистора CISS воздействуют на входную цепь и влияют на изменение тока в ней. Установка небольшой ферритовой бусины SMD в качестве ZG разрывает паразитную емкостную связь и препятствует возникновению колебательных процессов тока затвора, не ухудшая существенно форму импульсов напряжения на затворе. В качестве примера на рисунке 10 показаны осциллограммы напряжений «сток-исток» и «затвор-исток» с ферритовой бусиной, имеющей импеданс 120 Ом на частоте 100 МГц, а на рисунке 11 – результаты моделирования тока затвора с ферритовой бусиной и без нее. Как видно из рисунка 11, ферритовая бусина эффективно подавляет высокочастотные пульсации тока затвора и, что критически важно, изменение напряжения VGS в этом случае полностью определяется током через емкость CGS.
Как видно из рисунка 11, ферритовая бусина эффективно подавляет высокочастотные пульсации тока затвора и, что критически важно, изменение напряжения VGS в этом случае полностью определяется током через емкость CGS.
Рис. 11. Результаты моделирования тока затвора: а) с ферритовой бусиной; б) без нее
Особенности переключения каскодного GaN-транзистора
Рис. 12. Паразитные емкости транзистора QL нижнего плеча полумоста в выключенном состоянии, QH находится в ключевом режиме | На рисунке 12 показана эквивалентная схема полумоста в интервале времени, когда происходит коммутация транзистора верхнего плеча, транзистор нижнего плеча закрыт, при этом через него протекает замыкающий ток в паузах между импульсами коммутации. При включении транзистора QH в выходной цепи коммутации (S) появляется напряжение с высокой скоростью изменения dV/dt, которое создает ток IGD, заряжающий емкость CGD транзистора QL. Часть этого тока будет заряжать емкость CGS, увеличивая напряжение на затворе. При достаточно большом отношении CGD/CGS увеличение напряжения VGS может привести к включению нижнего транзистора QL. Однако в каскодных GaN-транзисторах это отношение чрезвычайно мало, например, для TPh4006 CGD = 4,5 пФ, а величина CGS составляет 720 пФ при VGS = 0, и более 2000 пФ во включенном состоянии. При достаточно большом отношении CGD/CGS увеличение напряжения VGS может привести к включению нижнего транзистора QL. Однако в каскодных GaN-транзисторах это отношение чрезвычайно мало, например, для TPh4006 CGD = 4,5 пФ, а величина CGS составляет 720 пФ при VGS = 0, и более 2000 пФ во включенном состоянии. |
Рис. 13. Осциллограммы выключения нижнего транзистора QL. Сверху – вниз: напряжение «сток-исток» с масштабирующим коэффициентом 1:100, ток в индуктивности, внешнее напряжение «затвор-исток» |
Рис. 14. Схема управления затвором каскодного GaN-транзистора с отрицательным напряжением
смещения
Более существенной проблемой, чем емкостная связь через CGD каскодной пары, является емкость CGD_Si низковольтного кремниевого МОП-транзистора. Напряжение «сток-исток» кремниевого МОП-транзистора VDS_Si (рисунок 12) при высокой скорости dV/dt может возрасти до величины -VTH GaN-транзистора. В этом случае отношение CGD_Si/CGS будет иметь значительное влияние.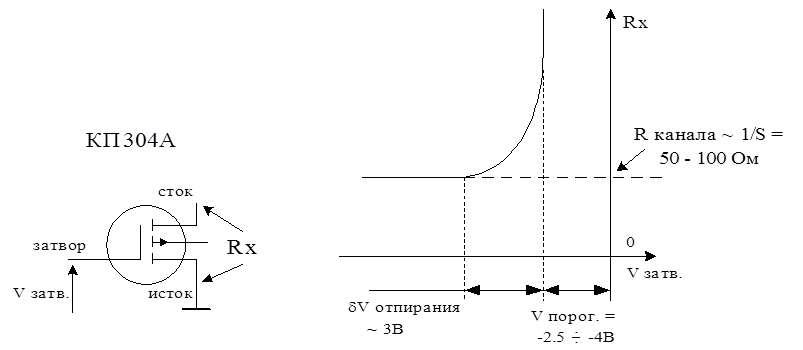 Осциллограммы на рисунке 13 показывают, что при изменении VDS_Si напряжение VGS быстро приближается к пороговому уровню, однако, так как повышение VDS_Si происходит при закрытом GaN-транзисторе, ток стока кремниевого МОП-транзистора, обусловленный увеличением VGS, должен сначала разрядить затвор GaN-транзистора до того, как через транзистор начнет протекать внешний ток. Поэтому мгновенное включение кремниевого полевого транзистора не обязательно приведет к появлению внешнего тока стока. Для повышения помехоустойчивости транзистора можно использовать схему управления затвором, создающую небольшое отрицательное напряжение смещения, например такую, как показано на рисунке 14. Однако в оценочных платах производства компании Transphorm отрицательное смещение затвора не используется, при этом в процессе работы не наблюдается экстремально больших коммутационных потерь, обусловленных ложным включением нижнего транзистора полумостовой схемы.
Осциллограммы на рисунке 13 показывают, что при изменении VDS_Si напряжение VGS быстро приближается к пороговому уровню, однако, так как повышение VDS_Si происходит при закрытом GaN-транзисторе, ток стока кремниевого МОП-транзистора, обусловленный увеличением VGS, должен сначала разрядить затвор GaN-транзистора до того, как через транзистор начнет протекать внешний ток. Поэтому мгновенное включение кремниевого полевого транзистора не обязательно приведет к появлению внешнего тока стока. Для повышения помехоустойчивости транзистора можно использовать схему управления затвором, создающую небольшое отрицательное напряжение смещения, например такую, как показано на рисунке 14. Однако в оценочных платах производства компании Transphorm отрицательное смещение затвора не используется, при этом в процессе работы не наблюдается экстремально больших коммутационных потерь, обусловленных ложным включением нижнего транзистора полумостовой схемы.
Охлаждение
Радиатор следует подключать к цепи заземления переменного тока. В оценочной плате, фрагмент которой показан на рисунке 8, радиатор электрически соединен с полигоном земли (отрицательным полюсом источника питания), при этом оба транзистора изолированы от радиатора. Для транзистора нижнего плеча емкость между пластиной корпуса TO220 и радиатором не критична, поскольку пластина соединена с истоком, поэтому транзистор может быть установлен непосредственно на радиатор. Однако при этом возможно протекание тока нагрузки через радиатор. Если надежное соединение между пластиной корпуса транзистора и радиатором невозможно или нежелательно – необходимо использовать изолирующую прокладку. Для транзистора верхнего плеча емкость между пластиной TO220 и радиатором будет увеличивать коммутационные потери, поэтому необходимо использовать изолирующую прокладку увеличенной толщины и/или с низкой диэлектрической проницаемостью. Данную паразитную емкость можно исключить при использовании в верхнем плече транзистора Transphorm с подключением к пластине корпуса вывода стока, например, TPh4006PD.
В оценочной плате, фрагмент которой показан на рисунке 8, радиатор электрически соединен с полигоном земли (отрицательным полюсом источника питания), при этом оба транзистора изолированы от радиатора. Для транзистора нижнего плеча емкость между пластиной корпуса TO220 и радиатором не критична, поскольку пластина соединена с истоком, поэтому транзистор может быть установлен непосредственно на радиатор. Однако при этом возможно протекание тока нагрузки через радиатор. Если надежное соединение между пластиной корпуса транзистора и радиатором невозможно или нежелательно – необходимо использовать изолирующую прокладку. Для транзистора верхнего плеча емкость между пластиной TO220 и радиатором будет увеличивать коммутационные потери, поэтому необходимо использовать изолирующую прокладку увеличенной толщины и/или с низкой диэлектрической проницаемостью. Данную паразитную емкость можно исключить при использовании в верхнем плече транзистора Transphorm с подключением к пластине корпуса вывода стока, например, TPh4006PD. Однако поскольку структура внутреннего соединения «сток-пластина» отличается от структуры соединения «исток-пластина», паразитные резонансные емкости, возникающие в полумостовой схеме, будут иметь более сложный характер.
Однако поскольку структура внутреннего соединения «сток-пластина» отличается от структуры соединения «исток-пластина», паразитные резонансные емкости, возникающие в полумостовой схеме, будут иметь более сложный характер.
Особенности управления верхним плечом моста
Вследствие высоких скоростей изменения напряжения драйвер затвора верхнего плеча должен обладать хорошей устойчивостью к синфазным помехам. Для уменьшения dI/dt целесообразно выбирать драйвер затвора с меньшим выходным током: например, хороший результат показывают драйверы с выходным током 0,5 А.
Типовая бутстрепная схема питания (схема с плавающим питанием) верхнего плеча моста содержит элементы R4, D1, C12 и C13. Емкость перехода D1 непосредственно влияет на коммутационные потери, поэтому в качестве D1 должен использоваться быстрый диод с малой емкостью перехода. Резистор R4 предназначен для ограничения тока заряда конденсатора, его величина составляет 10…15 Ом. Если для питания драйвера верхнего плеча используется изолированный DC/DC-преобразователь, его проходная емкость играет ту же роль, что и емкость перехода D1 в бутстрепной схеме. Индуктивность, включенная последовательно с этой емкостью, создаст дополнительную резонансную цепь, которая будет возбуждаться при каждом импульсе коммутации, что требует тщательной разводки этого узла на печатной плате. При использовании плавающего источника питания может оказаться полезной установка синфазного помехоподавляющего дросселя.
Преимущества решений на GaN транзисторах
Рис. 15. Зависимость тока стока ID от напряжения «сток-исток» VDS в закрытом состоянии кремниевого МОП -транзистора (CoolMOS ) и каскодного GaN-транзистора (GaN-on-Si HEMT) при температуре 175°C
В таблице 2 приведено сравнение основных параметров каскодного GaN-транзистора Transphorm и современного МОП-транзистора (Superjunction MOSFET) при использовании в качестве высоковольтных ключей в мостовой схеме. GaN-транзистор TPh4006PS имеет значительно меньший заряд «затвор-исток» QGD, что обеспечивает более быструю коммутацию и, соответственно, значительно меньшие коммутационные потери по сравнению с кремниевым МОП-транзистором. При этом полный заряд затвора QG GaN-транзистора также значительно меньше, что позволяет использовать для его управления драйверы затвора с меньшим выходным током.
Графики на рисунке 15 характеризуют способность 600-вольтовых транзисторных ключей работать при высоких температурах корпуса транзистора, характерных для современной преобразовательной техники. При температуре 175°C ток стока ID кремниевого МОП-транзистора (CoolMOS) быстро растет при приближении напряжения «сток-исток» VDS в закрытом состоянии к максимальному значению 600 В, в то время как ток стока каскодного GaN-транзистора (GaN-on-Si HEMT) растет сравнительно медленно до напряжения примерно в 1 кВ, значительно превышающего рабочее напряжение.
Таблица 2. Сравнительные характеристики каскодного CaN-транзистора TPh4006PS и МОП-транзистора серии Superjunction MOSFET
| Параметр | Обозначение | Наименование | |
| Superjunction MOSFET | TPh4006PS | ||
| Максимальное напряжение «сток-исток» при температуре 25°C, В | VDS (25°C) | 600 | 600 |
| Сопротивление канала при температуре 25°C, Ом | RDS(on) (25°C) | 0,14…0,16 | 0,15…0,18 |
| Полный заряд затвора, нКл | QG | 75 | 6,2 |
| Заряд «затвор-сток», нКл | QGD | 38 | 2,2 |
| Эффективная выходная емкость, определяемая по энергии, накопленной при изменении VDS от 0 до 480 В, пФ | Co(er) | 66 | 56 |
| Эффективная выходная емкость, определяемая по времени заряда при изменении VDS от 0 до 480 В, пФ | Co(tr) | 314 | 110 |
| Заряд обратного восстановления внутреннего диода, нКл | QRR | 82001 | 542 |
| Время обратного восстановления внутреннего диода, нс | tRR | 4601 | 302 |
| Примечания: 1 – VDS = 400 В, IDS = 11,3 А, di/dt = 100 А/мкс; 2 – VDS = 480 В, IDS = 9 А, di/dt = 450 А/мкс. | |||
Типовые решения Transphorm
Одним из типовых решений Transphorm является двухтактный безмостовой корректор коэффициента мощности (ККМ), выполненный по схеме повышающего преобразователя напряжения (рисунок 16) со следующими характеристиками:
- диапазон входного переменного напряжения 85…265 В;
- выходное постоянное напряжение 387 ±5 В;
- максимальная мощность нагрузки 4400 Вт;
- частота коммутации 66 кГц.
Рис. 16. Двухтактный безмостовой ККМ с коммутатором сетевого напряжения: а) на диодах; б) на МОП-транзисторах
Рис. 17. Сигналы управления затворами SD1 и SD2
ККМ работает в режиме непрерывных токов дросселя (CCM), что оказалось возможным благодаря низким коммутационным потерям и малому времени обратного восстановления, свойственным каскодным GaN-транзисторам. ККМ содержит «быстрое» плечо на каскодных GaN-транзисторах Q1 и Q2, работающее на частоте коммутации, и «медленное» плечо, коммутирующее полуволны сетевого напряжения посредством диодов D1, D2 или МОП-транзисторов SD1, SD2. При положительной полуволне напряжения сети через открытый D1 (SD1) входная линия переменного тока подключена к выходной общей шине питания. При этом Q1 выполняет функцию активного ключа повышающего преобразователя, а Q2 – синхронного выпрямителя. При отрицательной полуволне напряжения сети через открытый D2 (SD2) входная линия переменного тока подключена к выходной плюсовой шине питания, соответственно, функции Q1 и Q2 меняются местами.
Рис. 18. Графики зависимости КПД и потерь мощности от мощности нагрузки двухтактного безмостового ККМ на GaN-транзисторах при напряжении сети 85 В (бордовый), 115 В (зеленый), 180 В (красный) и 230 В (синий)
Замена диодов, коммутирующих сетевое напряжение, МОП-транзисторами позволяет снизить потери за счет меньшего падения напряжения в открытом состоянии, однако сигналы управления МОП-транзисторами должны подаваться с некоторой паузой относительно момента сигнала полярности сетевого напряжения (рисунок 17). Это обусловлено скачкообразным изменением коэффициентов заполнения импульсов коммутации Q1 и Q2 (от 0 до 100% одного ключа и от 100% до 0 – другого) при переходе сетевого напряжения через ноль. Из-за большого времени восстановления внутренних диодов SD1 и SD2 напряжение VD (рисунок 16б) не может быстро измениться от 0 до VDC или от VDC до 0, вследствие чего в этой цепи возникает бросок тока. Для мягкого переключения с одной полуволны на другую в управление затворами SD1 и SD2 вводятся паузы, составляющие несколько периодов коммутации, в течение которых оба ключа SD1 и SD2 закрыты и работают их внутренние диоды. Кроме того, поскольку ККМ работает в режиме непрерывных токов, сравнительно большая индуктивность входного дросселя ограничивает амплитуду бросков тока. Результаты измерения КПД двухтактного безмостового ККМ (рисунок 18) показывают максимальное значение 99% при напряжении сети 230 В и мощности нагрузки 1500 Вт.
Рис. 19. Структурная схема инвертора (преобразователя постоянного напряжения в переменное) мощностью 4,5 кВт
Рис. 20. Зависимость КПД инвертора от мощности нагрузки
Другим примером типовых решений Transphorm является инвертор (рисунок 19) со следующими характеристиками:
- входное напряжение питания 400 В;
- выходное однофазное переменное напряжение 240 В, 50/60 Гц;
- частота коммутации 50 кГц.
Максимальный КПД инвертора составляет 99% при мощности нагрузки 1…2 кВт (рисунок 20).
Заключение
В силовой преобразовательной технике некоторые перспективные топологии, основные на использовании мостовых схем с жесткой коммутацией, длительное время не получали развития из-за отсутствия подходящей элементной базы. Это обусловлено тем, что к силовым ключам, особенно в высоковольтных применениях, предъявлялись требования, считавшиеся ранее несовместимыми – малое сопротивление ключа в открытом состоянии для снижения потерь проводимости и малое время переключения для снижения коммутационных потерь. Для наиболее массовых п/п-ключей – кремниевых МОП-транзисторов – ограничивающим фактором является малая ширина запрещенной зоны кремния, вследствие чего высоковольтные ключи на основе МОП-транзисторов имеют либо большое сопротивление канала в открытом состоянии, либо большую емкость затвора. Таким образом, кремниевая технология производства высоковольтных ключей практически исчерпала возможности по снижению одновременно и кондуктивных, и коммутационных потерь.
Компания Transphorm, анонсировав революционную технологию производства нитрид-галлиевых транзисторов на подложке из кремния, смогла решить большую часть проблем, связанных с производством высоковольтных ключей. Большая ширина запрещенной зоны у нитрида галлия позволяет создавать высоковольтные ключи с малым сопротивлением в открытом состоянии, а каскодная схема, состоящая из высоковольтного GaN-транзистора и низковольтного МОП-транзистора, позволила значительно уменьшить емкость затвора и время обратного восстановления внутреннего диода. Преимущества каскодных GaN-транзисторов производства компании Transphorm наглядно демонстрирует корректор коэффициента мощности на основе полумостовой схемы с жесткой коммутацией, обеспечивающий КПД 99% при мощности нагрузки 1,5 кВт. Фактически, технология производства каскодных GaN-транзисторов компании Transphorm открывает новые направления в схемотехнике силовых преобразовательных устройств – сетевых источников питания, инверторов и драйверов электродвигателей.
Таблица 1. Сравнительные характеристики различных технологий производства силовых п/п-ключей
| Наименование параметра | Технология производства силовых п/п ключей | ||
| Si | 4H-SiC | GaN | |
| Максимальная напряженность электрического поля, 106 В/см | 3 | 30 | 30 |
| Подвижность носителей заряда, см2/В•с | 1500 | 700 | 2000 |
| Коэффициент теплопроводности, Вт/см•К | 1,5 | 4,5 | 1,5 |
Таблица 2. Сравнительные характеристики каскодного CaN-транзистора TPh4006PSи МОП-транзистора серии Superjunction MOSFET
| Параметр | Обозначение | Наименование | |
| Superjunction MOSFET | TPh4006PS | ||
| Максимальное напряжение «сток-исток» при температуре 25°C, В | VDS (25°C) | 600 | 600 |
| Сопротивление канала при температуре 25°C, Ом | RDS(on) (25°C) | 0,14…0,16 | 0,15…0,18 |
| Полный заряд затвора, нКл | QG | 75 | 6,2 |
| Заряд «затвор-сток», нКл | QGD | 38 | 2,2 |
| Эффективная выходная емкость, определяемая по энергии, накопленной при изменении VDS от 0 до 480 В, пФ | Co(er) | 66 | 56 |
| Эффективная выходная емкость, определяемая по времени заряда при изменении VDS от 0 до 480 В, пФ | Co(tr) | 314 | 110 |
| Заряд обратного восстановления внутреннего диода, нКл | QRR | 82001 | 542 |
| Время обратного восстановления внутреннего диода, нс | tRR | 4601 | 302 |
| Примечания: 1 – VDS = 400 В, IDS = 11,3 А, di/dt = 100 А/мкс; 2 – VDS = 480 В, IDS = 9 А, di/dt = 450 А/мкс. | |||
•••
Наши информационные каналы
Что такое полевой транзистор и как его проверить
Добрый день, друзья!
Недавно мы с вами начали плотнее знакомились с тем, как устроено компьютерное «железо». И познакомились одним из его «кирпичиков» — полупроводниковым диодом. Компьютер – это сложная система, состоящая из отдельных частей. Разбирая, как работают эти отдельные части (большие и малые), мы приобретаем знание.
Обретая знание, мы получаем шанс помочь своему железному другу-компьютеру, если он вдруг забарахлит. Мы же ведь в ответе за тех, кого приручили, не правда ли?
Сегодня мы продолжим это интересное дело, и попробуем разобраться, как работает самый, пожалуй, главный «кирпичик» электроники – транзистор. Из всех видов транзисторов (их немало) мы ограничимся сейчас рассмотрением работы полевых транзисторов.
Почему транзистор – полевой?
Слово «транзистор» образовано от двух английских слов translate и resistor, то есть, иными словами, это преобразователь сопротивления.
Среди всего многообразия транзисторов есть и полевые, т.е. такие, которые управляются электрическим полем.
Электрическое поле создается напряжением. Таким образом, полевой транзистор – это полупроводниковый прибор, управляемый напряжением.
В англоязычной литературе используется термин MOSFET (MOS Field Effect Transistor). Есть другие типы полупроводниковых транзисторов, в частности, биполярные, которые управляются током. При этом на управление затрачивается и некоторая мощность, так как к входным электродам необходимо прикладывать некоторое напряжение.
Канал полевого транзистора может быть открыт только напряжением, без протекания тока через входные электроды (за исключением очень небольшого тока утечки). Т.е. мощность на управление не затрачивается. На практике, однако, полевые транзисторы используются большей частью не в статическом режиме, а переключаются с некоторой частотой.
Конструкция полевого транзистора обуславливает наличие в нем внутренней переходной емкости, через которую при переключении протекает некоторый ток, зависящий от частоты (чем больше частота, тем больше ток). Так что, строго говоря, некоторая мощность на управление все-таки затрачивается.
Где используются полевые транзисторы?
Настоящий уровень технологии позволяет сделать сопротивление открытого канала мощного полевого транзистора (ПТ) достаточно малым – в несколько сотых или тысячных долей Ома!
И это является большим преимуществом, так как при протекании тока даже в десяток ампер рассеиваемая на ПТ мощность не превысит десятых или сотых долей Ватта.
Таким образом, можно отказаться от громоздких радиаторов или сильно уменьшить их размеры.
ПТ широко используются в компьютерных блоках питания и низковольтных импульсных стабилизаторах на материнской плате компьютера.
Из всего многообразия типов ПТ для этих целей используются ПТ с индуцированным каналом.
Как работает полевой транзистор?
ПТ с индуцированным каналом содержит три электрода — исток (source), сток (drain), и затвор (gate).
Принцип работы ПТ наполовину понятен из графического обозначения и названия электродов.
Канал ПТ – это «водяная труба», в которую втекает «вода» (поток заряженных частиц, образующих электрический ток) через «источник» (исток).
«Вода» вытекает из другого конца «трубы» через «слив» (сток). Затвор – это «кран», который открывает или перекрывает поток. Чтобы «вода» пошла по «трубе», надо создать в ней «давление», т.е. приложить напряжение между стоком и истоком.
Если напряжение не приложено («давления в системе нет»), тока в канале не будет.
Если приложено напряжение, то «открыть кран» можно подачей напряжения на затвор относительно истока.
Чем большее подано напряжение, тем сильнее открыт «кран», больше ток в канале «сток-исток» и меньше сопротивление канала.
В источниках питания ПТ используется в ключевом режиме, т.е. канал или полностью открыт, или полностью закрыт.
Честно сказать, принципы действия ПТ гораздо более сложны, он может работать не только в ключевом режиме. Его работа описывается многими заумными формулами, но мы не будем здесь все это описывать, а ограничимся этими простыми аналогиями.
Скажем только, что ПТ могут быть с n-каналом (при этом ток в канале создается отрицательно заряженными частицами) и p-каналом (ток создается положительно заряженными частицами). На графическом изображении у ПТ с n-каналом стрелка направлена внутрь, у ПТ с p-каналом – наружу.
Собственно, «труба» — это кусочек полупроводника (чаще всего – кремния) с примесями химических элементов различного типа, что обуславливает наличие положительных или отрицательных зарядов в канале.
Теперь переходим к практике и поговорим о том,
Как проверить полевой транзистор?
В норме сопротивление между любыми выводами ПТ бесконечно велико.
И, если тестер показывает какое-то небольшое сопротивление, то ПТ, скорее всего, пробит и подлежит замене.
Во многих ПТ имеется встроенный диод между стоком и истоком для защиты канала от обратного напряжения (напряжения обратной полярности).
Таким образом, если поставить «+» тестера (красный щуп, соединенный с «красным» входом тестера) на исток, а «-» (черный щуп, соединенный с черным входом тестера) на сток, то канал будет «звониться», как обычный диод в прямом направлении.
Это справедливо для ПТ с n-каналом. Для ПТ с p-каналом полярность щупов будет обратной.
Как проверить диод с помощью цифрового тестера, описано в соответствующей статье. Т.е. на участке «сток — исток» будет падать напряжение 500-600 мВ.
Если поменять полярность щупов, к диоду будет приложено обратное напряжение, он будет закрыт и тестер это зафиксирует.
Однако исправность защитного диода еще не говорит об исправности транзистора в целом. Более того, если «прозванивать» ПТ, не выпаивая из схемы, то из-за параллельно подключенных цепей не всегда можно сделать однозначный вывод даже об исправности защитного диода.
В таких случаях можно выпаять транзистор, и, используя небольшую схему для тестирования, однозначно ответить на вопрос – исправен ли ПТ или нет.
В исходном состоянии кнопка S1 разомкнута, напряжение на затворе относительно стока равно нулю. ПТ закрыт, и светодиод HL1 не светится.
При замыкании кнопки на резисторе R3 появляется падение напряжения (около 4 В), приложенное между истоком и затвором. ПТ открывается, и светодиод HL1 светится.
Эту схему можно собрать в виде модуля с разъемом для ПТ. Транзисторы в корпусе D2 pack (который предназначен для монтажа на печатную плату) в разъем не вставишь, но можно припаять к его электродам проводники, и уже их вставить в разъем. Для проверки ПТ с p-каналом полярность питания и светодиода нужно изменить на обратную.
Иногда полупроводниковые приборы выходят из строя бурно, с пиротехническими, дымовыми и световыми эффектами.
В этом случае на корпусе образуются дыры, он трескается или разлетается на куски. И можно сделать однозначный вывод об их неисправности, не прибегая к приборам.
В заключение скажем, что буквы MOS в аббревиатуре MOSFET расшифровываются как Metal — Oxide — Semiconductor (металл – оксид – полупроводник). Такова структура ПТ – металлический затвор («кран») отделен от канала из полупроводника слоем диэлектрика (оксида кремния).
Надеюсь, с «трубами», «кранами» и прочей «сантехникой» вы сегодня разобрались.
Однако, теория, как известно, без практики мертва! Надо обязательно поэкспериментировать с полевиками, поковыряться, повозиться с их проверкой, пощупать, так сказать.
Что вызывает это колено в моем падении напряжения стока МОП-транзистора?
Наклон напряжения стока зависит от емкости затвора-стока Cgd. В случае падения фронта транзистор должен разрядить Cgd. В дополнение к току нагрузки для резистора он также должен поглощать ток, протекающий через Cgd.
Важно помнить, что Cgd — это не простой конденсатор, а нелинейная емкость, которая зависит от рабочей точки. В насыщении нет канала на стороне стока транзистора, и Cgd происходит из-за емкости перекрытия между затвором и стоком. В линейной области канал простирается в сторону стока, и Cgd больше, потому что теперь между затвором и стоком имеется большая емкость затвора для канала.
Когда транзистор переходит между насыщением и линейной областью, значение Cgd изменяется и, следовательно, также наклон напряжения стока.
Использование LTspice Cgd можно проверить с помощью симуляции «Рабочая точка постоянного тока». Результаты можно просмотреть с помощью «Просмотр / Spice Error Log».
Для Vgs 3,92 В Cgd составляет около 1,3 нПФ, потому что Vds высокое.
Name: m1
Model: irf2805s
Id: 1.70e-02
Vgs: 3.92e+00
Vds: 6.60e+00
Vth: 3.90e+00
Gm: 1.70e+00
Gds: 0.00e+00
Cgs: 6.00e-09
Cgd: 1.29e-09
Cbody: 1.16e-09
Для Vgs 4 В Cgd намного больше с 6,5 нФ из-за более низких Vds.
Name: m1
Model: irf2805s
Id: 5.00e-02
Vgs: 4.00e+00
Vds: 6.16e-03
Vth: 3.90e+00
Gm: 5.15e-01
Gds: 7.98e+00
Cgs: 6.00e-09
Cgd: 6.52e-09
Cbody: 3.19e-09
Изменение Cgd (обозначенное Crss) для разных смещений можно увидеть на графике ниже, взятом из таблицы данных.
IRF2805 — это транзистор VDMOS, который показывает другое поведение для Cgd. Из интернета :
Дискретный вертикальный MOSFET-транзистор с двойным рассеиванием (VDMOS), широко используемый в источниках питания с переключателем уровня платы, имеет поведение, качественно отличающееся от описанных выше монолитных моделей MOSFET. В частности, (i) диод корпуса транзистора VDMOS подключен к внешним клеммам иначе, чем диод подложки монолитного полевого МОП-транзистора, и (ii) нелинейность ёмкости затвор-сток (Cgd) не может быть смоделирована с помощью простой градуировки Емкости монолитных моделей MOSFET. В транзисторе VDMOS Cgd резко изменяется примерно на нулевое напряжение затвора (Vgd). Когда Vgd отрицателен, Cgd физически основан на конденсаторе с затвором в качестве одного электрода и стоком на задней стороне матрицы в качестве другого электрода. Эта емкость довольно низкая из-за толщины непроводящего кристалла. Но когда Vgd положительный, матрица является проводящей, а Cgd физически основан на конденсаторе с толщиной оксида затвора. Традиционно, сложные подсхемы использовались, чтобы дублировать поведение мощного MOSFET. Было написано новое встроенное устройство специй, которое воплощает это поведение в интересах скорости вычислений, надежности сходимости и простоты написания моделей. Модель DC аналогична монолитному MOSFET уровня 1, за исключением того, что длина и ширина по умолчанию равны единице, так что коэффициент трансдуктивности может быть задан напрямую без масштабирования. Модель переменного тока выглядит следующим образом. Емкость затвор-источник принимается постоянной. Опытным путем было установлено, что это хорошее приближение для мощных полевых МОП-транзисторов, если напряжение затвор-исток не приводится в действие отрицательным. Емкость затвор-сток принимает следующую эмпирически найденную форму:
Для положительного Vgd Cgd изменяется как гиперболический тангенс Vgd. Для отрицательного Vdg Cgd изменяется как арктангенс Vgd. Параметры модели a, Cgdmax и Cgdmax параметризуют емкость стока затвора. Емкость исток-сток поступает через градуированную емкость диода корпуса, подключенного к электродам стока истока, вне сопротивлений истока и истока.
В файле модели можно найти следующие значения
Cgdmax=6.52n Cgdmin=.45n
Очень прерывистый сбой питания МОП-транзистора
Я работаю на очень пятнистый отказ двигателя (я не дизайнер). У нас есть намотанная арматура, которая переключается с помощью силовых полевых МОП-транзисторов. Они приводятся в действие FET драйвером типа тотема. Следовательно, когда драйвер выключен, затвор силового полевого транзистора плавает. Да, я знаю. Плохой дизайнерский выбор. Я просто убираю беспорядок.
На стороне статора двигателя имеется цепь симистора и привода, управляемая микропроцессором. Когда вы подключаете двигатель, приводная линия остается на плаву, поскольку микропорт переключается до завершения загрузки. Поскольку эта линия порта входит в логический элемент И и находится в плавающем состоянии, в результате получается около 5 циклов переменного тока с достаточной амплитудой для срабатывания вентиля, а это — симистор. Это помещает примерно 3-5 полупериодов линии на статор, с пиками до 100 А в зависимости от полного сопротивления источника. Ага. Еще одна ошибка дизайна — его надо было снести.
Проблема — это случается не часто, и не происходит сбой питания MOSFET. Из сотен двигателей у нас было три выхода из строя с мощными полевыми транзисторами, замкнутыми стоком и затвором в источник. Вопрос — я пытаюсь решить, является ли эта серия пиков тока (которые вызывают напряжение на якоре — и отношение витков составляет 1: 1) вероятным подозрением, учитывая плохо спроектированную схему силового полевого МОП-транзистора. МОП-транзисторы расположены прямо через обмотку якоря. Когда двигатель выходит из строя, он не выходит из строя во время работы. Похоже, что он потерпит неудачу, как только вы подключите его. Все мои доказательства косвенные — я до сих пор не смог вызвать неудачу. Но огромный всплеск на плагине, редкость неудачи и трудность дублирования, похоже, указывают на это. Если я иду по неверному пути, мне нужно знать и знать почему. Кажется, что это может повредить FET, но я ищу путь к неудаче, который имеет смысл.
В данный момент я запускаю несколько двигателей, используя ПЛК, чтобы следить за ними. План состоит в том, чтобы выполнить цикл до отказа, применить исправления проекта и запустить снова. Если я не получу вспышку гения.
Рассел МакМахон
Ворота FET НЕ ДОЛЖНЫ плавать.
Ничто не может быть гарантировано в этом состоянии.
Емкость Миллера будет успешно соединять большие сигналы привода на затворе от переходных процессов стока. Затвор, управляемый выше его значения Vgsmax, будет достаточно часто прокалывать оксид затвора, и может возникнуть любая комбинация жестких шортов между GDS. Я видел DS коротким с открытым G, GS коротким с открытым D, GDS коротким и, возможно, GD коротким с открытым S, но я не был бы уверен на 100% в этом.
Для ЛЮБОГО мощного полевого транзистора с индуктивной нагрузкой я добавляю стабилитрон GS, установленный как можно ближе к полевому транзистору, с номинальным напряжением выше Vgs_drive_max и комфортно ниже VGS_abs_max. Это преобразует цепи, которые выходят из строя в считанные минуты или часы, в цепи, которые никогда не выходят из строя.
Buz90 datasheet на русском
| Главная | О сайте | Теория | Практика | Контакты |
Высказывания: Основные параметры BUZ90A полевого транзистора n-канального.Эта страница показывает существующую справочную информацию о параметрах полевого транзистора n-канального BUZ90A. Дана подробная информация о параметрах, схеме и цоколевке, характеристиках, местах продажи и производителях. Структура (технология): MOSFET |
| Pd max | Uds max | Udg max | Ugs max | Id max | Tj max, °C | Fr (Ton/of) | Ciss tip | Rds |
| 75W | 600V | 600V | ±20V | 4A | 150°C | 30/150nS | 1050pF | 2 |
Производитель: SIEMENS
Сфера применения: SIPMOS Power V-MOS
Популярность: 6452
Условные обозначения описаны на странице «Теория».
Схемы транзистора BUZ90A
| Общий вид транзистора BUZ90A. | Цоколевка транзистора BUZ90A. |
Обозначение контактов:
Международное: G – затвор, D – сток, S – исток.
Российское: З – затвор, С – сток, И – исток.
Коллективный разум. Дополнения для транзистора BUZ90A.
Другие разделы справочника:
Есть надежда, что справочник транзисторов окажется полезен опытным и начинающим радиолюбителям, конструкторам и учащимся. Всем тем, кто так или иначе сталкивается с необходимостью узнать больше о параметрах транзисторов. Более подробную информацию обо всех возможностях этого интернет-справочника можно прочитать на странице «О сайте».
Если Вы заметили ошибку, огромная просьба написать письмо.
Спасибо за терпение и сотрудничество.
BUZ90 MOSFET – описание производителя. Даташиты. Основные параметры и характеристики. Поиск аналога. Справочник
Наименование прибора: BUZ90
Тип транзистора: MOSFET
Максимальная рассеиваемая мощность (Pd): 75 W
Предельно допустимое напряжение сток-исток (Uds): 600 V
Предельно допустимое напряжение затвор-исток (Ugs): 20 V
Максимально допустимый постоянный ток стока (Id): 4.5 A
Максимальная температура канала (Tj): 150 °C
Выходная емкость (Cd): 1050 pf
Сопротивление сток-исток открытого транзистора (Rds): 1.6 Ohm
Тип корпуса: TO220AB
BUZ90 Datasheet (PDF)
1.1. buz90a.pdf Size:175K _siemens
BUZ 90 A SIPMOS � Power Transistor � N channel � Enhancement mode � Avalanche-rated Pin 1 Pin 2 Pin 3 G D S Type VDS >1.2. buz90.pdf Size:176K _siemens
BUZ 90 SIPMOS � Power Transistor � N channel � Enhancement mode � Avalanche-rated Pin 1 Pin 2 Pin 3 G D S Type VDS >
BUZ900DP MAGNA BUZ901DP TEC MECHANICAL DATA Dimensions in mm N�CHANNEL POWER MOSFET 20.0 5.0 3.3 Dia. POWER MOSFETS FOR AUDIO APPLICATIONS FEATURES 1 2 3 � HIGH SPEED SWITCHING 2.0 1.0 � N�CHANNEL POWER MOSFET 2.0 � SEMEFAB DESIGNED AND DIFFUSED 3.4 � HIGH VOLTAGE (160V & 200V) � HIGH ENERGY RATING 0.6 1.2 � ENHANCEMENT MODE 2.8 � INTEGRAL PROTECTION DIODE 5.45 5.45 � P�
BUZ900D MAGNA BUZ901D TEC MECHANICAL DATA Dimensions in mm N–CHANNEL POWER MOSFET +0.1 25.0 -0.15 8.7 Max. 10.90 ± 0.1 1.50 11.60 POWER MOSFETS FOR Typ. ± 0.3 AUDIO APPLICATIONS FEATURES 1 2 • HIGH SPEED SWITCHING • N–CHANNEL POWER MOSFET • SEMEFAB DESIGNED AND DIFFUSED • HIGH VOLTAGE (160V & 200V) R 4.0 ± 0.1 R 4.4 ± 0.2 • HIGH ENERGY RATING • ENHANC
BUZ900P MAGNA BUZ901P TEC MECHANICAL DATA Dimensions in mm (inches) N–CHANNEL POWER MOSFET 4.69 (0.185) 15.49 (0.610) 5.31 (0.209) 16.26 (0.640) 1.49 (0.059) 2.49 (0.098) POWER MOSFETS FOR AUDIO APPLICATIONS 3.55 (0.140) 3.81 (0.150) FEATURES 1 2 3 • HIGH SPEED SWITCHING 1.65 (0.065) 2.13 (0.084) 0.40 (0.016) • N–CHANNEL POWER MOSFET 0.79 (0.031) 2.87 (0.113) 3.1
BUZ907D MAGNA BUZ908D TEC MECHANICAL DATA Dimensions in mm P–CHANNEL POWER MOSFET +0.1 25.0 -0.15 8.7 Max. 10.90 ± 0.1 1.50 11.60 POWER MOSFETS FOR Typ. ± 0.3 AUDIO APPLICATIONS FEATURES 1 2 • HIGH SPEED SWITCHING • SEMEFAB DESIGNED AND DIFFUSED • HIGH VOLTAGE (220V & 250V) • HIGH ENERGY RATING R 4.0 ± 0.1 R 4.4 ± 0.2 • ENHANCEMENT MODE • INTEGRAL PROT
BUZ900 www.DataSheet4U.com MAGNA BUZ901 TEC MECHANICAL DATA Dimensions in mm N–CHANNEL POWER MOSFET +0.1 25.0 -0.15 8.7 Max. 10.90 ± 0.1 1.50 11.60 POWER MOSFETS FOR Typ. ± 0.3 AUDIO APPLICATIONS FEATURES 1 2 • HIGH SPEED SWITCHING • N–CHANNEL POWER MOSFET • SEMEFAB DESIGNED AND DIFFUSED • HIGH VOLTAGE (160V & 200V) R 4.0 ± 0.1 R 4.4 ± 0.2 • HIGH ENERGY
BUZ907P MAGNA BUZ908P TEC MECHANICAL DATA Dimensions in mm P–CHANNEL 4.69 (0.185) 15.49 (0.610) POWER MOSFET 5.31 (0.209) 16.26 (0.640) 1.49 (0.059) 2.49 (0.098) POWER MOSFETS FOR AUDIO APPLICATIONS 3.55 (0.140) 3.81 (0.150) FEATURES 1 2 3 • HIGH SPEED SWITCHING 1.65 (0.065) 2.13 (0.084) 0.40 (0.016) • SEMEFAB DESIGNED AND DIFFUSED 0.79 (0.031) 2.87 (0.113) 3.12 (0
BUZ905X4S MAGNA BUZ906X4S TEC NEW PRODUCT UNDER DEVELOPMENT MECHANICAL DATA Dimensions in mm (inches) P–CHANNEL POWER MOSFET 11.8 (0.463) 12.2 (0.480) 31.5 (1.240) 31.7 (1.248) POWER MOSFETS FOR 8.9 (0.350) 7.8 (0.307) 4.1 (0.161 ) 8.2 (0.322) W = 9.6 (0.378) Hex Nut M 4 4.3 (0.169 ) (4 places) AUDIO APPLICATIONS 4.8 (0.187) H = 4.9 (0.193) 1 2 (4 places) R 4.0 (0.
BUZ902 MAGNA BUZ903 TEC MECHANICAL DATA Dimensions in mm N–CHANNEL POWER MOSFET +0.1 25.0 -0.15 8.7 Max. 10.90 ± 0.1 1.50 11.60 POWER MOSFETS FOR Typ. ± 0.3 AUDIO APPLICATIONS FEATURES 1 2 • HIGH SPEED SWITCHING • SEMEFAB DESIGNED AND DIFFUSED • HIGH VOLTAGE (220V & 250V) • HIGH ENERGY RATING R 4.0 ± 0.1 R 4.4 ± 0.2 • ENHANCEMENT MODE • INTEGRAL PROTEC
BUZ902D MAGNA BUZ903D TEC MECHANICAL DATA Dimensions in mm N–CHANNEL POWER MOSFET +0.1 25.0 -0.15 8.7 Max. 10.90 ± 0.1 1.50 11.60 POWER MOSFETS FOR Typ. ± 0.3 AUDIO APPLICATIONS FEATURES 1 2 • HIGH SPEED SWITCHING • SEMEFAB DESIGNED AND DIFFUSED • HIGH VOLTAGE (220V & 250V) • HIGH ENERGY RATING R 4.0 ± 0.1 R 4.4 ± 0.2 • ENHANCEMENT MODE • INTEGRAL PROT
BUZ905DP MAGNA BUZ906DP TEC MECHANICAL DATA Dimensions in mm P–CHANNEL POWER MOSFET 20.0 5.0 3.3 Dia. POWER MOSFETS FOR AUDIO APPLICATIONS FEATURES 1 2 3 • HIGH SPEED SWITCHING 2.0 1.0 • P–CHANNEL POWER MOSFET 2.0 • SEMEFAB DESIGNED AND DIFFUSED 3.4 • HIGH VOLTAGE (160V & 200V) • HIGH ENERGY RATING 0.6 1.2 • ENHANCEMENT MODE 2.8 • INTEGRAL PROTECTION D
BUZ905D MAGNA BUZ906D TEC MECHANICAL DATA Dimensions in mm P–CHANNEL POWER MOSFET +0.1 25.0 -0.15 8.7 Max. 10.90 ± 0.1 1.50 11.60 POWER MOSFETS FOR Typ. ± 0.3 AUDIO APPLICATIONS FEATURES 1 2 • HIGH SPEED SWITCHING • P–CHANNEL POWER MOSFET • SEMEFAB DESIGNED AND DIFFUSED • HIGH VOLTAGE (160V & 200V) R 4.0 ± 0.1 R 4.4 ± 0.2 • HIGH ENERGY RATING • ENHANC
BUZ907DP MAGNA BUZ908DP TEC MECHANICAL DATA Dimensions in mm P–CHANNEL POWER MOSFET 20.0 5.0 3.3 Dia. POWER MOSFETS FOR AUDIO APPLICATIONS FEATURES 1 2 3 • HIGH SPEED SWITCHING 2.0 1.0 2.0 • SEMEFAB DESIGNED AND DIFFUSED 3.4 • HIGH VOLTAGE (220V & 250V) • HIGH ENERGY RATING 0.6 1.2 • ENHANCEMENT MODE 2.8 • INTEGRAL PROTECTION DIODES 5.45 5.45 • COMPLI
BUZ907 MAGNA BUZ908 TEC MECHANICAL DATA Dimensions in mm P�CHANNEL POWER MOSFET +0.1 25.0 -0.15 8.7 Max. 10.90 � 0.1 1.50 11.60 POWER MOSFETS FOR Typ. � 0.3 AUDIO APPLICATIONS FEATURES 1 2 � HIGH SPEED SWITCHING � SEMEFAB DESIGNED AND DIFFUSED � HIGH VOLTAGE (220V & 250V) � HIGH ENERGY RATING R 4.0 � 0.1 R 4.4 � 0.2 � ENHANCEMENT MODE � INTEGRAL PROTECTION DIODES � COMPLI
BUZ905P MAGNA BUZ906P TEC MECHANICAL DATA Dimensions in mm (inches) P–CHANNEL POWER MOSFET 4.69 (0.185) 15.49 (0.610) 5.31 (0.209) 16.26 (0.640) 1.49 (0.059) 2.49 (0.098) POWER MOSFETS FOR AUDIO APPLICATIONS 3.55 (0.140) 3.81 (0.150) FEATURES 1 2 3 • HIGH SPEED SWITCHING 1.65 (0.065) 2.13 (0.084) 0.40 (0.016) • P–CHANNEL POWER MOSFET 0.79 (0.031) 2.87 (0.113) 3.1
BUZ902DP MAGNA BUZ903DP TEC MECHANICAL DATA Dimensions in mm N–CHANNEL POWER MOSFET 20.0 5.0 3.3 Dia. POWER MOSFETS FOR AUDIO APPLICATIONS FEATURES 1 2 3 • HIGH SPEED SWITCHING 2.0 1.0 2.0 • SEMEFAB DESIGNED AND DIFFUSED 3.4 • HIGH VOLTAGE (220V & 250V) • HIGH ENERGY RATING 0.6 1.2 • ENHANCEMENT MODE 2.8 • INTEGRAL PROTECTION DIODES 5.45 5.45 • COMPLI
BUZ902P MAGNA BUZ903P TEC MECHANICAL DATA Dimensions in mm N�CHANNEL 4.69 (0.185) 15.49 (0.610) POWER MOSFET 5.31 (0.209) 16.26 (0.640) 1.49 (0.059) 2.49 (0.098) POWER MOSFETS FOR AUDIO APPLICATIONS 3.55 (0.140) 3.81 (0.150) FEATURES 1 2 3 � HIGH SPEED SWITCHING 1.65 (0.065) 2.13 (0.084) 0.40 (0.016) � SEMEFAB DESIGNED AND DIFFUSED 0.79 (0.031) 2.87 (0.113) 3.12 (0.123) �
BUZ900X4S MAGNA BUZ901X4S TEC NEW PRODUCT UNDER DEVELOPMENT MECHANICAL DATA Dimensions in mm (inches) N–CHANNEL POWER MOSFET 11.8 (0.463) 12.2 (0.480) 31.5 (1.240) 31.7 (1.248) POWER MOSFETS FOR 8.9 (0.350) 7.8 (0.307) 4.1 (0.161 ) 8.2 (0.322) W = 9.6 (0.378) Hex Nut M 4 4.3 (0.169 ) (4 places) AUDIO APPLICATIONS 4.8 (0.187) H = 4.9 (0.193) 1 2 (4 places) R 4.0 (0.
1.20. buz905-06.pdf Size:40K _magnatec
BUZ905 MAGNA BUZ906 TEC MECHANICAL DATA Dimensions in mm P–CHANNEL POWER MOSFET +0.1 25.0 -0.15 8.7 Max. 10.90 ± 0.1 1.50 11.60 POWER MOSFETS FOR Typ. ± 0.3 AUDIO APPLICATIONS FEATURES 1 2 • HIGH SPEED SWITCHING • P–CHANNEL POWER MOSFET • SEMEFAB DESIGNED AND DIFFUSED • HIGH VOLTAGE (160V & 200V) R 4.0 ± 0.1 R 4.4 ± 0.2 • HIGH ENERGY RATING • ENHANCEM
BUZ90 (Siemens Semiconductor Group)
Power Transistor
No Preview Available !
Click to Download PDF File for PC
BUZ90 (Siemens Semiconductor Group)
Power Transistor
No Preview Available !
Характеристики полевых транзисторов. OrCAD PSpice. Анализ электрических цепей
Характеристики полевых транзисторов
Демонстрационная версия OrCAD имеет компоненты J2N3819 и J2N4393 в качестве моделей для полевых n-канальных транзисторов (JFET). Чтобы получить семейство выходных характеристик, создайте новый проект с именем Jfetch. Используем простую схему (рис. 15.22). Номинальные значения для VGS и VDD показаны на рисунке. Определите опции моделирования в Simulation Profile, используя имя jfetchs. Внутренний цикл вариации использует значения источника напряжения VDD от 0 до 12 В с шагом в 0,2 В. Внешний цикл определяется изменением напряжения VGS от 0 до 4 В с шагом в 1 В.
Рис. 15.22. Схема смещения для n-канального полевого транзистора
Выполните моделирование и получите в Probe график ID(J1). Вы должны получить семейство кривых с параметром VGS, приведенных на рис. 15.23. Кривые показывают, что наибольшие токи соответствуют VGS=0. Ниже расположена кривая с параметром VGS=–1 В и так далее. Напряжением отсечки является VGS=–3 В.
Рис. 15.23. Ток стока в n-канальном полевом транзисторе
Выходной файл включает параметры модели J2N3S19: пороговое напряжение (отсечки) VTO=-3 В, коэффициент передачи BETA и другие. Они отражены на рис. 15.24. В приложении D приведены все параметры модели для J (JFET).
**** 10/03/99 11:45:33 *********** Evaluation PSpice (Nov 1998) **************
** circuit file for profile: jfetchs
*Libraries:
* Local Libraries :
* From [PSPICE NETLIST] section of pspiceev.ini file:
.lib nom.lib
*Analysis directives:
.DC LIN V VDD 0V 12V 0.2V
+ LIN V_VGS 0V 4V 1V
.PROBE
*Netlist File:
.INC «jfetch-SCHEMATIC1.net»
*Alias File:
**** INCLUDING jfetch-SCHEMATIC1.net ****
* source JFETCH
J_J1 2 1 0 J2N3819
V_VDD 2 0 12V
V_VGS 0 1 1V
**** RESUMING jfetch-SCHEMATIC1-jfetchs.sim.cir
**** .INC «jfetch-SCHEMATIC1.als»
**** INCLUDING jfetch-SCHEMATIC1.als ****
.ALIASES
J_J1 J1(d=2 g=1 s=0 )
V_VDD VDD(+=2 -=0 )
V_VGS VGS(+=0 -=1 )
_ _(1=1)
_ _(2=2)
.ENDALIASES
.END
**** Junction FET MODEL PARAMETERS
J2N3819
NJF
VTO -3
BETA 1.304000E-03
LAMBDA 2.250000E-03
IS 33.570000E-15
ISR 322.400000E-15
ALPHA 311.700000E-06
VK 243.6
RD 1
RS 1
CGD 1.600000E-12
CGS 2.414000E-12
M .3622
VTOTC -2.500000E-03
BETATCE -.5
KF 9.882000E-18
Рис. 15.24. Выходной файл для n-канального полевого транзистора
Хотя предыдущие выпуски программного обеспечения от MicroSim использовали для создания рисунков программу Schematics вместо Capture, автоматически формируя команду .ОР в схемном файле, используемая в книге версия Capture этого не делает. Следовательно, значения параметров смещения не выводятся в выходном файле. Чтобы получить эти значения, отредактируете параметры настройки моделирования и запросите анализ параметров смещения путем проверки с опцией .OP. Выходной файл при таком запуске показан на рис. 15.25. Информация, дублирующая информацию предыдущего выходного файла, из него удалена. Убедитесь, что выходной файл соответствует графику, показывая VDD=12 В, VGS=–1 В, IDD=5,328 мА.
**** 10/03/99 12:27:36 *********** Evaluation PSpice (Nov 1998) **************
** circuit file for profile: jfetchs
*Libraries:
* Local Libraries :
* From [PSPICE NETLIST] section of pspiceev.ini file:
.lib nom.lib
*Analysis directives:
.OP
.PROBE
*Netlist File:
.INC «jfetch-SCHEMATIC1.net»
*Alias File:
**** INCLUDING jfetch-SCHEMATIC1.net ****
* source JFETCH
J_J1 2 10 J2N3819
V_VDD 2 0 12V
V_VGS 0 1 1V
**** RESUMING jfetch-SCHEMATIC1-jfetchs.sim.cir ****
.INC «jfetch-SCHEMATIC1.als»
**** INCLUDING jfetch-SCHEMATIC1.als ****
.ALIASES
J_J1 J1(d=2 g=1 s=0 )
V_VDD VDD(+=2 -=0)
V_VGS VGS(+=0 -=1 )
_ _(1=1)
_ _(2=2)
.ENDALIASES
**** RESUMING jfetch-SCHEMATIC1-jfetchs.sim.cir ****
.END
**** SMALL SIGNAL BIAS SOLUTION TEMPERATURE = 27.000 DEG С
NODE VOLTAGE NODE VOLTAGE NODE VOLTAGE NODE VOLTAGE
( 1) -1.0000 ( 2) 12.0000
VOLTAGE SOURCE CURRENTS
NAME CURRENT
V_VDD -5.328E-03
V_VGS -1.321E-12
TOTAL POWER DISSIPATION 6.39E-02 WATTS
**** JFETS
NAME J_J1
MODEL J2N3819
ID 5.33E-03
VGS -1.00E+00
VDS 1.20E+01
GM 5.34E-03
GDS 1.17E-05
CGS 1.83E-12
CGD 6.15E-13
Рис. 15.25. Выходной файл, использующий опцию .OР
Данный текст является ознакомительным фрагментом.
Продолжение на ЛитРесРуководство для начинающих по MOSFET
IRFP260N, изображение с сайта warf.com. Пины — Gate, Drain, Source слева направо.
Если вам нужно переключать сильноточные и / или высоковольтные нагрузки с помощью микроконтроллера, вам понадобится какой-либо тип транзистора. Я собираюсь рассказать, как использовать полевой МОП-транзистор, поскольку это лучший вариант для мощных нагрузок. Это руководство будет всего лишь кратким введением, в котором будет рассказано, как управлять MOSFET простым способом с конечной целью — заставить его работать как идеальный переключатель.Я не собираюсь вдаваться в такие темы, как область триода, насыщенность, пороговое напряжение и т. Д.
Обратитесь к базовой схеме подключения N- или P-канала и запомните три контакта: Gate, Drain и Source. Когда я упоминаю что-то вроде разности потенциалов затвор-исток, я имею в виду разницу в напряжении между двумя контактами.
Спасибо Farnell.com за поставку многих деталей, которые будут частью этого обзора / руководства. Я также хотел бы отметить, что все части работают отлично!
N-канальный полевой МОП-транзистор
Как думать о полевом МОП-транзисторе:
МОП-транзистор можно рассматривать как переменный резистор, сопротивление сток-исток которого (обычно Rds) является функцией разности напряжений на выводах затвор-исток.Если нет разницы потенциалов между затвором-источником, тогда сопротивление сток-исток очень велико и его можно рассматривать как разомкнутый переключатель, поэтому ток не может течь через контакты сток-исток. Когда существует большая разность потенциалов затвор-исток, сопротивление сток-исток очень низкое и его можно рассматривать как замкнутый переключатель — ток может течь через контакты сток-исток.
МОП-транзистор с каналом P
N-канал — для N-канального MOSFET источник заземлен.Если мы хотим позволить току течь, мы можем легко поднять напряжение на затворе, позволяя току течь. Если ток не должен течь, штифт затвора должен быть заземлен.
Канал P — если посмотреть на полевой МОП-транзистор с каналом P, то можно увидеть, что источник подключен к шине питания V2. Чтобы позволить току течь, ворота должны быть заземлены. Чтобы остановить прохождение тока, затвор нужно подтянуть к V2. Потенциальная проблема заключается в том, что если V2 представляет собой очень высокое напряжение, может быть трудно поднять затвор до напряжения V2.Более того, MOSFET имеет ограничения на разность потенциалов затвор-исток. Также обратите внимание, что логика инвертирована для МОП-транзистора P-типа!
Сопротивление сток-источник — в идеале мы хотим, чтобы сопротивление сток-источник было очень высоким, когда ток не течет, и очень низким, когда ток течет. Основная проблема, связанная с использованием полевых МОП-транзисторов с микроконтроллерами, заключается в том, что для МОП-транзистора может потребоваться разность потенциалов 10-15 затвор-исток, чтобы приблизиться к самому низкому сопротивлению сток-исток, но микроконтроллер может работать от 5 В или 3 В.3в. Требуется какой-то драйвер MOSFET.
IRFP260N емкость затвора
Кривые тока IRFP260N.
Емкость затвор-исток — на выводах затвор-исток также имеется емкость, которая не позволяет полевому МОП-транзистору быстро переключать состояния. Чтобы быстро изменять напряжение на внутренней емкости, драйвер MOSFET должен быть сильноточным. Он также должен активно заряжать (источник) и разряжать (сток) конденсатор (для канала N)!
Драйверы MOSFET:
Полумост способен на то, что было сказано выше! Есть много доступных микросхем, которые могут это сделать.Вот список из нескольких, которые я протестировал. Схемы также предоставляются!
Драйвер Fet — полумост
- MIC4422YN — Макс 18 В, пик 9 А, непрерывный 2 А.
- MCP1407 — Макс 18 В, 6 А в пике, 1,3 А в непрерывном режиме.
- UCC27424 — Может управлять двумя полевыми МОП-транзисторами, макс. 15 В, типичное значение 4 А.
Все эти драйверы работали примерно одинаково (подъем ~ 20 нс, спад ~ 30 нс). Обратите внимание, что, хотя они могут использоваться не только для драйверов MOSFET, эти микросхемы не обладают большой способностью рассеивать тепло!
МОП-транзисторов, которые я тестировал:
Изначально планировалось собрать данные об этих парнях, но я был очень занят школой.В таблицах данных для полевых МОП-транзисторов есть множество графиков!
Корпусный диод полевого МОП-транзистораP вызывает непреднамеренное протекание тока.
UCC27424
MIC4422YN и MCP1407
- IRFP260N — канал 200В, 50А, N.
- IRF3703PBF — 30в, 210А, канал N. Вводящие в заблуждение рейтинги! Прочтите мои примечания к таблице данных в конце.
- RFP30N06LE — канал 60в, 30А, N.
- FQP27P06– 60В, 27А, канал P.
Важное напоминание — не забывайте, что обычно радиатор на задней панели МОП подключается к сливу! Если вы устанавливаете несколько полевых МОП-транзисторов на радиатор, они должны быть электрически изолированы от радиатора! Если радиатор прикреплен к заземляющей раме болтами, рекомендуется изолировать его.
Корпусный диод— МОП-транзисторы также имеют внутренний диод, который может пропускать ток непреднамеренно (см. Пример). Внутренний диод также ограничивает скорость переключения. Это не будет проблемой, если вы работаете на частоте ниже 1 МГц.
Отличная шпаргалка, включая МОП-транзисторы. — akafugu.jp
Примечание о затворе — Напряжение источника: затворы MOSFET могут быть выше или ниже напряжения источника. Таким образом, для N-канального МОП-транзистора с источником на 0 В, -10 В на затворе позволит току течь. Проверьте это с помощью таблицы данных вашего MOSFET!
Схема диода— Если нагрузка несколько индуктивная, вам потребуется установить диод для разряда индуктивности.Если вы хотите получить более подробную информацию, посмотрите pdf-файл International Rectifier в конце. В моем «Введение в повышающий преобразователь» также рассказывается о природе индукторов при быстром включении / выключении.
Звонок от ворот-источника — Есть несколько методов, о которых я слышал / видел, чтобы ограничить звонок на воротах. Звонок снижает эффективность и, если он чрезмерен, может повредить полевой МОП-транзистор. Вы можете использовать стабилитрон и резистор последовательно с катодом стабилитрона, подключенным к затвору, анодом, подключенным к истоку для канала N. Канал P будет перевернут стабилитроном.Добавьте резистор, чтобы ограничить ток, проходящий через стабилитрон, и наблюдайте за этими пробивными напряжениями! Есть также еще один диод, который вы могли бы изучить, называемый TVS-диодом.
Примечания к техническому паспорту — Если у детали слишком хорошие, чтобы соответствовать действительности, внимательно ознакомьтесь с примечаниями к применению. Например, IRF3703PBF требует постоянного тока стока 210 А при 25ºC. Нам не нужно делать никаких тепловых расчетов, чтобы знать, что 220 А — это ТОННА тока для корпуса TO-220! При более внимательном рассмотрении на странице 8, примечание 6 видно, что он может непрерывно пропускать максимум 75 А из-за тепловых ограничений корпуса.На будущее: IRF довольно хорошо дает точные рейтинги, но вы должны искать такие вещи. Сейчас в реальном мире множество тестов показывает, плохой ли ваш дизайн, или вы работаете с нечестным или некомпетентным поставщиком с неточными / вводящими в заблуждение таблицами данных.
UCC27424, MIC4422YN, MCP1407
Пример Arduino Mosfet
Без драйвера для зарядки Gate требуется больше времени, и его пик составляет 5 В. Чрезмерный звон из-за отсутствия подавления звонка на затворе.
Большое дополнительное чтение:
Информация по применению MOSFET International Rectifier MOSFET
Руководство по высокоскоростному полевому МОП-транзистору
M: полевой МОП-транзистор
M: полевой МОП-транзисторДалее: Q: Биполярный переходный транзистор Up: Описание схемы Предыдущая: L: Индуктор & nbsp Содержание
Подразделы
M xxxxxxx nd ng ns nb mname { args }
M xxxxxxx ng ns nb mname { ширина / длина } { args }
.MOSfet label nd ng ns nb mname { args }
.MOSfet этикетка nd ng ns nb mname { ширина / длина } { args }
МОП-транзистор.
Nd , ng , ns и nb — сток, затвор, исток и объемные (субстратные) узлы соответственно. Mname — это название модели.
Длина и ширина — длина и ширина нарисованного канала, дюйм микрон.Обратите внимание, что обозначение W / L имеет единицы микрон, но то же самое параметры, в списке аргументов (W и L) указаны единицы измерения. Все остальные размеры указаны в метрах.
Параметры rstray и norstray определяют, нужно ли включены последовательные сопротивления. rstray используется по умолчанию. Опыт показал, что эффект последовательного сопротивления часто отсутствует. значительный, это может значительно снизить время моделирования, и это часто увеличивает ошибки округления. rstray по умолчанию для Совместимость со специями, и потому что это обычно важно для BJT модель.Norstray — это эквивалент установки модели параметры rd, rs и rsh равны нулю.
Ввод значения параметра 0 — это не то же самое, что не указывать Это. Такое поведение несовместимо со SPICE. В SPICE значение 0 часто интерпретируется как не указанное, в результате чего вычислить его другим способом. Если вы хотите, чтобы он был рассчитан, не указывайте это.
Еще одно тонкое отличие от SPICE заключается в том, что Gnucap может опускать некоторые ненужные части модели, которые могут повлиять на некоторые заявленные ценности.Это не должно влиять на напряжение или ток. Например, если затвор и слив связаны, Cgs в модели не будет, поэтому напечатанное значение для Cgdovl и Cgd будет 0, что будет не согласен со SPICE. Это не имеет значения, потому что закороченный конденсатор можно хранить бесплатно.
Реализованы уровни 1, 2, 3, 4, 5, 6, 7.
Основные параметры, совместимые со Spice
- L = x
- Длина вытяжного канала. (По умолчанию = параметр DEFL из options.DEFL по умолчанию = 100)
- W = x
- Ширина вытяжного канала. (По умолчанию = параметр DEFW из опций. DEFW по умолчанию = 100)
- AD = x
- Зона дренажного диффузора. (По умолчанию = параметр DEFAD из опций. DEFAD по умолчанию = 0)
- AS = x
- Область распространения источника. (По умолчанию = параметр DEFAS из опций. DEFAS по умолчанию = 0)
- PD = x
- Периметр водосточного примыкания.(По умолчанию = 0.)
- PS = x
- Периметр примыкания к источнику. (По умолчанию = 0.)
- NRD = x
- Количество квадратов дренажной диффузии. (По умолчанию = 1.)
- NRS = x
- Количество квадратов источника рассеивания. (По умолчанию = 1.)
Базовый выбор — требуется для всех моделей
- УРОВЕНЬ = x
- Модельный индекс.(По умолчанию = 1) Выбирает, какую из нескольких моделей использовать. Поддерживаются варианты 1-7, соответствующие Spice 3f5.
Расширенное управление (не в Spice) — все модели
- CMODEL = x
- Селектор модели емкости (по умолчанию = 1 для уровней 4,5,7. По умолчанию = 2 для уровня 1,2,3. По умолчанию = 3 для уровня 6.) Единственные допустимые значения: 1, 2 и 3. 2 выбирает расчет емкости Мейера, совместимый с Spice 2. 3 выбирает модель Мейера, совместимую со Spice 3.1 выбирает не использовать модель Мейера.
Биннинг (не в Spice) — все модели
Gnucap поддерживает « биннинг ». Вы можете указать любое количество моделей как семья. Эти модели должны иметь параметры выбора WMAX, WMIN, LMAX и LMIN.
Чтобы использовать « биннинг », определите набор моделей с тем же именем, кроме для числового расширения, начинающегося с 1. Модели должны быть пронумерованы последовательно. Например, у вас может быть набор моделей: NM3U.1, NM3U.2, NM3U.3, NM3U.4, NM3U.5, NM3U.6. Для устройства вы должны указать модель NM3U. В первая модель, отвечающая требованиям, длина между LMIN и LMAX, а ширина между WMIN и WMAX будет использовал. Они будут проверяться в порядке номеров.
Если в нумерации есть пробел, только те, что ниже пробела, будут использовал. Если вам нужна конкретная модель из набора, отключив биннинг, вы можете указать его полное название.
- WMAX = x
- Максимальная ширина.(По умолчанию = Infinity.) Максимальная ширина устройства, которое может использоваться с этой моделью.
- WMIN = x
- Максимальная ширина. (По умолчанию = 0.) Минимальная ширина устройства, которая может быть используется с этой моделью.
- LMAX = x
- Максимальная длина. (По умолчанию = бесконечность.) Максимальная длина устройства, которое может использоваться с этой моделью.
- LMIN = x
- Максимальная длина. (По умолчанию = 0.) Минимальная длина устройства, которая может быть используется с этой моделью.
Соединение субстрата — все модели
- IS = x
- Ток насыщения объемного перехода. Если не ввод, он рассчитывается из JS. Если оба введены, выдается предупреждение, и вычисляемый значение (из JS) используется, если AD и AS также Вход. Если ни IS, ни JS не введены, значение по умолчанию 1e-14 используется.
- JS = x
- Ток насыщения объемного перехода на квадратный метр площади перехода.Может использоваться для расчета IS. Если существует конфликт, выдается предупреждение. изданный.
- FC = x
- Коэффициент для формулы истощающей емкости прямого смещения. (По умолчанию = 0,5)
- PB = x
- Потенциал объемного перехода. (По умолчанию = 0,8)
- CJ = x
- Нижняя емкость объемного перехода при нулевом смещении на квадратный метр перехода площадь. Если не ввод, но есть NSUB, он вычисляется, в противном случае по умолчанию используется значение 0.
- МДж = x
- Коэффициент градации дна объемного стыка. (По умолчанию = 0,5)
- PBSW = x
- Боковая стенка Потенциал объемного перехода. (По умолчанию = PB)
- CJSW = x
- Емкость боковой стенки объемного перехода без смещения на метр перехода периметр. (По умолчанию = 0.)
- MJSW = x
- Коэффициент градации боковины объемного стыка.(По умолчанию = 0,33)
Бродяги — все модели
- RSH = x
- Сопротивление диффузионного слоя дренажа и источника. Если нет ввода, используйте RS и RD напрямую. Если существует конфликт, выдается предупреждение. Сопротивление используется, только если установлена опция rstray.
- RD = x
- Омическое сопротивление стока (немасштабированное). Если вводится RS, по умолчанию значение RD равно 0. Если оба RD и RS не введены, и RSH является входным, они вычисляются из RSH.Если есть существует конфликт, выдается предупреждение с указанием предпринятых действий, который считается совместимым со SPICE. Сопротивление только используется, если установлена опция rstray.
- RS = x
- Омическое сопротивление источника (немасштабированное). Если вводится RD, по умолчанию значение RS равно 0. Если оба RD и RS не введены, и RSH является входным, они вычисляются из RSH. Если есть существует конфликт, выдается предупреждение с указанием предпринятых действий, который считается совместимым со SPICE.Сопротивление только используется, если установлена опция rstray.
- CBD = x
- Емкость B-D перехода при нулевом смещении (немасштабированная). Если CBD не указано, он рассчитывается от CJ.
- CBS = x
- Емкость перехода B-S при нулевом смещении (немасштабированная). Если CBS не указано, он рассчитывается от CJ.
- CGSO = x
- Емкость перекрытия затвор-исток, на ширину канала.(По умолчанию = 0.)
- CGDO = x
- Емкость перекрытия затвор-сток, на ширину канала. (По умолчанию = 0.)
- CGBO = x
- Емкость перекрытия затвор-большая часть, на длину канала. (По умолчанию = 0.)
Принято и проигнорировано — все модели
- KF = x
- Коэффициент фликкер-шума. Параметр SPICE принят, но не реализовано.
- AF = x
- Показатель фликкер-шума.Параметр SPICE принят, но не реализован.
Общие параметры уровня 1,2,3,6
- VTO = x
- Пороговое напряжение нулевого смещения. Если нет ввода, но есть NSUB, то это вычисляется, в противном случае используется значение по умолчанию 0.
- КП = x
- Параметр крутизны. Если не введено, рассчитывается UO * COX.
- ГАММА = x
- Пакетный пороговый параметр.Если нет ввода, но есть NSUB, то это вычисляется, в противном случае используется значение по умолчанию 0.
- PHI = x
- Поверхностный потенциал. Если не ввод, а NSUB, он рассчитывается, в противном случае используется значение по умолчанию 0,6. Выдается предупреждение, если расчетное значение меньше 0,1, в этом случае используется 0,1.
- ЛЯМБДА = x
- Модуляция длины канала. Если не ввод, он рассчитывается динамически. во время моделирования.Если введенное значение больше 0,2, появится предупреждение. выдается, но исправления не вносятся. (принято, но игнорируется для уровня 3)
- ТОКС = x
- Толщина оксида. (метры) (по умолчанию = 1e-7)
- NSUB = x
- Легирование подложки. (атомов / см) Используется при расчете VTO, ГАММА, ФИ и CJ. Если не введено, значения по умолчанию используются.
- NSS = x
- Плотность состояния поверхности.(атомов / см) (по умолчанию = 0.) Используется, с НСУБ в расчете ВТО.
- XJ = x
- Металлургическая глубина стыка. (метры) Используется для расчета короткого канала эффекты. Если нет ввода, не моделируйте эффекты короткого канала, фактически по умолчанию 0.
- LD = x
- Боковое распространение. (По умолчанию = 0.) Эффективная длина канала уменьшена. на 2 * LD.
- UO = x
- Подвижность на поверхности.(см / В-с) (по умолчанию = 600.)
- ДЕЛЬТА = x
- Влияние ширины на пороговое напряжение. (По умолчанию = 0.) (Уровень 2 и 3 Только.)
- TPG = x
- Тип материала ворот. (По умолчанию = 1.)
+1 напротив субстрата
-1 то же, что и подложка
0 Алюминий
1-й уровень
Модель уровня 1 не имеет дополнительных параметров.
Уровень 2
- NFS = x
- Быстрая плотность состояний поверхности.(атомов / см) Используется при моделировании подпороговые эффекты. Если не вводится, не моделируйте подпороговое значение. эффекты.
- VMAX = x
- Максимальная скорость дрейфа носителей. (м / с) Используется при расчете vdsat, и лямбда. Если нет ввода, используйте другой метод. VMAX делает не всегда работает, если метод дает сбой, используется альтернативный метод и предупреждение « Теория Баума отклонена » выдается, если ошибка Порог установлен на отладку или хуже.
- NEFF = x
- Коэффициент суммарной платы за канал (фиксированный и мобильный).(По умолчанию = 1.) Используется во внутреннем расчете лямбды.
- UCRIT = x
- Критическое поле для снижения мобильности. (В / см) (по умолчанию = 1e4)
- UEXP = x
- Критическая экспонента поля в деградации подвижности. Если нет ввода, не деградация мобильности модели, значение по умолчанию равно 0.
- UTRA = x
- Коэффициент поперечного поля. Параметр SPICE принят, но не реализовано.Это также не реализовано в большинстве версий SPICE.
Уровень 3
- NFS = x
- Быстрая плотность состояний поверхности. (атомов / см) То же, что и уровень 2.
- VMAX = x
- Максимальная скорость дрейфа носителей. (м / с) Используется при расчете vdsat. Если нет ввода, используйте другой метод.
- THETA = x
- Модуляция подвижности.
- ETA = x
- Статическая обратная связь.
- КАППА = x
- Вектор поля насыщенности.
6 уровень
- КВ = x
- Коэффициент напряжения насыщения.
- NV = x
- Коэффициент напряжения насыщения.
- KC = x
- Коэффициент тока насыщения.
- NC = x
- Коэффициент тока насыщения.
- NVTH = x
- Пороговый коэффициент напряжения.
- PS = x
- Сб. текущая модификация пар.
- ГАММА1 = x
- Параметр массового порога 1.
- СИГМА = x
- Эффект статической обратной связи пар.
- LAMBDA1 = x
- Параметр модуляции длины канала. 1.
Общие комментарии по уровням 4, 5, 7, 8 (модели BSIM)
Модели BSIM имеют дополнительные параметры для длины, ширины и зависимость продукта (длина * ширина).Чтобы получить имя, добавьте префикс Параметр в списке обозначается буквой L, W или P соответственно. Spice поддерживает Параметр « P » только для BSIM3, но Gnucap поддерживает его для всех 3 модели. Например, VFB является основным параметром с единицами измерения вольт, также существуют LVFB, WVFB и PVFB. Единицы LVFB и WVFB: Вольт * мкм. Единицы измерения ПВФБ — Вольт * микрон * микрон. В реальный параметр рассчитывается по , где L и W — эффективная длина и ширина в микронах.
Параметры s здесь не указаны, но они такие же, как у Spice. 3f5 с теми же значениями по умолчанию.
« Уровни » такие же, как у Spice.
- 4
- BSIM 1.
- 5
- BSIM 2.
- 7
- BSIM 3v3.1.
Следующее зарезервировано для использования в будущем:
- 8
- BSIM 3v3.2.
- 9
- BSIM-SOI.
- 10
- BSIM 4.
- VDS
- Напряжение сток-исток.
- ВГС
- Напряжение затвор-исток.
- ВБС
- Напряжение накопителя.
- VDSInt
- Внутреннее напряжение сток-исток.
- VGSInt
- Внутреннее напряжение затвор-исток.
- VBSInt
- Внутреннее напряжение накопительного источника.
- VGD
- Напряжение затвор-сток.
- VBD
- Напряжение накопительного стока.
- VSD
- Напряжение исток-сток.
- ВДМ
- Напряжение средней точки стока.
- ВГМ
- Напряжение затвора-средней точки.
- ВБМ
- Напряжение средней емкости.
- VSM
- Напряжение средней точки источника.
- VDG
- Напряжение сток-затвор.
- VBG
- Напряжение на затворе.
- VSG
- Напряжение исток-затвор.
- VDB
- Напряжение стока-накопителя.
- VGB
- Напряжение затвор-накопитель.
- VSB
- Источник-объемное напряжение.
- VD
- Напряжение сток-земля.
- VG
- Напряжение затвор-земля.
- VB
- Напряжение на основной массе.
- VS
- Напряжение «источник-земля».
- Id
- Отводящий ток.
- IS
- Источник тока.
- IG
- Ток затвора.
- IB
- Объемный ток.
- CGSO
- Емкость перекрытия затвор-исток.
- CGDO
- Емкость перекрытия затвор-сток.
- CGBO
- Емкость перекрытия затвор-большая часть.
- CGSm
- Емкость Мейера затвор-исток.
- CGDm
- Емкость Мейера затвор-сток.
- CGBm
- Затворно-объемная емкость Мейера.
- CGST
- Общая емкость затвор-исток.
- CGDT
- Общая емкость затвор-сток.
- CGBT
- Общая емкость затвора.
- CBD
- Емкость перехода объемный сток.
- CBS
- Емкость перехода объемного истока.
- CGATE
- Номинальная емкость затвора.
- GM
- Крутизна.
- ГДС
- Проводимость сток-исток.
- ГМБ
- Крутизна эффекта тела.
- VDSAT
- Напряжение насыщения.
- VTH
- Пороговое напряжение.
- IDS
- Ток утечки-источника, не включая паразитные.
- IDSTray
- Утечка тока из-за паразитов.
- IE Ошибка
- Расчетная граница ошибки тока стока.
- п.
- Мощность.
- ПД
- Рассеиваемая мощность. Мощность рассеивается в виде тепла. Это всегда положительный и не включает источник питания. Он должен быть таким же, как P, потому что МОП-транзистор не может генерировать энергию.
- PS
- Источник энергии.Мощность, исходящая от детали. Это всегда положительно и не учитывает собственное рассеивание. Это должно быть 0, потому что MOSFET не может генерировать энергию.
- РЕГИОН
- Код региона. Числовой код, представляющий регион, в котором он находится.
Действует. Число — это сумма нескольких факторов. Отрицательный
код указывает, что исток и сток поменяны местами.
- 1 Активно. (Не отрезано.)
- 2 Не подпороговое значение.
- 4 Насыщенный.
- 10 Прямое смещение от источника к большому.
- 20 Отвод к массе смещен вперед.
- 40 Пробить.
Все параметры внутренних элементов (Ids, Gmr, Gmf, Yds, Gmbr, Gmbf, Cgb, Cgd, Cgs, Dsb, Ddb, Rd, Rs) доступны. Чтобы получить к ним доступ, соедините метки внутреннего элемента с этим устройством, разделенные точкой. Cgd.M6 — это емкость затвора для стока M6.
В этом выпуске нет доступных зондов для анализа переменного тока, кроме для внутренних элементов.
Далее: Q: Биполярный переходный транзистор Up: Описание схемы Предыдущая: L: Индуктор & nbsp Содержание Эл Дэвис 2002-03-26
Оптимизация амбиполярного тока и аналоговых / радиочастотных характеристик Т-образного туннельного полевого транзистора с диэлектрической прокладкой затвора
1. ВведениеПоскольку размеры полевого МОП-транзистора постоянно масштабируются, на характеристики полевого МОП-транзистора влияют различные эффекты короткого канала (SCE), например, снижение барьера, вызванное стоком, поверхностное рассеяние и т. д. [1–3] Кроме того, по мере того, как размеры устройства продолжают уменьшаться, влияние подпороговых токов утечки на потребляемую мощность устройства становится все более серьезным. [4–6] Однако для MOSFET инжекция носителей в переход источник-канал определяется термоэлектронной эмиссией над встроенным потенциальным барьером, и, следовательно, обратный подпороговый наклон ограничен 60 мВ / декаду при комнатной температуре. [7,8] Таким образом, туннельный полевой транзистор (TFET) активно исследуется как один из наиболее многообещающих кандидатов для будущих приложений со сверхнизким энергопотреблением.Благодаря механизму ввода несущей, основанному на межполосном туннелировании (BTBT), TFET может преодолеть подпороговое ограничение размаха 60 мВ / дек обычного полевого МОП-транзистора. [9–15] Однако низкий прямой ток и значительный амбиполярный ток являются основными недостатками традиционных кремниевых транзисторов TFET, которые ограничивают использование TFET в маломощных и высокочастотных приложениях. [16–21] Чтобы улучшить ток возбуждения при уменьшении занимаемой площади TFET, были предложены различные L-образные архитектуры, основанные на перекрывающейся структуре затвор-исток и вертикальном канале. [22–32] Однако было указано, что обычный L-TFET страдает тяжелым амбиполярным поведением, которое требует дальнейшей оптимизации. [32,33]
Недавно был предложен Т-образный TFET (TTFET) с перекрытием затвор-сток (GDO) для одновременного улучшения тока возбуждения и подавления амбиполярного тока. [34] Однако было обнаружено, что этот Т-образный TFET со структурой GDO (GDO-TTFET) может подавлять амбиполярный ток только при низком В ds .Кроме того, структура GDO также увеличивает емкость затвор-сток, что приводит к плохим ВЧ / аналоговым характеристикам.
Для подавления амбиполярного тока в более широком диапазоне смещения при одновременном улучшении ВЧ / аналоговых характеристик в этой статье предлагается новый Т-образный TFET с диэлектрической прокладкой затвора (GDS). Результаты моделирования TCAD показывают, что предложенный нами Т-образный TFET с GDS (GDS-TTFET) не только подавляет амбиполярный ток в более широком диапазоне смещения, но также улучшает аналоговые / радиочастотные характеристики по сравнению с GDO-TTFET.Чтобы реализовать предложенную структуру GDS, достаточно вставить слой диэлектрика с низким значением κ между диэлектриком с высоким значением κ и материалом электрода затвора. Кроме того, процесс GDS-TTFET совместим с процессом самовыравнивания, используемым в Ref. [33], что делает процесс GDS-TTFET намного проще, чем GDO-TTFET.
2. Структура устройства и метод моделированияПредлагаемый Т-образный TFET с диэлектрической прокладкой затвора (GDS-TTFET) показан на рис. 1 (а).Устройство содержит два вертикальных канала с перекрытием затвора и две слаболегированные области туннелирования p-типа, расположенные между истоком и диэлектрическим слоем затвора. Под электродом затвора между электродом затвора и диэлектриком затвора с высоким значением κ вставлена диэлектрическая прокладка с низким значением κ . На основе этапов процесса LTFET, продемонстрированных в работе. [33], Т-образный TFET (TTFET) с симметричной вертикальной двойной структурой затвора может быть легко изготовлен. Следовательно, на основе традиционных процессов TTFET структура, предложенная в этой статье, может быть достигнута только путем добавления слоя диэлектрической прокладки затвора.
Подробные параметры устройства перечислены ниже: высота затвора H G = 50 нм, высота истока H S = 30 нм, высота стока H D = 10 нм, ширина затвора W G = 10 нм, ширина источника W S = 20 нм, ширина области туннелирования между источником и диэлектрическим слоем затвора W tun = 3 нм, толщина диэлектрика затвора κ T OX = 2 нм, высота вставленной диэлектрической прокладки затвора низкой κ по умолчанию H прокладка = 4 нм), рабочая функция затвора Ф = 4.2 эВ, p + Тип допирование источника N S = 10 20 см −3 , p — Тип легирование канала N Sub = 10 17 см −3 , а n + типа дренажное легирование N D = 10 20 см −3 . Для сравнения, обычные TTFET и GDO-TTFET, предложенные в Ref. [34] также показаны на рис. 1 (б) и 1 (в) соответственно.
В этой статье все три упомянутых выше устройства основаны на кремнии и исследованы с использованием Sentaurus TCAD с динамической нелокальной моделью туннелирования.С этим динамическим нелокальным туннельным подходом пути туннелирования динамически определяются в соответствии с изменением электрического поля, поэтому он может более точно моделировать процесс туннелирования, особенно для непланированных TFET, таких как L-образные и T-образные TFET. Согласно исх. В [37] два калиброванных коэффициента туннельной модели Кейна для кремния равны и B = 9,9 · 10 6 В / см. В дополнение к модели BTBT, модель сужения запрещенной зоны OldSlotboom и модель рекомбинации Шокли – Рида – Холла также используются в симуляциях TCAD.Для простоты рассмотрена идеализированная структура устройства с резкими переходами исток / сток-канал, а ловушки и заряды, связанные с дефектами, в этой статье не рассматриваются.
3. Результаты моделирования и обсуждение 3.1. Сравнение характеристик обычных TTFET, GDO-TTFET и GDS-TTFETI ds — В gs для обычных TTFET, GDO-TTFET и GDS-TTFET при В ds = V показано на рис. 2. Ясно, что при V gs имеет отрицательное смещение от −2.От 0 В до 0 В GDS-TTFET имеет самый низкий амбиполярный ток. В частности, когда В gs = -1,0 В, биполярный ток GDS-TTFET уменьшается на порядок, что на 4 порядка меньше, чем у обычного TTFET, и на 5 порядков ниже, чем у ГДО-ТТФЕТ. Также следует отметить, что, поскольку структура источника обычных TTFET, GDO-TTFET и GDS-TTFET идентична, I ds — V GS из этих трех устройств одинаковы, когда V GS имеет положительное смещение от 0 В до 2.0 В.
Чтобы дополнительно объяснить, почему структура GDS может эффективно подавлять амбиполярный ток, профили энергетических диапазонов обычных TTFET, GDO-TTFET и GDS-TTFET показаны на рис. 3. Можно увидеть, что когда V ds = 1,5 В и В gs = −2,0 В зона проводимости стока находится намного ниже валентной зоны канала, что создает широкое туннельное окно для дырок из зоны проводимости стока в валентная зона канала при отрицательном смещении напряжения затвора.По мере появления туннельных окон вероятность межзонного туннелирования (BTBT) в основном определяется шириной туннельного барьера, который определяется как ближайшее расстояние между зоной проводимости и валентной зоной при открытом туннельном окне. Вставляя диэлектрическую прокладку затвора с низким значением κ между электродом затвора и диэлектриком затвора, структура GDS эффективно снижает влияние смещения затвора на потенциал бокового канала, когда напряжение затвора имеет обратное смещение В gs = −2.0 В, что приводит к медленному изменению профиля энергетической зоны. Из рисунка 3 видно, что GDS-TTFET имеет наибольшее расстояние туннелирования, что означает наименьшую вероятность туннелирования и, следовательно, наименьший амбиполярный ток при отрицательном смещении напряжения затвора.
Также следует отметить, что хотя GDO-TTFET имеет большую ширину туннелирования, чем обычный TTFET, он имеет больший амбиполярный ток, чем обычный TTFET. Это связано с тем, что при использовании структуры перекрытия затвор-сток (GDO), ток BTBT GDO-TTFET определяется компонентом туннелирования, перпендикулярным каналу, что также называется «туннелирование линии». [11]
На рисунке 4 показана диаграмма энергетических полос, перпендикулярная каналу, для обычных TTFET, GDO-TTFET и GDS-TTFET. Можно видеть, что диаграмма энергетических зон GDO-TTFET имеет наиболее значительную кривизну изгиба зон на поверхности канала, что приводит к небольшому туннельному расстоянию между валентной зоной и зоной проводимости, что приводит к значительному «туннельному» току BTBT. . Однако для GDS-TTFET кривизна изгиба полосы, перпендикулярная направлению канала, настолько мала, что нет окон туннелирования и не происходит «туннелирования линии».
Рис. 4.
| Рис. 4. Диаграмма энергетических зон перпендикулярно каналу при В ds = 1,5 В и В — gs — gs 2,0 В для обычных TTFET, GDO-TTFET и GDS-TTFET. |
Для лучшего объяснения, 2D контурные графики поколения BTBT G BTBT для обычных TTFET, GDO-TTFET и GDS-TTFET при V ds = 1.5 В и В gs = −2,0 В показаны на рисунке 5. Согласно рисунку 5 пиковое значение GDS-TTFET G BTBT составляет порядка 10 25 , что на 6 порядков меньше, чем у обычных TTFET и GDO-TTFET. Поскольку более высокое значение G BTBT и большая зона распределения BTBT приведут к большему туннельному току, GDS-TTFET имеет самый низкий амбиполярный ток. Кроме того, хотя пиковое значение G BTBT обычного TTFET и GDO-TTFET имеет один и тот же порядок величины, поскольку площадь туннелирования GDO-TTFET намного больше, чем у обычного TTFET, GDO -TTFET имеет самый большой амбиполярный туннельный ток, когда напряжение затвора смещено на В гс = −2.0 V.
Рис. 5.
| Рис. 5. 2D контурные графики поколения BTBT G BTBT для обычных TTFET (a), GDO (б) и GDS-TTFET (в) с В ds = 1,5 В и В gs = −2,0 В. |
Изменение электрического поля вдоль поверхности канала от канала к стоку для обычные TTFET, GDO-TTFET и GDS-TTFET показаны на рис.6. Как видно из рис. 6, для обычных TTFET и GDS-TTFET существует всплеск изменения электрического поля на границе раздела между областью канала и областью стока. Согласно теории Кейна, когда происходит межзонное туннелирование, вероятность туннелирования экспоненциально зависит от локальной напряженности электрического поля. Можно видеть, что напряженность электрического поля GDS-TTFET вблизи интерфейса канал / сток намного меньше, чем у обычного TTFET, что означает, что GDS-TTFET имеет более низкий амбиполярный ток, чем обычный TTFET.Из-за структуры перекрытия затвор-сток, используемой в GDO-TTFET, изменение электрического поля GDO-TTFET отличается от такового у обычных TTFET и GDS-TTFET. Во всей области перекрытия затвор-сток напряженность электрического поля GDO-TTFET остается постоянной на уровне около 1,0 × 10 7 В / см, что приводит к значительному «туннельному» току линии.
Рис. 6.
| Рис. 6. Изменение только электрического поля поверхности канала от канала к стоку для обычных TTFET, GDO-TTFET и GDS-TTFET с В дс = 1.5 В и В gs = -2,0 В. |
Кроме того, пик изменения электрического поля на поверхности перехода сток / канал является основной причиной эффектов горячих носителей, которые приводят к спад порогового напряжения и низкая надежность устройства. [35] На рис. 6 показано, что структура GDS может помочь уменьшить поверхностное электрическое поле вблизи перехода сток / канал. У GDS-TTFET электрическое поле примерно в 3 раза меньше, чем у обычного TTFET.Следовательно, по сравнению с обычным TTFET, GDS-TTFET имеет лучшее подавление эффектов горячей несущей, следовательно, меньший спад порогового напряжения и лучшую надежность устройства.
Когда V ds маленький, GDS-TTFET все еще имеет преимущество перед обычными TTFET и GDO-TTFET. Как показано на рис. 7, когда В gs смещено в определенном диапазоне напряжений, амбиполярное напряжение равно току выключенного состояния TTFET, что означает, что TTFET выключен. Видно, что GDS-TTFET имеет самый широкий диапазон выключенного состояния по сравнению с другими (для TTFET, для GDO-TTFET и для GDS-TTFET).Эта уникальная особенность GDS-TTFET делает его более перспективным для применения в интегральных схемах.
3.2. Паразитная емкость и характеристики аналогового / ВЧ-сигналаЗа счет вставки разделительного слоя κ между электродом затвора и диэлектриком затвора структура GDS не только эффективно подавляет биполярный ток, но и снижает паразитные емкости между затвором и истоком. стока, которые являются жизненно важными параметрами для аналоговых / радиочастотных характеристик TTFET. На рисунке 8 показаны паразитные емкости затвор-исток и затвор-сток в зависимости от напряжения затвора для обычных TTFET, GDO-TTFET и GDS-TTFET.Для простоты В ds = 1,0 В, частота моделирования переменного тока установлена на 1 МГц.
Рис. 8.
| Рис. 8. Зависимость паразитной емкости затвор-исток и затвор-сток от напряжения затвора для обычных TTFET, GDO-TTFET и GDS-TTFET с V ds = 1,0 В. |
Можно видеть, что по сравнению с обычными TTFET и GDO-TTFET, GDS-TTFET не только имеет меньшую емкость затвор-исток, но и меньшую емкость затвор-сток, которая имеет существенное влияние на частоту среза f T и усиление полосы пропускания производства (GBP).
Кроме того, также обнаружено, что емкость затвор-исток C gs и емкость затвор-сток C gd имеют противоположные тенденции с напряжением затвора В gs . Для TFET области истока и стока имеют разные типы легирования. В этой статье область истока сильно легирована примесью P-типа, а область стока сильно легирована примесью N-типа. Таким образом, область истока является областью, богатой дырками, а область стока — областью, богатой электронами.Когда V GS смещен в отрицательном диапазоне, инверсионный слой в канале состоит из дырок. Таким образом, емкость затвор-исток C gs больше, чем емкость затвор-сток C gd , а емкость затвор-исток C gs становится больше, когда напряжение затвора смещается более отрицательно. Напротив, когда В gs смещено в положительном диапазоне, емкость затвор-исток C gs становится маленькой, емкость затвор-сток C gd является доминирующей.Поскольку аналоговые / ВЧ характеристики TTFET в основном анализируются в прямом рабочем режиме (), емкость затвор-сток имеет более значительное влияние на аналоговые / ВЧ характеристики, чем емкость затвор-исток.
Еще одним параметром, тесно связанным с характеристиками аналогового / ВЧ-сигнала, является крутизна g m TTFET. g m TTFET-транзистора в первую очередь определяется его характеристиками прямой проводимости, которые в основном зависят от структуры затвор-исток устройства.На рисунке 9 показаны передаточные характеристики для обычных TTFET, GDO-TTFET и GDS-TTFET с В ds = 1,0 В. Можно видеть, что, поскольку эти три устройства TTFET имеют идентичные структуры затвор-исток, их характеристики прямой проводимости одинаковы I DS — V GS взаимосвязь или журнал I DS — V GS взаимосвязь. Другими словами, когда В gs смещено в пределах диапазона положительного напряжения, эти три устройства TTFET имеют одинаковую крутизну.
На основе крутизны и паразитной емкости доступны два других важных показателя качества для аналоговых / радиочастотных приложений: частота среза f T и произведение коэффициента усиления на полосу пропускания (GBP). Частота среза зависит от отношения крутизны к общей емкости и может быть определена как
На рисунке 10 показано сравнение f T в зависимости от напряжения затвора для обычных TTFET, GDO-TTFET и GDS-TTFET. Для всех этих трех устройств TTFET можно увидеть, что частота среза f T увеличивается с увеличением напряжения затвора и достигает максимального значения, когда напряжение затвора смещается на определенное значение, а затем f T уменьшается по мере того, как напряжение затвора продолжает увеличиваться. Более того, можно видеть, что из-за уменьшенных паразитных емкостей затвор-сток GDS-TTFET достигает наивысших значений f T по сравнению с обычными TTFET и GDO-TTFET.
Благодаря своей перекрывающейся структуре затвор-сток, GDO-TTFE имеет самую большую паразитную емкость затвор-сток среди этих трех устройств TTFET, поэтому при одинаковой крутизне f T GDO-TTFET всегда будет наименьшее, когда В gs смещено от 0 В до 2,0 В.
Те же тенденции изменения произведения полосы пропускания усиления (GBP) можно найти на рис.11, в то время как GBP определяется как
Также следует отметить, что как максимальное значение f T , так и максимальное значение GBP для этих трех TTFET меньше 1 ГГц, поскольку кремниевый TTFET по-прежнему имеет низкий рабочий ток I ON из-за относительно кремниевых транзисторов. большая запрещенная зона и значительная эффективная туннельная масса. [12] Low I ON означает небольшую крутизну, которая накладывает ограничение на максимум f T и GBP. Следовательно, в будущей работе материалы III – V и структуры гетеропереходов могут быть введены в TTFET для увеличения тока в открытом состоянии и дальнейшего улучшения аналоговых / радиочастотных характеристик.
3.3. Оптимизация параметров для GDS-TTFETДля устройств GDS-TTFET толщина слоя диэлектрика κ , вставленного между электродом затвора и диэлектриком затвора, представлена параметром H spacer , который имеет огромное влияние на характеристики GDS-TTFET с точки зрения возможности подавления биполярного тока и аналоговых / радиочастотных характеристик.
На рисунке 12 показаны характеристики переноса GDS-TFET с другим спейсером H . Можно видеть, что, когда напряжение затвора смещено отрицательно, чем больше проставка H , тем слабее способность управляющего электрода затвора к каналу и тем меньше генерируемый амбиполярный туннельный ток. Однако, если H спейсер больше 4 нм, способность управления затвором в области туннелирования (между затвором и источником) также ухудшится по мере увеличения спейсера H , что приведет к уменьшению I ON .
Для дальнейшего исследования влияния проставки H на ток в цепи GDS-TTFET I ON на рисунке 13 показано влияние проставки H на крутизну GDS-TTFET, когда V gs смещен от 1,0 В до 2,0 В. Видно, что когда H спейсер меньше 4 нм, структура GDS почти не влияет на крутизну GDS-TTFET. Однако, когда H спейсер больше 6 нм, крутизна GDS-TFET значительно снижается.Кроме того, как показано на рис. 14, большая прокладка H означает меньшие паразитные емкости затвор-исток и затвор-сток, что полезно для улучшения аналоговых / радиочастотных характеристик GDS-TTFET.
Для всестороннего анализа влияния спейсера H на аналоговые / радиочастотные характеристики GDS-TTFET, влияние спейсера H на частоту отсечки f T и произведение коэффициента усиления на полосу пропускания (GBP) GDS-TTFET показано на рис.15 и 16 соответственно.
Из рисунка 15 видно, что структура GDS имеет значительное улучшение характеристик частоты среза GDS-TTFET. В частности, когда H спейсер равен 4 нм, частота отсечки f T GDS-TTFET может получить более высокое пиковое значение около 7 × 10 8 Гц, и это пиковое значение может быть сохраняется в более широком диапазоне смещения V GS . Однако, когда H спейсер увеличивается до 6 нм, характеристика частоты среза GDS-TTFET начинает ухудшаться, как пиковое значение частоты среза, так и диапазон смещения V gs с высокой частотой среза уменьшаются .
Те же тенденции изменения произведения ширины полосы усиления (GBP) можно найти на рис.16, когда H spacer равно 4 нм, пиковое значение GBP является самым высоким, но когда H spacer увеличивается, пиковое значение GPB будет постепенно уменьшаться.
Следовательно, необходимо оптимизировать проставку H GDS-TTFET. Выбрав соответствующую прокладку H , GDS-TTFET может эффективно подавить биполярный ток и уменьшить паразитную емкость затвор-сток, не затрагивая при этом I ON , тем самым обеспечивая наилучшие аналоговые / ВЧ характеристики.
FinFET: от устройств к архитектуре
С момента начала действия закона Мура масштабирование планарных MOSFET сталкивается с серьезными проблемами в нанометровом режиме, FinFET и Trigate FET стали их преемниками. Причитающийся наличие нескольких (двух / трех) вентилей, FinFETs / Trigate Полевые транзисторы способны справляться с эффектами короткого канала (SCE) лучше, чем обычные планарные полевые МОП-транзисторы на сильно масштабируемых технологических узлах и, таким образом, разрешить непрерывное масштабирование транзистора. В этой статье мы просмотрите исследования FinFET с самого нижнего уровня устройства на высший архитектурный уровень.Мы исследуем различные типы FinFET, различные возможные асимметрии FinFET и их влияние, и новые компромиссы на уровне логики и архитектуры, предлагаемые FinFETs. Мы также рассматриваем инструменты анализа и оптимизации, которые доступны для характеристики устройств FinFET, схем и архитектуры.
1. Введение
Неустанное масштабирование планарных полевых МОП-транзисторов за последние четыре десятилетия обеспечило постоянно увеличивающуюся плотность транзисторов и производительность интегральных схем (ИС). Однако продолжить эту тенденцию в нанометровом режиме очень сложно из-за резкого увеличения допорогового тока утечки () [1–3].Из-за очень малой длины канала в полевых МОП-транзисторах с большим масштабом потенциал стока начинает влиять на электростатику канала и, следовательно, затвор теряет адекватный контроль над каналом. В результате затвор не может полностью перекрыть канал в выключенном режиме работы, что приводит к увеличению расстояния между стоком и истоком. Использование более тонких оксидов затвора и диэлектрических материалов с высоким содержанием k помогает решить эту проблему за счет увеличения емкости затворного канала.Однако уменьшение толщины оксидов затвора принципиально ограничивается ухудшением утечки затвора и утечки стока, вызванной затвором (GIDL) [4–6]. Полевые транзисторы с несколькими затворами (MGFET), которые являются альтернативой планарным MOSFET, демонстрируют лучшее экранирование потенциала стока из канала из-за близости дополнительного затвора (ов) к каналу (т. емкость) [7–12]. Это делает полевые транзисторы MGFET превосходящими планарные полевые МОП-транзисторы по показателям производительности короткого канала, таким как подпороговая крутизна (), снижение барьера, вызванное стоком (DIBL), и спад порогового напряжения ().Улучшение этих показателей подразумевает меньшую деградацию транзисторов при постоянном масштабировании, что, в свою очередь, означает меньшую деградацию.
До сих пор мы называли планарные полевые МОП-транзисторы на пластинах объемного кремния (или объемные полевые МОП-транзисторы) планарными МОП-транзисторами. Полностью обедненные полевые МОП-транзисторы на основе кремния на изоляторе (FDSOI) (планарные полевые МОП-транзисторы, построенные на пластинах КНИ) избегают дополнительных путей утечки от стока к истоку, избавляясь от дополнительной подложки под каналом [13, 14]. Их показатели производительности сопоставимы с показателями полевых транзисторов с двумя затворами (DGFET), которые представляют собой полевые транзисторы с двумя затворами.Оба предлагают уменьшенную емкость перехода, более высокое отношение, лучшую и улучшенную устойчивость к случайным колебаниям примеси (RDF). Однако DGFET имеют более мягкие ограничения на толщину канала, что в долгосрочной перспективе делает DGFET более масштабируемыми, чем FDSOI MOSFET [15, 16]. Кроме того, структуры DGFET также могут быть построены на пластинах объемного Si, что делает DGFET более привлекательными для литейных производств, которые не хотят переходить на процесс SOI [17, 18].
Среди всех полевых МОП-транзисторов FinFET (тип DGFET) и триггерные полевые транзисторы (еще один популярный MGFET с тремя затворами) оказались наиболее востребованными альтернативами полевым МОП-транзисторам из-за их простой структуры и простоты изготовления [19–27].Два или три затвора, обернутые вокруг вертикального канала, обеспечивают легкое выравнивание затворов и совместимость со стандартным процессом изготовления КМОП. В полевых транзисторах Trigate используется дополнительный этап избирательного травления жесткой маски для создания третьего затвора поверх канала. Хотя этот третий затвор усложняет процесс, он также приводит к некоторым преимуществам, таким как уменьшенная периферийная емкость и дополнительная ширина транзистора [28–30].
Устройства FinFET / Trigate были тщательно изучены за последнее десятилетие.Было опубликовано большое количество исследовательских статей, которые демонстрируют улучшенное поведение этих устройств в коротком канале по сравнению с обычными объемными полевыми МОП-транзисторами [19–22, 31–33]. Многие исследователи представили новые стили проектирования схем, в которых используются различные типы FinFET [34–48]. Исследователи также исследовали различные симметричные и асимметричные стили FinFET и использовали их в гибридных логических вентилях и памяти FinFET [49–66]. Также изучались новые архитектуры для кэшей, сетей на кристалле (NoC) и процессоров, основанные на таких логических вентилях и памяти [67–74].Несмотря на эти успехи в исследованиях FinFET, статей, дающих глобальный обзор FinFET от уровня устройства до самого верхнего уровня архитектуры, мало. Mishra et al. обеспечил такой взгляд на схемном уровне [75]. Однако FinFET не охватываются другими уровнями проектной иерархии. Кроме того, на уровне контуров с момента публикации этой главы книги был достигнут большой прогресс. Наша статья предназначена для широкого круга читателей: инженеров по устройствам, проектировщиков схем и архитекторов аппаратного обеспечения.Наша цель — предоставить глобальное представление о концепциях FinFET, охватывающих всю иерархию проектирования ИС.
Работа организована следующим образом. В разделе 2 мы рассматриваем различные типы FinFET и возможные асимметрии, которые могут быть встроены в их структуры. Мы также обсуждаем источники изменений процесса в FinFET и их влияние на производительность FinFET. Мы обсуждаем моделирование процессов FinFET, моделирование устройств и компактные модели в разделе 3. Мы описываем новый инвертор FinFET (INV) и логические элементы NAND, триггеры, защелки, статическую память с произвольным доступом (SRAM) и динамическую память с произвольным доступом ( DRAM) в разделе 4.В разделе 5 мы обсуждаем методологии анализа и оптимизации на уровне цепей, а также новую схему межсоединений, которая использует FinFET. Затем мы представляем обзор инструментов моделирования на уровне архитектуры с учетом вариаций технологического напряжения-температуры (PVT) в Разделе 6 и завершаем его в Разделе 7.
2. FinFETs
В 1989 году Hisamato et al. изготовили структуру КНИ с двумя затворами, которую они назвали полностью обедненным транзистором с обедненным каналом (ДЕЛЬТА) [76]. Это было первое сообщение о создании структуры, подобной FinFET.FinFET-транзисторы привлекают все большее внимание за последнее десятилетие из-за ухудшающегося поведения планарных MOSFET в коротком канале [19–24]. Рисунок 1 демонстрирует превосходные характеристики FinFET на коротком канале по сравнению с планарными MOSFET с той же длиной канала. На рисунке 2 показаны обычный планарный MOSFET и FinFET. В то время как планарный канал MOSFET является горизонтальным, канал FinFET (также известный как плавник) является вертикальным. Следовательно, высота канала () определяет ширину () FinFET. Это приводит к особому свойству FinFET, известному как квантование по ширине.В этом свойстве говорится, что ширина FinFET должна быть кратной, то есть ширину можно увеличить, используя несколько ребер. Таким образом, произвольная ширина FinFET невозможна. Хотя меньшая высота ребер обеспечивает большую гибкость, они приводят к появлению нескольких ребер, что, в свою очередь, приводит к большей площади кремния. С другой стороны, более высокие ребра приводят к уменьшению площади кремниевого основания, но также могут привести к структурной нестабильности. Обычно высота ребра определяется инженерами-технологами и поддерживается ниже четырехкратной толщины ребра [77, 78].
Хотя FinFET, реализованные на пластинах SOI, очень популярны, FinFET также широко применяются на обычных объемных пластинах [79–81]. На рисунке 3 показаны FinFET, реализованные на объемных пластинах и пластинах SOI. В отличие от объемных FinFET, где все ребра имеют общую кремниевую подложку (также известную как основная часть), ребра в SOI FinFET физически изолированы. Некоторые компании предпочитают массовую технологию, потому что легче перейти на массовые полевые транзисторы FinFET с обычных объемных полевых МОП-транзисторов. Однако FinFET на обоих типах пластин вполне сопоставимы с точки зрения стоимости, производительности и выхода, и пока рано выбирать победителя.С этого момента наше обсуждение будет ограничиваться SOI FinFET, если не указано иное.
Полевые транзисторы с триггером, которые до сих пор назывались в этой статье как FinFET, представляют собой вариант FinFET с третьим затвором наверху ребра. Intel представила полевые транзисторы Trigate на узле 22 нм в процессоре Ivy-Bridge в 2012 году [28, 82]. На рисунке 4 показан полевой транзистор Trigate FET вместе с полевым транзистором FinFET. Толщина диэлектрика наверху ребра уменьшена в полевых транзисторах Trigate для создания третьего затвора.Из-за наличия третьей заслонки толщина ребра также увеличивает ширину канала. Следовательно, полевые транзисторы Trigate имеют небольшое преимущество по ширине перед полевыми транзисторами FinFET. Тригированные полевые транзисторы также имеют меньшую емкость затвор-исток по сравнению с полевыми полевыми транзисторами из-за дополнительной проводимости тока на верхней поверхности, но это преимущество уменьшается из-за повышенного паразитного сопротивления [29].
Янг и Фоссум сравнили полевые транзисторы Trigate и полевые транзисторы FinFET и утверждали, что в конечном итоге полевые транзисторы FinFET превосходят полевые транзисторы Trigate [83].Они показали, что, хотя нелегированные полевые транзисторы Trigate могут иметь более расслабленную толщину тела, они не могут конкурировать с полевыми транзисторами FinFET по показателям SCE. При попытке достичь сопоставимых показателей SCE полевые транзисторы Trigate теряют преимущество масштабирования и страдают от значительного недостатка площади компоновки. Однако, как и споры о массовом противостоянии SOI, также преждевременно объявлять явного победителя между FinFET и Trigate FET. С этого момента мы будем рассматривать только FinFET, если не указано иное.
FinFET-транзисторы могут быть изготовлены с каналом в разных направлениях в одном кристалле.Изготовление планарных каналов полевого МОП-транзистора вдоль любой плоскости кристалла, кроме затруднительной из-за вариаций процесса и ловушек на границе раздела [36, 84]. Однако FinFET можно изготавливать и вдоль плоскости. Это приводит к повышенной подвижности дырок. FinFET-транзисторы с ориентацией могут быть изготовлены простым поворотом схемы транзистора в плоскости пластины [85]. Таким образом, nFinFET, реализованные вместе, и pFinFET, обеспечивают более быстрые логические вентили, поскольку это дает разработчикам возможность бороться с присущей разницей в подвижности между электронами и дырками.Однако очевидным недостатком такой многоориентационной схемы является увеличенная площадь кремния [85]. В следующих разделах мы подробно обсуждаем классификации FinFET и варианты процессов.
2.1. FinFET Classification
Существует два основных типа FinFET: с короткозамкнутым затвором (SG) и с независимым затвором (IG). SG FinFET также известны как трехконтактные (3T) FinFET, а IG FinFET — как четырехконтактные (4T) FinFET. В SG FinFET передние и задние затворы физически закорочены, тогда как в IG FinFET затворы физически изолированы (рисунок 5).Таким образом, в SG FinFET оба затвора совместно используются для управления электростатикой канала. Следовательно, SG FinFET показывает более высокий ток включения (), а также более высокий ток отключения (или подпороговый ток) по сравнению с IG FinFET. IG FinFET предлагает гибкость применения различных сигналов или напряжений на своих двух затворах. Это позволяет использовать смещение заднего затвора для линейной модуляции переднего затвора. Однако IG FinFET несут большие потери по площади из-за необходимости размещения двух отдельных контактов затвора.
SG FinFET можно дополнительно разделить на категории на основе асимметрии их параметров устройства. Обычно рабочие функции () передних и задних ворот FinFET одинаковы. Однако рабочие функции также могут быть разными. Это приводит к асимметричной работе затвора SG FinFET или ASG FinFET (рисунок 6) [86, 87]. Полевые транзисторы ASG FinFET могут быть изготовлены с селективным легированием двух затворных стеков. Они имеют очень многообещающие характеристики для коротких каналов и на два порядка ниже, чем у SG FinFET, и лишь немного ниже, чем у SG FinFET [49].На рисунках 7 и 8 показано сравнение кривых тока стока и напряжения на переднем затворе для SG, IG и ASG nFinFET и pFinFET, соответственно, демонстрируя преимущества ASG FinFET.
Помимо асимметрии работы затвора, в FinFET также исследовались другие асимметрии. Goel et al. [57] показывают, что асимметричные FinFET-транзисторы с расширением «сток-разделитель» (ADSE) (рисунок 9) могут привести к улучшенным характеристикам короткого канала из-за косвенного увеличения длины канала.Однако это улучшение происходит за счет увеличения площади компоновки. Эта асимметрия также разрушает традиционную концепцию сменного истока-стока в КМОП. Асимметрия создается в токах сток-исток и исток-сток из-за дополнительного перекрытия. Эта асимметрия влияет на характеристики проходного транзистора FinFET. Асимметричные FinFET-транзисторы, легированные сток-исток (AD) (рис. 10), с разницей на порядок величины в концентрациях легирования сток-исток, использовались в [58].Это также нарушает обычную симметрию в и, что снова приводит к асимметричным характеристикам проходного транзистора FinFET. SCE улучшены в AD FinFET из-за более низких электрических полей в низколегированном стоке. Также были предложены FinFET с асимметричной толщиной оксида (ATox) (рис. 11) [88, 89]. Такие FinFET-транзисторы имеют хорошие подпороговые наклоны. Использование IG FinFET (или 4T FinFET) в этом контексте также позволяет использовать переменные. Эта асимметрия может быть достигнута с помощью процесса травления, усиленного ионной бомбардировкой.Наконец, были исследованы также FinFET-транзисторы с асимметричной высотой ребра [61, 90]. Поскольку ширина канала FinFET-транзистора пропорциональна его высоте ребра, pFinFET-транзисторы с более высокими ребрами могут компенсировать присущее несоответствие подвижности между электронами и дырками.
На рисунке 12 показано двумерное (2D) поперечное сечение трехмерного (3D) FinFET, иллюстрирующее различные параметры интересующего устройства. Типичные значения этих параметров приведены в Таблице 1.,,,,,,,,,,,,,,,,,,,,,,, и относятся к физической длине переднего и заднего затвора, эффективной толщине оксида переднего и заднего затвора, толщину ребра, высоту ребра, толщину переднего и заднего затвора, толщину прокладки переднего и заднего затвора, нижнее перекрытие затвор-сток / исток, легирование корпуса, легирование истока / стока, рабочие функции переднего и заднего затвора, шаг ребра и шаг ворот соответственно.
| |||||||||||||||||||||||||||||
2.2. Варианты процесса
Уменьшенный размер элемента и ограниченное фотолитографическое разрешение вызывают статистические колебания в параметрах устройства в нанометровом масштабе. Эти колебания вызывают изменения в параметрах электрического устройства, такие как,, и т.д., известные как изменения процесса. Эти изменения могут быть между штампами или внутри штампа, коррелированными или некоррелированными, в зависимости от процесса изготовления. Они приводят к несоответствию прочности устройства и ухудшают выход всего штампа. Вот почему дальнейшее масштабирование планарных МОП-транзисторов стало таким трудным.
В планарных полевых МОП-транзисторах в канал должно быть вставлено достаточное количество легирующих добавок, чтобы справиться с SCE. Однако это означает, что RDF может привести к значительному изменению в. Например, в узлах с большим масштабом вариация 3, вызванная дискретной флуктуацией примесей, может превышать 100% [91]. Поскольку FinFET-транзисторы обеспечивают лучшую производительность SCE из-за наличия второго затвора, им не требуется сильное легирование канала для обеспечения высокого. Следовательно, дизайнеры могут поддерживать тонкий канал (ребро) почти на внутреннем уровне ().Это снижает статистическое влияние RDF на. Желаемое достигается путем разработки рабочих функций материала затвора. Низкое легирование канала также обеспечивает лучшую подвижность носителей внутри канала. Таким образом, FinFET-транзисторы превосходят планарные MOSFET-транзисторы, преодолевая основной источник вариаций процесса.
FinFET страдают от других изменений процесса. Из-за своих малых размеров и литографических ограничений FinFET подвержены нескольким важным физическим колебаниям, таким как изменения длины затвора (,), толщины ребра (), толщины оксида затвора (,) и перекрытия затвора () [91– 97].Например, оксид затвора находится на протравленной боковой стенке ребра и может иметь неоднородность. Степень неоднородности зависит от шероховатости кромки кромки (LER) ребра. LER также вызывает изменения в толщине ребер. На рисунке 13 показано влияние параметрических изменений на подпороговый ток () nFinFET. Xiong и Bokor изучали чувствительность электрических параметров к различным физическим изменениям в устройствах, разработанных с почти собственным каналом [91].
Choi et al.исследовали изменения температуры в цепях FinFET при вышеупомянутых изменениях физических параметров [98]. Они показали, что даже при умеренных изменениях технологического процесса (3 () = 10%) в длине затвора (,) и толщине корпуса () тепловой пробой возможен более чем в 15% ИС, когда активность переключения первичного входа составляет 0,4. Эффект изменения температуры более серьезен в КНИ FinFET, потому что оксидный слой под ребром имеет плохую теплопроводность. Следовательно, тепло, генерируемое в ребре, не может легко рассеиваться в КНИ FinFET.Бходж и Джа оценили SG, IG и ASG FinFET при изменении температуры и обнаружили, что даже несмотря на то, что все три FinFET ухудшаются при более высокой температуре, FinFET ASG по-прежнему остаются лучшими и сохраняют 100-процентное преимущество над SG FinFET, как показано на рисунке 14. [49]. Они также показали распределение отклонений в процессе для трех FinFET (Рисунок 15).
3. Характеристика устройства FinFET
В этом разделе мы обсуждаем различные способы определения характеристик устройств FinFET посредством моделирования.Моделирование процесса, за которым следует моделирование устройства, представляет собой технологический процесс компьютерного проектирования (TCAD), характеризующий наноразмерные устройства, такие как FinFET. С другой стороны, компактные модели были еще одним очень популярным способом характеристики КМОП-устройств на протяжении десятилетий.
3.1. Моделирование процесса
Реальные устройства проходят несколько этапов обработки. Функциональность и производительность изготовленных устройств зависят от того, насколько оптимизирован технологический процесс. Таким образом, моделирование процесса TCAD является важным шагом в оптимизации устройства FinFET.После моделирования процесса следует моделирование устройства. Эти два этапа моделирования образуют цикл оптимизации, в котором небольшие изменения в технологическом процессе (например, время, температура, дозы и т. Д.) Могут привести к желаемым электрическим характеристикам устройства. Таким образом, моделирование процесса помогает разработчикам устройств исследовать пространство параметров процесса, устраняя необходимость в фактическом изготовлении устройства. Хотя трехмерное моделирование процесса требует больших вычислительных ресурсов, оно не только дает хорошее представление о физике устройства, но и обеспечивает рентабельный процесс оптимизации процесса предварительного производства.
Симулятор процессов и устройств Sentaurus от Synopsys — широко используемый инструмент для моделирования процессов [99]. Его структура трехмерного моделирования процессов совместима с основной структурой 2D TCAD TSUPREM4 / MEDICI (также от Synopsys). 2D-фреймворк использовался дизайнерами в течение последнего десятилетия и был хорошо откалиброван с помощью расширенных библиотек CMOS. Nawaz et al. реализовали полную технологическую схему FinFET как коммерчески доступную среду моделирования процессов и устройств [100].Как и в реальных устройствах, в их настройках реализованы все важные геометрические особенности, такие как скругления углов и трехмерные грани.
Моделирование процессов больших компоновок, состоящих из нескольких устройств, требует чрезвычайно высоких вычислительных затрат. Новая методология TCAD, не зависящая от компоновки / процесса / устройства, была предложена в [54], чтобы преодолеть барьер моделирования процесса для точного синтеза трехмерной структуры TCAD. В нем Bhoj et al. применять подход к автоматизированному синтезу конструкций, который устраняет необходимость в повторяющемся трехмерном моделировании процессов для различных макетов.При таком подходе единичные устройства, имитирующие процесс, размещаются в местах расположения устройств в компоновке, что устраняет необходимость в симуляции процесса для всей компоновки, тем самым значительно снижая вычислительные затраты. Было показано, что этот подход к синтезу структуры, сопровождаемый методологией извлечения емкости на основе транспортного анализа, позволяет точно определять паразитные емкости в SRAM и кольцевых генераторах FinFET в практических временных рамках [54, 55, 63, 66]. Точное извлечение паразитных емкостей привело к всесторонней оценке переходных показателей различных битовых ячеек FinFET SRAM [55].
3.2. Моделирование устройства
После того, как имитация процесса генерирует сетчатую структуру устройства, моделирование устройства выполняется в структуре путем вызова соответствующих транспортных моделей. Традиционная модель дрейфово-диффузионного переноса не подходит для захвата SCE в нанометровых MOSFET и FinFET. Гидродинамическая модель с квантовыми поправками (такими как модели градиента плотности) была популярна среди исследователей для моделирования устройств FinFET [101]. Другие более точные модели, такие как решение уравнения переноса Больцмана на основе функции Грина, налагают огромную вычислительную нагрузку [101].Для моделирования цепей с несколькими устройствами устройство Sentaurus (Synopsys) позволяет моделировать устройства в смешанном режиме. Здесь отдельные устройства FinFET подключаются извне с помощью проводов или других элементов схемы, чтобы сформировать список соединений, а связанные уравнения переноса решаются для всего списка соединений. Эта функция позволяет разработчикам устройств видеть, как устройство ведет себя при использовании в цепи.
3.3. Компактные модели
Компактные модели FinFET, основанные на физических принципах, были очень полезным инструментом для дизайнеров.Короткоканальная модель IGFET Беркли (BSIM) и модель двойного затвора Университета Флориды (UFDG) для многозатворных полевых МОП-транзисторов SOI и полевых транзисторов FinFET были построены с использованием TCAD и откалиброваны с использованием изготовленного оборудования [102–105]. Эти модели совместимы с коммерческими симуляторами схем, такими как программа моделирования с упором на интегральные схемы (SPICE). Следовательно, с помощью этих моделей можно моделировать большие списки соединений, если пространство решений находится в пределах их диапазона. Однако моделирование устройства предшествует созданию компактных моделей и является более точным.Таким образом, все результаты, представленные в этой статье, основаны на моделировании устройств в смешанном режиме.
4. Стандартные ячейки FinFET
После характеристики отдельных устройств n / pFinFET мы переходим на один уровень вверх к характеристике логических вентилей, защелок, триггеров и ячеек памяти FinFET, которые являются строительными блоками любой цифровой интегрированной системы. схема [49–51]. IG и ASG FinFET предлагают новые компромиссы с задержкой утечки в логических вентилях FinFET, которые можно использовать в маломощных или высокопроизводительных приложениях.Схематические диаграммы SG и IG FinFET показаны на рисунке 16. Схематические диаграммы ASG FinFET показаны на рисунке 17. Bhoj и Jha провели углубленный анализ и сравнение INV и NAND2 на основе SG, IG и ASG FinFET ( двухвходовые И-НЕ) вентили [49]. Эти два шлюза являются наиболее важными строительными блоками любой логической библиотеки, потому что любая логическая сеть может быть построена только с этими двумя воротами.
4.1. SG / IG INV
Существует четыре возможных конфигурации INV в зависимости от того, как объединяются SG и IG FinFET для их реализации.Они называются SG, low-power (LP), IGn и IGp INV. Их принципиальные схемы показаны на рисунке 18. Как видно из названия, SG INV имеет полевые транзисторы SG n / pFinFET. Он имеет очень компактную планировку. В остальных трех конфигурациях используется как минимум один IG FinFET. Задний затвор IG pFinFET (nFinFET) привязан к сигналу (). Когда эти сигналы имеют обратное смещение, например, когда на 0,2 В выше и на 0,2 В ниже земли, происходит значительное снижение. Наличие IG FinFET также приводит к более сложной компоновке, в результате чего накладные расходы на площадь составляют 36% по сравнению с 2 SG INV (что вдвое больше, чем SG INV минимального размера).В таблице 2 сравниваются нормализованная площадь, задержка и утечка различных INV. Ясно, что SG INV является лучшим по площади и задержке распространения (), но требует гораздо более высокого тока утечки, чем LP INV. Однако LP INV плохо работает по площади и задержке распространения. IGn INV, однако, выглядит многообещающим с учетом его промежуточной площади, задержки и утечки.