2.19. Емкость и эффект Миллера
ГЛАВА 2. ТРАНЗИСТОРЫ
Некоторые типы усилительных каскадов
До сих пор мы пользовались моделью транзистора для сигналов постоянного тока или низкой частоты. В простейшей модели транзистора в виде усилителя тока и в более сложной модели Эберса-Молла напряжения, токи и сопротивления рассматривают со стороны различных выводов транзистора. Пользуясь этими моделями, мы уже охватили достаточно широкий круг вопросов, и на самом деле они содержат в себе почти все, что необходимо учитывать при разработке транзисторных схем. Однако до сих пор мы не принимали во внимание важный момент — внешние цепи и сами переходы транзистора обладают некоторой емкостью, которую необходимо учитывать при разработке быстродействующих и высокочастотных схем. На самом деле, на высоких частотах емкость зачастую определяет работу схемы: на частоте 100 МГц емкость перехода, равная 5 пкФ, имеет импеданс 320 Ом.
Емкость схемы и перехода. Емкость ограничивает скорость изменения напряжений в схеме, так как любая схема имеет собственные конечные выходные импеданс и ток.

Рис. 2.73. Емкости перехода и нагрузки в транзисторном усилителе.
Эффект Миллера. Емкость С
Существует несколько методов борьбы с эффектом Миллера, например, он будет полностью устранен, если использовать усилительный каскад с общей базой. Импеданс источника можно уменьшить, если подавать сигнал на каскад с заземленным эмиттером через эмиттерный повторитель. На рис. 2.74 показаны еше две возможности. В дифференциальном усилителе (без резистора в коллекторной цепи T На рис. 2.74 представлена лишь часть каскодной схемы; в нее можно включить зашунтированный эмиттерный резистор и делитель напряжения для подачи смещения на базу (подобные примеры были рассмотрены в начале настоящей главы) или охватить всю схему петлей обратной связи по постоянному току. Напряжение U+ можно формировать с помощью делителя или зенеровского диода; для того чтобы напряжение было жестко фиксировано на частотах сигнала, можно шунтировать резистор в базе Т2.
На рис. 2.74 представлена лишь часть каскодной схемы; в нее можно включить зашунтированный эмиттерный резистор и делитель напряжения для подачи смещения на базу (подобные примеры были рассмотрены в начале настоящей главы) или охватить всю схему петлей обратной связи по постоянному току. Напряжение U+ можно формировать с помощью делителя или зенеровского диода; для того чтобы напряжение было жестко фиксировано на частотах сигнала, можно шунтировать резистор в базе Т2.
Рис. 2.74. Две схемы, в которых устранен эффект Миллера. Схема Б представляет собой пример каскодного включения транзисторов.
Упражнение 2.14. Объясните, почему эффект Миллера не наблюдается в транзисторах рассмотренной только что схемы дифференциального усилителя и в каскодных схемах.
Паразитные емкости могут создавать и более сложные проблемы, чем те, которых мы сейчас коснулись. В частности: а) спад усиления, обусловленный наличием емкости обратной связи и выходной емкости, сопровождается побочными эффектами, которые мы рассмотрим в следуюшей главе; б) входная емкость также оказывает влияние на работу схемы даже при наличии мощного источника входных сигналов; в частности, ток.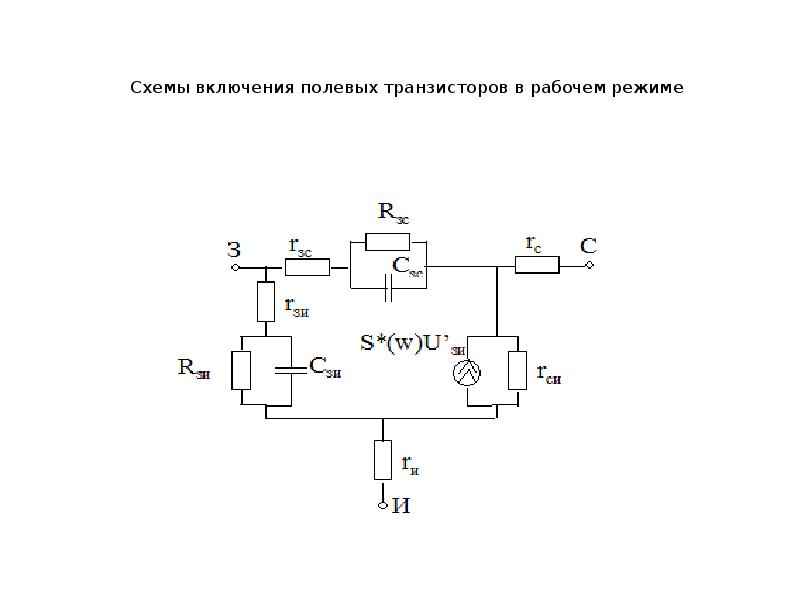
Некоторые типичные транзисторные схемы
Как буферизовать выход операционного усилителя для получения более высокого тока, часть 4
Добавлено 29 октября 2019 в 04:22
Сохранить или поделиться
Если для выходного буфера операционного усилителя вместо биполярного транзистора вы решили выбрать MOSFET транзистор, то вам необходимо учесть взаимосвязь между емкостью затвора и неустойчивостью усилителя.
Вспомогательная информация
Вопрос устойчивости
В предыдущей статье мы увидели, что в стандартных схемах буферизации выходного тока операционного усилителя вместо биполярного транзистора можно использовать MOSFET. Одним значительным преимуществом реализаций с MOSFET транзисторами является незначительный ток, требуемый от выходного каскада операционного усилителя – ток стока MOSFET транзистора управляется в основном напряжением затвор-исток, а не током, протекающим через затвор, к тому же через затвор могут протекать только небольшие (в нашем контексте, незначительные) токи утечки, потому что он изолирован от остальной части полевого транзистора. Таким образом, вы можете формировать очень большие токи нагрузки даже с очень маленьким операционным усилителем. Однако изолированный затвор MOSFET транзистора дает и пользу, и проблемы. Этот изолированный затвор означает наличие емкости, а если у вас к выходу операционного усилителя подключена слишком большая емкость, это приведет к серьезным проблемам со схемой.
На самом деле, всё немного сложнее, чем описанное выше. Как вы, возможно, знаете, операционные усилители имеют ограниченные способности в безопасном управлении емкостными нагрузками. Проблема заключается в устойчивости (стабильности): выходное сопротивление операционного усилителя в сочетании с емкостью нагрузки создает полюс, который добавляет в передаточную функцию петлевого усиления дополнительный сдвиг фазы на 90°. Этот дополнительный сдвиг фазы может привести к большому «звону» или даже к возбуждению колебаний. (Серия статей об отрицательной обратной связи, а именно, части с 4 по 10, содержит большое количество информации об устойчивости; неустойчивость, вызванная емкостной нагрузкой, обсуждается в части 9.) Вы можете посмотреть техническое описание операционного усилителя, чтобы понять, насколько большая допускается емкость нагрузки для безопасного управления конкретным устройством; однако эта информация не имеет прямого отношения к нашей схеме буферизации выходного тока, поскольку емкость затвора MOSFET транзистора не подключена между выходным выводом операционного усилителя и землей.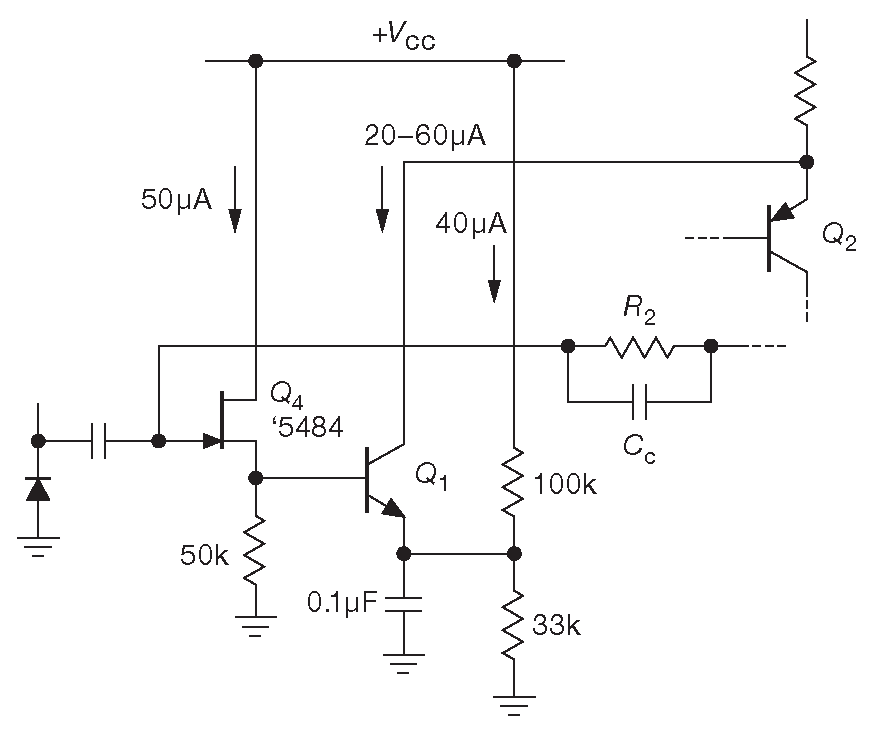 Часть емкости (а именно, емкость затвор-исток) соединена с землей через сопротивление нагрузки, и мы увидим, что это последовательное сопротивление влияет на устойчивость схемы.
Часть емкости (а именно, емкость затвор-исток) соединена с землей через сопротивление нагрузки, и мы увидим, что это последовательное сопротивление влияет на устойчивость схемы.
Заряд или емкость?
Возможно, вы заметили, что технические описания MOSFET транзисторов сообщают о «заряде затвора» более заметно, чем о входной емкости. Это также относится и к LTspice, который отображает только три параметра, когда вы открываете окно выбора нового NMOS или PMOS устройства; одним из этих параметров является заряд затвора, а емкость не упоминается совсем. Производители фокусируются на заряде затвора, потому что это лучший параметр для расчета и сравнения скоростей переключения:
\[\text{время, необходимое для открывания MOSFET транзистора} =\frac{\text{заряд затвора}}{\text{ток заряда}}\]
Для удобства я буду ссылаться на заряд затвора, когда мне нужно выразить входную емкость устройства относительно емкости другого MOSFET транзистора. Для наших целей достаточно понять, что больший заряд затвора соответствует большей емкости нагрузки. Нам на самом деле не очень нужна фактическая величина емкости, потому что мы не будем пытаться аналитически предсказать запас по фазе или процент перерегулирования (величину выбросов). На самом деле, это подводит меня к следующему пункту. Полное разоблачение: сложность этой схемы (вольт-амперные характеристики MOSFET транзистора, различные паразитные емкости, выходное сопротивление операционного усилителя, влияние величины сопротивления нагрузки) превышает мою способность точно понимать и объяснять, что происходит в контексте устойчивости. С уверенностью могу сказать, что большая емкость затвора может сделать схему менее устойчивой, поэтому будьте осторожны. Также можно с уверенностью сказать, что, как правило, более низкое сопротивление нагрузки ведет к большей неустойчивости. Кроме того, я рекомендую вам проводить моделирования и надеяться, что эти моделирования, по крайней мере, в некоторой степени соответствуют реальности.
Нам на самом деле не очень нужна фактическая величина емкости, потому что мы не будем пытаться аналитически предсказать запас по фазе или процент перерегулирования (величину выбросов). На самом деле, это подводит меня к следующему пункту. Полное разоблачение: сложность этой схемы (вольт-амперные характеристики MOSFET транзистора, различные паразитные емкости, выходное сопротивление операционного усилителя, влияние величины сопротивления нагрузки) превышает мою способность точно понимать и объяснять, что происходит в контексте устойчивости. С уверенностью могу сказать, что большая емкость затвора может сделать схему менее устойчивой, поэтому будьте осторожны. Также можно с уверенностью сказать, что, как правило, более низкое сопротивление нагрузки ведет к большей неустойчивости. Кроме того, я рекомендую вам проводить моделирования и надеяться, что эти моделирования, по крайней мере, в некоторой степени соответствуют реальности.
Отправная точка
Мы исследуем эту тему, рассмотрев несколько показательных графиков переходного процесса.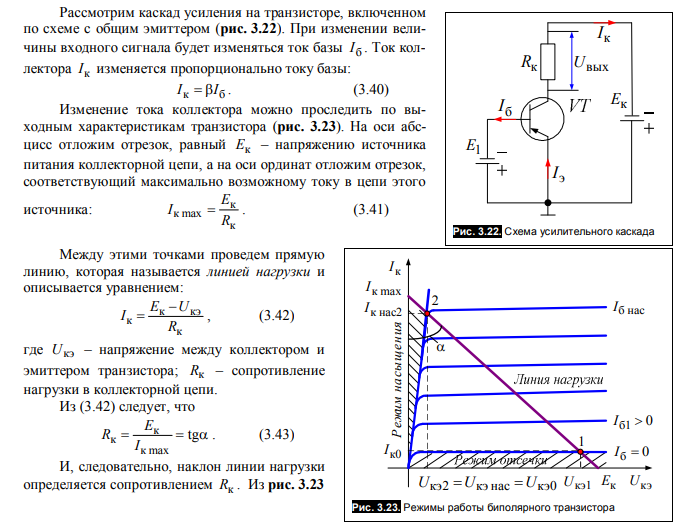 Для получения дополнительной информации об использовании переходной характеристики для оценки устойчивости смотрите статью «Отрицательная обратная связь, часть 10: устойчивость во временной области». Вы также можете выполнить моделирование устойчивости в частотной области, «разорвав петлю»; это обсуждается в части 9 серии про отрицательную обратную связь.
Для получения дополнительной информации об использовании переходной характеристики для оценки устойчивости смотрите статью «Отрицательная обратная связь, часть 10: устойчивость во временной области». Вы также можете выполнить моделирование устойчивости в частотной области, «разорвав петлю»; это обсуждается в части 9 серии про отрицательную обратную связь.
Давайте начнем с базовой (отправной) переходной характеристики, т.е. как будет выглядеть переходной процесс без какого-либо буферного транзистора или емкости нагрузки. Вот схема:
Рисунок 1 – Схема для моделирования переходного процесса в LTspice без буферного транзистора или емкости нагрузкиРезистор нагрузки был выбран исходя из типового максимального выходного тока LT6203, а именно 45 мА; на вход подается импульс 500 мВ, а (500 мВ)/(45 мА) = 11,1 Ом. Вот полученная осциллограмма:
Рисунок 2 – Осциллограмма полученного переходного процессаЗадержка между входным и выходным сигналами отражает ограничение скорости нарастания операционного усилителя, а умеренное перерегулирование (выброс) согласуется с тем фактом, что LT6203 имеет достаточный запас по фазе при единичном усилении.
Перерегулирование (выбросы), «звон», возбуждение колебаний
Теперь давайте добавим NMOS транзистор FDC2512 (заряд затвора = 8 нКл) и посмотрим, что произойдет.
Рисунок 3 – Схема для моделирования переходного процесса в LTspice с буферным транзистором FDC2512Рисунок 4 – Осциллограмма полученного переходного процесса (с буферным транзистором)Амплитуда выброса увеличилась, и мы можем заметить небольшую колебательную тенденцию. Тем не менее, в этом переходном процессе не о чем беспокоиться. На следующем графике показано влияние снижения сопротивления нагрузки с 12 Ом до 2 Ом.
Рисунок 5 – Осциллограмма полученного переходного процесса при уменьшении сопротивления нагрузки до 2 ОмПри более низком сопротивлении нагрузки мы наблюдаем некоторое дополнительное колебательное поведение, но амплитуда выброса (около 60 мВ или 12%) указывает на то, что схема все еще достаточно устойчива (перерегулирование на 12% соответствует запасу по фазе около 57°).
Теперь давайте заменим полевой транзистор на другой, с большей емкостью затвора.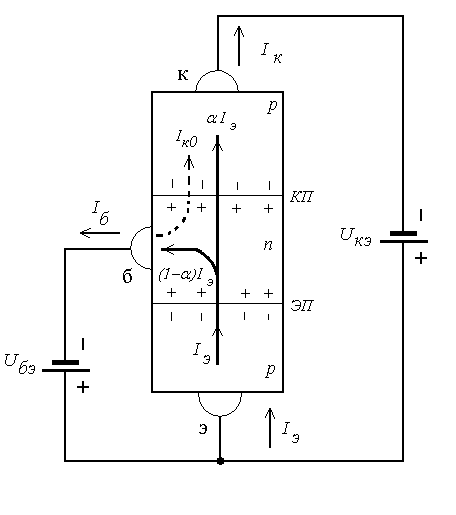 Следующий график включает результаты для FDS5680, у которого заряд затвора равен 30 нКл, по сравнению с 8 нКл у FDC2512. Сопротивление нагрузки для обеих цепей на полевых транзисторах составляет 2 Ом.
Следующий график включает результаты для FDS5680, у которого заряд затвора равен 30 нКл, по сравнению с 8 нКл у FDC2512. Сопротивление нагрузки для обеих цепей на полевых транзисторах составляет 2 Ом.
Очевидно, у нас тут проблемы. Амплитуда выброса увеличилась примерно до 60%, что означает, что запас по фазе составляет около 15° – даже не близко к 45°, необходимым для достаточной устойчивости. Чтобы мы могли оценить силу колебаний, генерируемых щедрой дозой емкости нагрузки, вот результаты для транзистора FDB8030L (заряд затвора = 120 нКл):
Рисунок 7 – Сравнение осциллограмм переходных процессов при замене MOSFET транзистора на другой, имеющий большую емкость затвора (заряд затвора 120 нКл)У биполярных транзисторов тоже есть емкость
Вышеприведенная демонстрация не означает, что полевые транзисторы повсеместно хуже биполярных транзисторов в контексте неустойчивости, вызванной вводимой емкостью нагрузки. Я признаю, что не одобряю MOSFET транзисторы, когда дело доходит до буферизации выходного тока операционного усилителя, и не только потому, что в биполярных транзисторах есть что-то приятно старомодное. Дело в том, что мне больше не хочется беспокоиться об устойчивости, и поэтому я предпочитаю избегать емкости затвора MOSFET транзисторов. Тем не менее, приведенные выше результаты для транзистора FDC2512 (заряд затвора = 8 нКл) показывают, что вы можете поддерживать адекватную устойчивость, выбирая подходящую модель транзистора (особенно учитывая, что сильноточные полевые транзисторы доступны с зарядом затвора значительно ниже 8 нКл). Кроме того, биполярные транзисторы вносят свою собственную емкостную нагрузку в виде емкости pn-перехода. Взгляните на следующий график, на котором показаны результаты для полевого транзистора FDC2512 и биполярного транзистора 2SCR293P (оба с Rнагр = 2 Ом).
Я признаю, что не одобряю MOSFET транзисторы, когда дело доходит до буферизации выходного тока операционного усилителя, и не только потому, что в биполярных транзисторах есть что-то приятно старомодное. Дело в том, что мне больше не хочется беспокоиться об устойчивости, и поэтому я предпочитаю избегать емкости затвора MOSFET транзисторов. Тем не менее, приведенные выше результаты для транзистора FDC2512 (заряд затвора = 8 нКл) показывают, что вы можете поддерживать адекватную устойчивость, выбирая подходящую модель транзистора (особенно учитывая, что сильноточные полевые транзисторы доступны с зарядом затвора значительно ниже 8 нКл). Кроме того, биполярные транзисторы вносят свою собственную емкостную нагрузку в виде емкости pn-перехода. Взгляните на следующий график, на котором показаны результаты для полевого транзистора FDC2512 и биполярного транзистора 2SCR293P (оба с Rнагр = 2 Ом).
Мы можем видеть, что влияние биполярного транзистора на устойчивость отнюдь не незначительно; фактически, выброс (перерегулирование) на графике для биполярного транзистора немного хуже, чем на графике для полевого транзистора.
Заключение
И MOSFET транзисторы, и биполярные транзисторы вносят вклад в емкость нагрузки, что может ухудшить устойчивость схемы на операционном усилителе с отрицательной обратной связью. Но вы должны быть особенно осторожны с емкостью затвора MOSFET транзисторов, которая, как правило, выше, чем входная емкость биполярных транзисторов и которая значительно варьируется между моделями транзисторов. Сначала я думал, что добавление некоторого последовательного сопротивления между выходом операционного усилителя и затвором полевого транзистора уменьшит проблемы с устойчивостью, но результаты моделирования показали, что этот подход не эффективен (на самом деле последовательное сопротивление ухудшило колебания). Моя рекомендация состоит в том, чтобы искать компоненты с низким зарядом затвора, а затем использовать моделирование, чтобы гарантировать, что полученная комбинация операционного усилителя и MOSFET транзистора поддерживает адекватную устойчивость.
Оригинал статьи:
Теги
LTspiceMOSFET / МОП транзисторЗапас по фазеЗаряд затвораМоделированиеОУ (операционный усилитель)Переходная характеристикаПереходной процессУсилитель с высоким выходным токомУстойчивостьСохранить или поделиться
Болобин И.
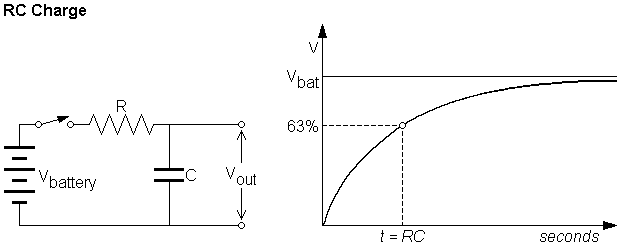 А. Эффект Миллера
А. Эффект МиллераУДК 621.382.3
Болобин Илья Андреевич
Филиал ФГБОУ ВО «Национальный исследовательский университет «МЭИ» в городе Смоленске
студент 4-го курса
Аннотация
Для успешной разработки мощного полевого транзистора необходимо всячески уменьшать входную емкость транзистора. Чтобы решить эту проблему нужно ослабить вредное воздействие получившее название эффекта Миллера. В данной статье речь пойдет об этом эффекте.
Ключевые слова: коэффициент усиления, МДП–транзистор, паразитная емкость, эффект Миллера
Bolobin Ilya Andreevich
Smolensk Branch of the Moscow Power Engineering Institute
4th year student
Abstract
To successfully develop a powerful field-effect transistor, the input capacitance of the transistor must be reduced in every possible way. To solve this problem, it is necessary to weaken the deleterious effect that has received the name of the Miller effect.
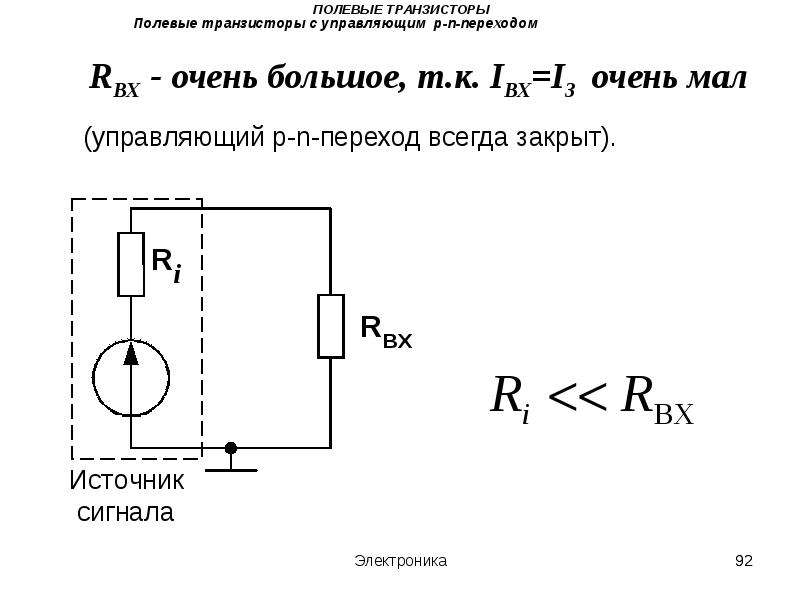 This article will deal with this effect.
This article will deal with this effect.Библиографическая ссылка на статью:
Болобин И.А. Эффект Миллера // Современная техника и технологии. 2017. № 3 [Электронный ресурс]. URL: https://technology.snauka.ru/2017/03/12948 (дата обращения: 04.10.2021).
Для успешной разработки мощного полевого транзистора необходимо всячески уменьшать входную емкость транзистора. Чтобы решить эту проблему нужно ослабить вредное воздействие получившее название эффекта Миллера. В данной статье речь пойдет об этом эффекте.
Рисунок 1–Ключ на МДП-транзисторе
С подачей на вход схемы управляющего импульса транзистор начинает открываться. Емкости и начинают заряжаться с постоянной времени .
Транзистор начнет открываться после того как суммарная емкость зарядятся до порогового напряжения . После этого транзистор открылся и становится усилителем и на емкость начинает влиять коэффициент усиления, который может достигать довольно больших значений (рисунок 2).
Рисунок 2–Эквивалентная схема полевого транзистора в режиме усиления
Эквивалентная емкость будет равна:
где К–коэффициент усиления. Емкость сильно увеличится и постоянная времени также увеличится. Что приведет к образованию «полки» на графике выходного напряжения (рисунок 3).
Рисунок 3–Временные диаграммы переключения МДП-транзистора
Так как коэффициент усиления К пропорционален напряжению на затворе, то с ростом напряжения эквивалентная емкость также буде возрастать. Процесс включения полевого транзистора имеет три стадии: предпороговую; начального включения; полного включения. На предпороговой стадии входная эквивалентная емкость заряжается с постоянной времени . На стадии начального включения на эквивалентную емкость начинает влиять эффект Миллера [1, c. 102]. С увеличением тока стока Ic растет крутизна и коэффициент усиления и влияние эффекта Миллера также возрастает. После достижения стадии полного включения транзистора эффект Миллера перестает доминировать, но благодаря протеканию тока в канале эквивалентная емкость будет несколько выше, чем на предпороговой стадии.
На стадии начального включения на эквивалентную емкость начинает влиять эффект Миллера [1, c. 102]. С увеличением тока стока Ic растет крутизна и коэффициент усиления и влияние эффекта Миллера также возрастает. После достижения стадии полного включения транзистора эффект Миллера перестает доминировать, но благодаря протеканию тока в канале эквивалентная емкость будет несколько выше, чем на предпороговой стадии.
Эквивалентная схема МДП–транзистора представлена на рисунке 4
Рисунок 4–Эквивалентная схема МДП–транзистора
На данной схеме приведены основные паразитные параметры мощного МДП–транзистора. Для наглядного представления влияния эффекта Миллера эквивалентная схема была промоделирована в программе схемотехнического моделирования Micro–Cap 9. При напряжении питания 100 В были получены графики переходный процессов на транзисторе (рисунок 5).
Рисунок 5–Графики входного и выходного напряжения
Видно образование «полки» под влиянием увеличения эквивалентной емкости. При повышении напряжения питания до 1000 В длина «полки» увеличивается (рисунок 6).
При повышении напряжения питания до 1000 В длина «полки» увеличивается (рисунок 6).
Рисунок 6–Входные и выходные характеристики при Uпит=1000 В.
Качество МДП–транзистора тем выше, чем меньше паразитная емкость.[2, c. 69].
Библиографический список
- Окснер Э.С. Мощные полевые транзисторы и их применение. Пер. с англ. – М.: Радио и связь, 1985 г. – 288 с.
- Воронин П.А. Силовые полупроводниковые ключи. Семейства, характеристики, применение. Издание 2-е переработанное. М.: Издательский дом «Додека XXI», 2005. – 384 с.
- Амелина М.А., Амелин С.А. Программа схемотехнического моделирования Micro-Cap. Версии 9, 10. [Электронный ресурс]: учеб. пособие / Амелина М.А., Амелин С.А – Электрон. текстовые дан. – СПб. : Лань, 2014. – 632 с. Режим доступа: URL http://e.lanbook.com/books/element.php?pl1_id=53665
Все статьи автора «Болобин Илья Андреевич»
Анализ и расчет статических параметров транзистора в схеме с общим затвором
1. Введение
Введение
Данная курсовая работа посвящена рассмотрению статических параметров одного из самых распространенных и самых универсальных усилительных приборов – полевого транзистора (ПТ).
Полевой транзистор в качестве элемента схемы представляет собой активный трехполюсник, поэтому включение его в схему можно осуществить шестью различными способами. Однако практический интерес представляют лишь те способы включения, которые позволяют получить усиление по мощности. Таких схем три:
1) схема с общим истоком и входом па затвор;
2) схема с общим стоком и входом на затвор;
3) схема с общим затвором и входом на исток.
Входное и выходное сопротивления, а также функции прямой и обратной передач усилительного каскада на полевом транзисторе будут, зависеть от выбранной схемы включения. Поэтому одна из схем должна быть принята за типовую, тогда параметры двух остальных схем могут быть, рассчитаны из параметров типовой схемы с помощью соответствующих преобразований.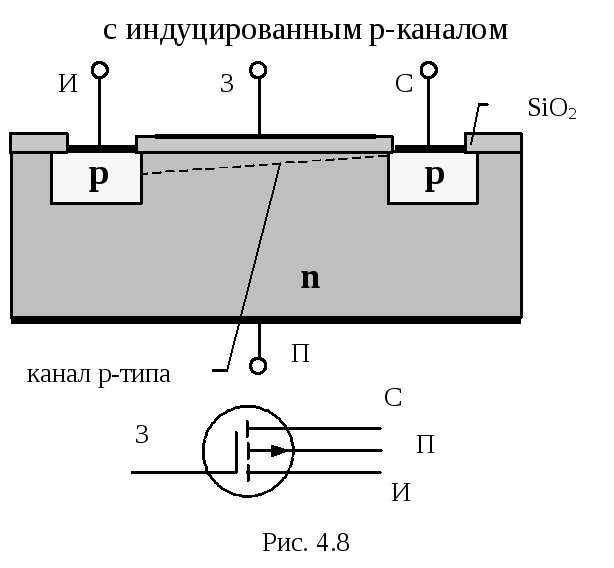
Основными преимуществами полевого транзистора являются его большое входное сопротивление по постоянному току и высокая технологичность. Последнее обусловливает широкое применение полевых транзисторов при разработке цифровых интегральных схем.
2.ОБЩИЕ СВЕДЕНИЯ О ПОЛЕВЫХ ТРАНЗИСТОАХ.
Полевыми транзисторами называют такие транзисторы, в которых ток создается носителями заряда одной полярности и ток в канале управляется электрическим полем. В транзисторе с p-каналом ток проводят дырки, а в транзисторе с n-каналом – электроны.
Полевой транзистор – полупроводниковый прибор, усилительные свойства которого обусловлены потоком основных носителей протекающим через проводящий канал, и управляемым электрическим полем.
Полевой транзистор в отличие от биполярного иногда, называют униполярным, так как его работа основана на использовании только основных носителей заряда – либо электронов, либо дырок. Поэтому в полевых транзисторах, отсутствуют процессы, изменения (накопления и рассасывания) объемного заряда неосновных носителей, оказывающие заметное влияние на быстродействие биполярных транзисторов. Основным способом движения носителей заряда, образующих ток полевого транзистора, является их дрейф в электрическом поле. Проводящий слой, в котором создается рабочий ток полевого транзистора, называют каналом.
Основным способом движения носителей заряда, образующих ток полевого транзистора, является их дрейф в электрическом поле. Проводящий слой, в котором создается рабочий ток полевого транзистора, называют каналом.
Полевой транзистор – полупроводниковый усилительный прибор, которым управляет не ток (как биполярным транзистором), а напряжение (электрическое поле, отсюда и название – полевой), осуществляющее изменение площади поперечного сечения проводящего канала, в результате изменяется выходной ток транзистора. Управление же электрическим полем предполагает отсутствие статического входного тока, что позволяет уменьшить мощность, требуемую для управления транзистором.
Токопроводящие каналы могут быть приповерхностными (транзисторы с изолированным затвором) и объемными (транзисторы с управляющим р-п-переходом). Приповерхностный канал представляет собой либо обогащенный слой, образующийся за счет донорных примесей в полупроводнике, либо инверсный слой, возникающий под действием внешнего поля. Такой полевой транзистор имеет классическую структуру металл-диэлектрик-полупроводник (МДП-структуру), в которой роль диэлектрика, как правило, играет оксид (например, двуокись кремния SiO2). Поэтому полевой транзистор с такой структурой часто называют МДП- или МОП-транзистором (металл-оксид-полупроводник).
Такой полевой транзистор имеет классическую структуру металл-диэлектрик-полупроводник (МДП-структуру), в которой роль диэлектрика, как правило, играет оксид (например, двуокись кремния SiO2). Поэтому полевой транзистор с такой структурой часто называют МДП- или МОП-транзистором (металл-оксид-полупроводник).
Металлический электрод, создающий эффект поля, называют затвором (З), два других электрода – истоком (И) и стоком (С). Исток и сток в принципе обратимы. Истоком служит тот из них, из которого при соответствующей полярности напряжения между истоком и стоком в канал поступают основные носители заряда, а стоком – тот, через который эти носители уходят из канала. В зависимости от того, какой из выводов является общим для входа и выхода, различают три схемы включения полевого транзистора:
– с общим истоком (ОИ),
– с общим затвором (ОЗ),
– с общим стоком (ОС).
Наибольшее распространение на практике нашла схема с ОИ.
3.Принцип работы полевого транзистора с p-n-переходом.
В полевом транзисторе с объемным каналом площадь поперечного сечения канала меняется за счет изменения площади обедненного слоя обратно включенного р-n-перехода. На (рис. 1) показан полевой транзистор с управляющим р-п-переходом, включенный по схеме с ОИ. При ее анализе все напряжения будем рассматривать с учетом их знаков.
На p-n-переход (затвор – исток) подается обратное напряжение Uзи. При его уменьшении глубина d обедненного слоя (заштрихованная область на рис.1 – область объемного заряда) возрастает, а токопроводящее сечение b канала сужается. При этом увеличивается сопротивление канала, а следовательно, снижается выходной ток Iс транзистора. Поскольку напряжение Uзи прикладывается к p-n-переходу в обратном направлении, ток Iз ничтожно мал и практически не зависит от управляющего напряжения.
Рис.1 Полевой транзистор с управляющим р-n-псреходом.
Для полевых транзисторов входная характеристика (зависимость Iз от Uзи при фиксированном значении Uси) не имеет практического применения и при расчетах используют только передаточные и выходные ВАХ. На (рис.2) приведены выходные и передаточные характеристики полевого транзистора с управляющим p-n-переходом для схемы включения с ОИ. Эти характеристики, подобно характеристикам биполярного транзистора, имеют нелинейный характер, а, следовательно, полевой транзиcтoр, как и биполярный, является управляемым нелинейным элементом цепи. Однако при сравнении их выходных характеристик очевидны существенные различия.
На (рис.2) приведены выходные и передаточные характеристики полевого транзистора с управляющим p-n-переходом для схемы включения с ОИ. Эти характеристики, подобно характеристикам биполярного транзистора, имеют нелинейный характер, а, следовательно, полевой транзиcтoр, как и биполярный, является управляемым нелинейным элементом цепи. Однако при сравнении их выходных характеристик очевидны существенные различия.
а) б)
Рис.2 Статические вольт-амперные характеристики полевых транзисторов с управляющим р-п-переходом (схема ОИ):
а – выходные,
б – передаточные.:
На начальном участке изменения выходного напряжения полевого транзистора крутизна его ВАХ с изменением входного сигнала не остается постоянной. Как видно из рис.2 а) с уменьшением Uзи крутизна ВАХ уменьшается, а следовательно, возрастает выходное сопротивление транзистора. Это указывает на зависимость выходного сопротивления полевого транзистора от управляющего напряжения на этом участке ВАХ.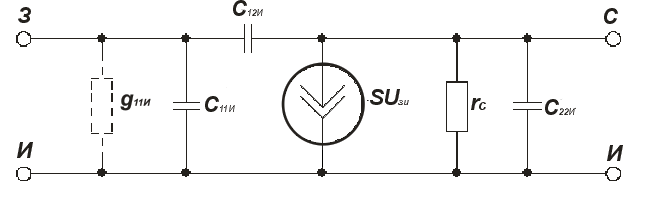
Изменение выходного тока Iс полевого транзистора при изменении Uси происходит до определенного значения выходного напряжения, равного напряжению насыщения Uси нас. (проекция на ось абсцисс точки пересечения штриховой кривой ОА с соответствующей ВАХ транзистора). Это напряжение равно
( 1 )
где Uзи отс.- управляющее напряжение, при котором Ic = 0 (режим отсечки), а Uзи – управляющее напряжение, соответствующее рассматриваемой ВАХ транзистора.
При дальнейшем возрастании выходного напряжения ток Iс остается неизменным вплоть до пробивного напряжения Uси проб.
Физику происходящих при этом процессов в полевом транзисторе можно объяснить следующим образом.
Как уже отмечалось, при входном напряжении Uзи = Uзи отс., соответствующем обратному напряжению на р-п-переходе (затвор – исток), при котором токопроводящий канал транзистора будет полностью перекрыт, выходной ток Iс транзистора будет равен нулю (см. рис. 2б). При Uзи > Uзи отс. в токопроводящем канале появляется проток шириной b и по нему от стока к истоку начинает протекать ток Iс, создающий на сопротивлении канала падение напряжения. Это напряжение, складываясь с напряжением Uзи, по мере приближения к стоку, приводит к увеличению напряжения на обратно смещенном р-n-переходе, т.е. к сужению канала при приближении к истоку, как это показано на (рис.1). Рост тока Ic приводит к увеличению падения напряжения на канале и к уменьшению его ширины, в результате уменьшается ток Iс, протекающий между стоком и истоком.
рис. 2б). При Uзи > Uзи отс. в токопроводящем канале появляется проток шириной b и по нему от стока к истоку начинает протекать ток Iс, создающий на сопротивлении канала падение напряжения. Это напряжение, складываясь с напряжением Uзи, по мере приближения к стоку, приводит к увеличению напряжения на обратно смещенном р-n-переходе, т.е. к сужению канала при приближении к истоку, как это показано на (рис.1). Рост тока Ic приводит к увеличению падения напряжения на канале и к уменьшению его ширины, в результате уменьшается ток Iс, протекающий между стоком и истоком.
Однако уменьшение тока стока приводит к уменьшению падения напряжения на канале и к уменьшению фактического (суммарного) напряжения на обратно смещенном p-n-переходе, что увеличивает ширину b канала, а следовательно, и ток Iс. В результате, в структуре полевого транзистора, приведенного на (рис.1), устанавливается динамическое равновесие и при Uси > Uси нас. ток стока поддерживается на уровне насыщения Iс нас.
Как видно из рис. 2 а с уменьшением напряжения Uзи пробивное напряжение транзистора Uси проб. уменьшается. При этом всегда выполняется равенство
2 а с уменьшением напряжения Uзи пробивное напряжение транзистора Uси проб. уменьшается. При этом всегда выполняется равенство
Uси. проб = Uси проб (при Uзи = 0) + Uзи ( 2 )
Если Uзи = Uзи отс., транзистор заперт (режим отсечки) и Iс = 0. В случае открытого транзистора для любого значения выходного тока Iс будет соблюдаться равенство
Uзи – Uси нас. = Uзи отс. = -Uзс нас., ( 3 )
где Uзи нас. – напряжение между стоком и затвором в режиме насыщения транзистора.
Из сравнения приведенных на рис.2 ВАХ видно, что полярности управляющего и выходного напряжений полевого транзистора с управляющим р-n-переходом не совпадают.
4.Основные параметры ПТ.
Основными параметрами, характеризующими полевой транзистор как нелинейный элемент, являются:
-коэффициент усиления по напряжению
при Ic=const ( 4 )
-крутизна (определяется по передаточной характеристике)
при Uси=const; ( 5 )-дифференциальное выходное (внутреннее Ri) сопротивление
при Uзи=const; ( 6 )
-дифференциальное сопротивление участка затвор – сток
( 7 )
Это сопротивление учитывает обратную связь между выходом и входом полевого транзистора.
Входное сопротивление r вх полевого транзистора очень велико (несколько мегаом), поскольку значение тока затвора Iз очень мало.
Значение параметра Ri определяют при работе транзистора в режиме насыщения как котангенс угла наклона выходной характеристики. Так как для полевых транзисторов режиму насыщения соответствует пологая часть выходной характеристики, то в рабочей области этот угол мал и, следовательно, внутреннее сопротивление оказывается достаточно большим (сотни килоом).
Крутизна S передаточной характеристики отражает степень влияния входного напряжения на выходной ток, т. е. эффективность управляющего действия затвора, и составляет 1 … 5 мА/В. Первые три параметра связаны соотношением
( 8 )
5.Эквивалентные схемы полевых транзисторов.
Рассмотрим наиболее распространенные схемы замещения полевых транзисторов. На (рис.3 а) приведена схема замещения ПТ с управляющим p-n-переходом, а, на (рис. 3б) – с изолированным затвором. В этих схемах принято, что вывод подложки электрически соединен с истоком. Такое включение наиболее часто используется при разработке схем на ПТ.
3б) – с изолированным затвором. В этих схемах принято, что вывод подложки электрически соединен с истоком. Такое включение наиболее часто используется при разработке схем на ПТ.
Следует отметить, что входное и выходное сопротивления ПТ носят явно выраженный емкостный характер. Активная составляющая входного тока для ПТ управляющим р-n-переходом обусловлена током обратно смещенного p-n-перехода и весьма мала.
а)
б)
Рис.3 Эквивалентные схемы полевого транзистора с управляющим р-п-переходом (а) и изолированным затвором (б)
6.Отличительные особенности полевого транзистора.
Из принципа действия полевого транзистора вытекают две основные его особенности:
-в установившемся режиме работы входной ток полевого транзистора стремится к пулю (т. е. rвх стремится к бесконечности),
-инерционность полевого транзистора в отличие от биполярного обусловлена только процессами перезаряда его входной и выходной емкостей.
Казалось бы, что отсутствие процессов изменения объемного заряда неосновных носителей дает преимущество полевому транзистору в быстродействии перед биполярным транзистором. Однако, следует отметить, что конструкция полевого транзистора предполагает получение больших значений его входных и выходных емкостей. Последнее с увеличением частоты входного сигнала приводит к фактическому падению коэффициента усиления каскада на полевом транзисторе. Действительно, по постоянному току коэффициент усиления полевых транзисторов стремится к бесконечности (входной ток стремится к нулю). При увеличении частоты входного сигнала входной ток полевого транзистора, определяемый его входной емкостью, растет, что эквивалентно снижению значения коэффициента усиления. Поэтому принято считать, что в общем случае по быстродействию, усилению и частотным свойствам полевой транзистор, как правило, не имеет преимуществ перед биполярным транзистором.
Полевые транзисторы имеют преимущество перед биполярными транзисторами в большей температурной стабильности их характеристик. Это объясняется тем, что основная температурная нестабильность характеристик биполярного транзистора обусловлена сильной зависимостью количества неосновных носителей заряда в полупроводнике. Учитывая, что полевой транзистор работает с использованием только основных носителей зарядов, которые в меньшей степени подвержены температурному влиянию, в нем отсутствует положительная обратная связь по температуре, присущая биполярным транзисторам.
Это объясняется тем, что основная температурная нестабильность характеристик биполярного транзистора обусловлена сильной зависимостью количества неосновных носителей заряда в полупроводнике. Учитывая, что полевой транзистор работает с использованием только основных носителей зарядов, которые в меньшей степени подвержены температурному влиянию, в нем отсутствует положительная обратная связь по температуре, присущая биполярным транзисторам.
2П302Б кремниевые планарные полевые с затвором на основе p-n перехода и каналом n-типа, цена 43.40 грн.
2П302Б кремниевые планарные полевые с затвором на основе p-n перехода и каналом n-типа (300 mW 30В) Au 5-я приемка 2П302Б Транзисторы 2П302Б кремниевые планарные полевые с затвором на основе p-n перехода и каналом n-типа. Предназначены для применения в широкополосных усилителях в диапазоне частот до 150 МГц, а также в переключающих и коммутирующих устройствах и других схемах аппаратуры специального назначения. Выпускаются в металлостеклянном корпусе с гибкими выводами.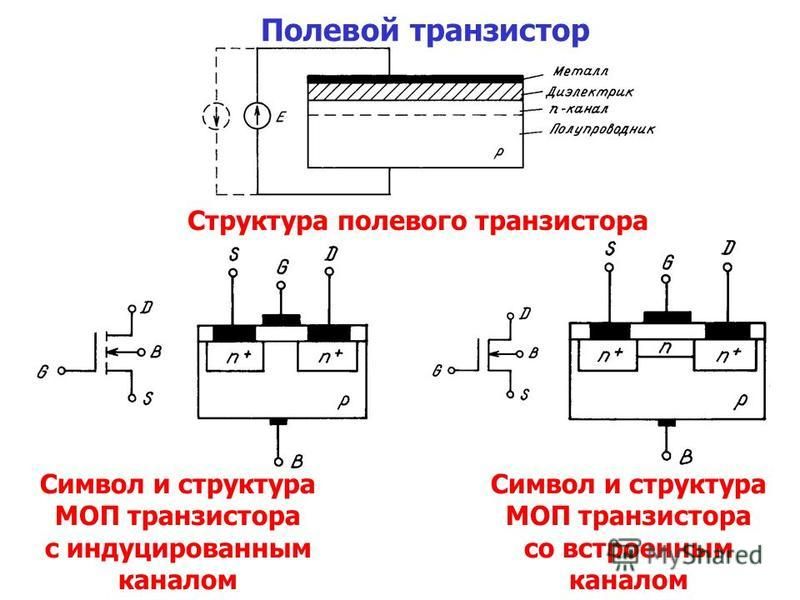 Тип прибора указывается на корпусе. Масса транзистора не более 1,5 г. Тип корпуса для 2П302А, 2П302Б, 2П302В: КТ-2-12. Тип корпуса для 2П302А1, 2П302Б1, 2П302В1: КТ-2-7. Технические условия: АЕЯР.432140.535 ТУ. Основные технические характеристики транзистора 2П302Б: • Структура транзистора: с p-n-переходом и n-каналом; • Рси max — Рассеиваемая мощность сток-исток: 300 мВт; • Uзи отс — Напряжение отсечки транзистора — напряжение между затвором и истоком: не более 7 В; • Uси max — Максимальное напряжение сток-исток: 20 В; • Uзи max — Максимальное напряжение затвор-исток: 10 В; • Iс — Ток стока (постоянный): 43 мА; • Iс нач — Начальный ток стока: 18…43 мА; • Iс ост — Остаточный ток стока: 6 мА; • S — Крутизна характеристики: не менее 7 мА/В; • С11и — Входная емкость транзистора — емкость между затвором и истоком: не более 20 пФ; • С12и — Емкость обратной связи в схеме с общим истоком при коротком замыкании на входе по переменному току: не более 8 пФ; • Rcи отк — Сопротивление сток-исток в открытом состоянии: не более 150 Ом; • tвкл — Время включения транзистора: не более 4 нс; • tвыкл — Время выключения транзистора: не более 5 нс Характеристики полевых транзисторов с затвором на основе p-n перехода и каналом n-типа 2П302А, 2П302Б, 2П302В, 2П302А1, 2П302Б1, 2П302В1: Тип полевого транзистора Р МАКС f МАКС Предельные значения параметров при Т=25°С Значения параметров при Т=25°С Т ОКР UСИ МАКС UЗС МАКС UЗИ МАКС IС МАКС UЗИ ОТС g22И IЗ УТ S IС НАЧ C11И C12И КШ мВт МГц В В В мА В мкСм нА мА/В мА пФ пФ дБ °С 2П302А 300 150 20 20 10 24 5 3…24 7 18…43 33 5 3…24 7 18…43 33
Тип прибора указывается на корпусе. Масса транзистора не более 1,5 г. Тип корпуса для 2П302А, 2П302Б, 2П302В: КТ-2-12. Тип корпуса для 2П302А1, 2П302Б1, 2П302В1: КТ-2-7. Технические условия: АЕЯР.432140.535 ТУ. Основные технические характеристики транзистора 2П302Б: • Структура транзистора: с p-n-переходом и n-каналом; • Рси max — Рассеиваемая мощность сток-исток: 300 мВт; • Uзи отс — Напряжение отсечки транзистора — напряжение между затвором и истоком: не более 7 В; • Uси max — Максимальное напряжение сток-исток: 20 В; • Uзи max — Максимальное напряжение затвор-исток: 10 В; • Iс — Ток стока (постоянный): 43 мА; • Iс нач — Начальный ток стока: 18…43 мА; • Iс ост — Остаточный ток стока: 6 мА; • S — Крутизна характеристики: не менее 7 мА/В; • С11и — Входная емкость транзистора — емкость между затвором и истоком: не более 20 пФ; • С12и — Емкость обратной связи в схеме с общим истоком при коротком замыкании на входе по переменному току: не более 8 пФ; • Rcи отк — Сопротивление сток-исток в открытом состоянии: не более 150 Ом; • tвкл — Время включения транзистора: не более 4 нс; • tвыкл — Время выключения транзистора: не более 5 нс Характеристики полевых транзисторов с затвором на основе p-n перехода и каналом n-типа 2П302А, 2П302Б, 2П302В, 2П302А1, 2П302Б1, 2П302В1: Тип полевого транзистора Р МАКС f МАКС Предельные значения параметров при Т=25°С Значения параметров при Т=25°С Т ОКР UСИ МАКС UЗС МАКС UЗИ МАКС IС МАКС UЗИ ОТС g22И IЗ УТ S IС НАЧ C11И C12И КШ мВт МГц В В В мА В мкСм нА мА/В мА пФ пФ дБ °С 2П302А 300 150 20 20 10 24 5 3…24 7 18…43 33 5 3…24 7 18…43 33
Мощные радиочастотные VDMOS-транзисторы фирмы Microsemi и модули на их основе
Радиочастотные полевые транзисторы с изолированным затвором класса VDMOS объединяют достоинства полевых транзисторов с вертикальным каналом и приборов DMOS, изготовляемых методом двойной диффузии.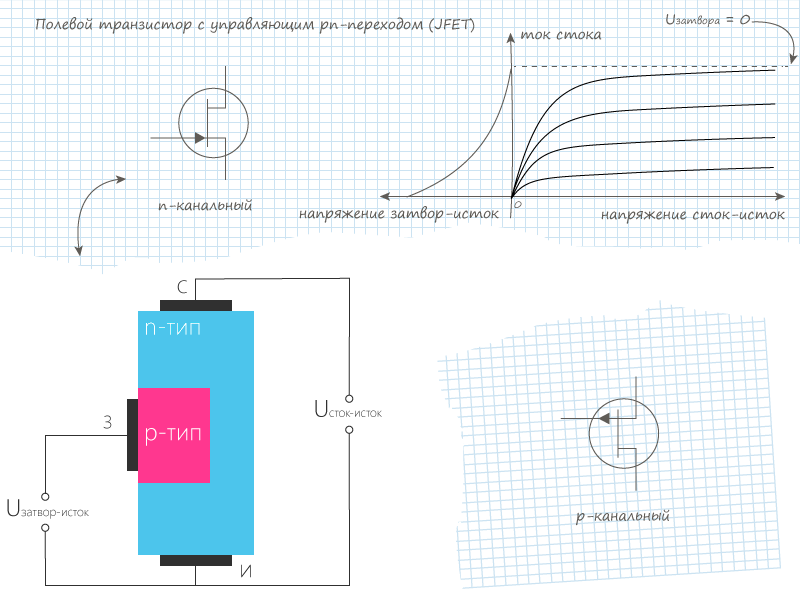 Широкую номенклатуру VDMOS выпускает американская компания Microsemi, с вошедшей в нее фирмой Advanced Power Technology (APT). В статье описаны приборы этих компаний с выходной мощностью от нескольких Вт до 2кВт на частоте от 10 до 200МГц и усилители мощности на их основе.
Широкую номенклатуру VDMOS выпускает американская компания Microsemi, с вошедшей в нее фирмой Advanced Power Technology (APT). В статье описаны приборы этих компаний с выходной мощностью от нескольких Вт до 2кВт на частоте от 10 до 200МГц и усилители мощности на их основе.
Введение
После освоения в СССР в конце 1970-х годов серийного производства первых в мире мощных полевых транзисторов с горизонтальным каналом КП901–КП904 [1, 2] во многих странах бурное развитие получили мощные полевые транзисторы с V- и U-образной структурой и вертикальным расположением канала. Первыми советскими приборами этого типа были транзисторы КП905, КП907, КП908, КП909, КП913 и др. [3, 5–7]. Их рабочая частота достигала 1–2 ГГц, и на них были отработаны принципы построения радиочастотных усилителей мощности [6, 7].
К сожалению, дно и стенки V-образной канавки, получаемой методом анизотропного травления, имели неидеальную структуру полупроводника, что вело к локализации электрического поля под ней и вызывало снижение максимального рабочего напряжения стока.
В конце 1970-х и особенно в 1980-х годах большое развитие получили приборы с двойной диффузией — DMOS. Они, по сути, являются гибридом полевого транзистора с горизонтальным каналом и транзистора с вертикальной структурой. Приборы класса DMOS имеют три важных преимущества по сравнению с приборами с V- и U-образной канавками: отсутствие дефектных областей, улучшенное качество затвора и повышенная подвижность носителей в канале. В то же время они характерны большой емкостью структуры и меньшей рабочей частотой. Две серии таких приборов (с выходной мощностью 300 Вт) созданы Воронежским ФГУП и «НИИ электронной техники» [4].
Мощные VDMOS фирмы Microsemi
Мощные полевые транзисторы за рубежом сейчас производит множество фирм, например ST Microelectronics, Mictosemi, IXYS, International Rectifiers, Philips и др. Компания Microsemi (www.microsemi.com) выпускает мощные радиочастотные полевые транзисторы VDMOS (Vertical Diffusion Metal Oxide Seniconductor), в которых объединены достоинства приборов с вертикальной структурой и DMOS-транзисторов.
Структура VDMOS-транзистора показана на рис. 1. Как нетрудно заметить, V- или U-образная канавка у прибора отсутствует, что заметно упрощает технологию его изготовления. Линии тока истока сначала от его металлических областей проходят через тонкий канал под поликристаллическим горизонтальным затвором и затем, переходя в вертикальное положение, собираются стоком в его N-области и низкоомной подложке типа N+.
Параметры ряда серийных VDMOS даны в таблице 1. В основном это высоковольтные приборы. По сравнению с приборами LDMOS (ST Microelectronics и Philips [5]) значения рабочей частоты приборов ниже (до 200МГц), но зато они имеют выдающиеся энергетические показатели — выходную мощность до 750Вт и максимальное напряжение на стоке 1200В. Некоторые приборы хорошо приспособлены для применения в усилителях мощности с низковольтным питанием от 12 до 50В).
VDMOS-транзисторы имеют различное корпусное исполнение, обусловленное реализуемыми схемотехническими решениями. Основные типы корпусов, применяемые при производстве мощных VDMOS транзисторов компании Microsemi, представлены на рис. 2. Характерной особенностью всех представленных корпусов является то, что они имеют малую высоту, это позволяет размещать их на достаточно тонкой печатной плате или теплоотводящей пластине.
Основные типы корпусов, применяемые при производстве мощных VDMOS транзисторов компании Microsemi, представлены на рис. 2. Характерной особенностью всех представленных корпусов является то, что они имеют малую высоту, это позволяет размещать их на достаточно тонкой печатной плате или теплоотводящей пластине.
Знакомство с силовыми VDMOS-транзисторами компании Microsemi начнем с прибора ARF1519. В качестве основных параметров приборов производитель указывает напряжение питания усилителя мощности, выходную мощность и частоту выходного сигнала. У этого прибора они равны 250В, 750Вт и 25МГц соответственно. При работе резонансного усилителя в классе C напряжение на стоке достигает значений в 3–4 раза выше напряжения питания. Поэтому максимальное рабочее напряжение у этого транзистора нормируется на уровне 1000В. Из приведённых технических характеристик видно, что компонент ARF1519 Microsemi является высоковольтным мощным транзистором с умеренной (для такого класса приборов) максимальной рабочей частотой.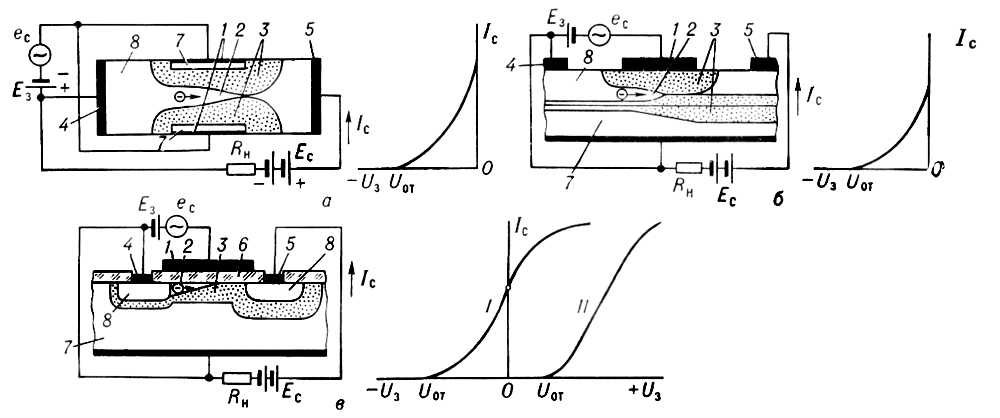 В то же время отметим, что она на порядок выше, чем рабочая частота сопоставимого по мощности и напряжению на стоке силового (ключевого) транзистора.
В то же время отметим, что она на порядок выше, чем рабочая частота сопоставимого по мощности и напряжению на стоке силового (ключевого) транзистора.
Выходные и передаточные характеристики транзистора ARF1519 показаны на рис. 3. Уровень остаточного напряжения на стоке включенного транзистора достаточно высок: до 15–20В при максимальном рабочем токе. Семейство передаточных характеристик имеет характерную термостабильную точку: в ней кривые пересекаются. Пороговое напряжение транзистора лежит в диапазоне от 2 до 3В.
Постоянный ток стока у VDMOS-транзистора ARF1519 нормируется на уровне 20А, а импульсный ток может превышать 40А. Естественно, такой сильноточный прибор имеет большую ёмкость. Зависимость ёмкости от напряжения «сток-исток» UDS характеризуется резкой нелинейностью (рис. 4). Средние значения ёмкостей: входная — 4600пФ, выходная — 310пФ, проходная — 90пФ. Столь большие значения ёмкости указывают на то, что импедансы входа и выхода у транзистора очень малы, и поэтому особое значение приобретает согласование импедансов транзистора с импедансами источника входного сигнала и нагрузки (обычно 50Ом).
Степень нагрева транзистора определяется значением его термического импеданса Rth (°C/Вт). Зависимость термического импеданса транзистора ARF1519 от длительности импульса тока стока представлена на рис. 5 и позволяет оценить степень допустимого увеличения тока стока от длительности импульса тока при заданном периоде повторения сигнала.
Основные квалификационные параметры транзистора оцениваются при его работе в составе тестовых схем усилителей мощности. Такие схемы SPICE-модели транзисторов для их расчета и моделирования компания Microsemi приводит практически для всех своих транзисторов. На рис. 6 представлена тестовая схема для транзистора ARF1519. Там же приведена спецификация компонентов этой схемы и чертеж варианта монтажа схемы на печатной плате.
Выбор ARF1519 в качестве первого транзистора для ознакомления с продукцией Microsemi не случаен: тестовая схема для него, показанная на рис. 6, — самая простая и наглядная. Это обычный однотактный каскад усилителя мощности на транзисторе, включенном с общим истоком. Для согласования выходного сопротивления генератора входного сигнала (50Ом) с низким входным импедансом полевого транзистора служит обычный ВЧ-трансформатор с большим коэффициентом трансформации (10:1). В стоке транзистора установлен последовательный резонансный контур с емкостной цепью согласования с нагрузкой (тоже 50Ом). Усилитель работает в классе C и развивает на частоте 13,56МГц мощность 750Вт (!). В схеме усилителя нет никакой «экзотики».
Низковольтные сильноточные VDMOS
Теперь рассмотрим транзистор VRG154, предназначенный для применения в устройствах с малым напряжением питания (от 12 до 50В). Максимальное напряжение на стоке этого прибора 170В, непрерывный ток коллектора 60A, а импульсный может достигать удвоенных значений. При этом прибор способен развивать мощность 600Вт на частоте 80 МГц при напряжении питания усилителя мощности 50 В и КПД 75%. Максимальная рассеиваемая на стоке мощность у этого прибора 1350 Вт!
Выходные и передаточные характеристики транзистора VRG154 представлены на рис. 7. Выходные характеристики (рис. 7а) демонстрируют малые значения напряжения «сток-исток» при больших (до 60A) токах стока. Именно это обстоятельство позволяет применять эти транзисторы в схемах с низковольтным напряжением питания и рекордно большой выходной мощностью.
На рис. 8 показаны графики зависимости емкостей транзистора от напряжения «сток-исток». Этот мощный прибор имеет большую и резко нелинейную зависимость ёмкости.
Зависимость выходной мощности от входной на частоте 30 и 55МГц для транзистора VRG154 показана на рис. 9. Видно, что выходная мощность транзистора при этих значениях частоты может превышать 1000Вт.
Зависимость теплового импеданса от длительности импульса в импульсном режиме работы дана на рис. 10. Подобные графики зависимости приводятся практически для всех мощных полевых транзисторов фирмы Microsemi.
Тестовая схема однотактного генератора, в которой испытывается транзистор VRG154, показана на рис. 11. Для согласования импедансов используются сложные LC-цепи (двухъячейчатые фильтры) на входе и на выходе с настройкой их с помощью триммеров. Напряжение питания усилителя мощности составляет 50В.
В схеме двухтактного усилителя мощности (рис. 12) пара транзисторов VRG154 способна при напряжении питания 40В отдавать на выходе мощность 1кВт. Для стабилизации напряжения смещения мощных полевых транзисторов и температурной компенсации используется специальный термочувствительный стабилизатор напряжения смещения на интегральной микросхеме IC1. Согласование импедансов источника входного сигнала и входа усилителя обеспечивается с помощью ВЧ-трансформаторов T1. Для согласования выходного импеданса с импедансом нагрузки применены цепи на отрезках линий передачи их коаксиального кабеля [13].
Сверхвысоковольтные VDMOS с напряжением на стоке более 1000 В
Транзистор ARF1505 (рис. 13) — это сверхвысоковольтный мощный полевой транзистор с максимальным напряжением на стоке 1200В, током стока 25А и рассеиваемой мощностью 1500Вт.
Для обеспечения стабильной работоспособности такого мощного транзистора необходимо жестко закрепить его на поверхности радиатора или теплоотводящей пластины. Способ крепления и размеры корпуса этого транзистора представлены на рис. 14.
Графики зависимости емкости от напряжения «сток-исток» у этого прибора нелинейные (рис. 15). При напряжении «сток-исток» 1В они превышают 10 000 пФ, но с ростом этого напряжения быстро падают. В технических данных на этот транзистор указаны следующие средние значения емкостей:
• входная — 5400пФ;
• выходная — 400пФ;
• проходная — 160пФ.
Выходные ВАХ транзистора ARF1505 показаны на рис. 16. Пороговое напряжение отсечки у этих приборов от 3 до 6В. Для сверхвысоковольтного прибора видимые на рис. 16 уровни остаточного напряжения малы. Температурный диапазон работы транзистора лежит в пределах от -55 до +175°C.
Тестовая схема усилителя мощности на частоту 27МГц с напряжением питания 300В показана на рис. 17. Схема проста и от простейших схем отличается отрезком линии передачи во входной цепи. На рис. 17 справа показана конструкция этого усилителя на печатной плате. Выходная мощность усилителя — 750Вт при коэффициенте полезного действия 75% и коэффициенте усиления 17 дБ. Усилитель работает в классе C.
Мощные VDMOS с частотой выходного сигнала более 100 МГц
Представительную, хотя и не очень многочисленную группу VDMOS составляют транзисторы с повышенной (100МГц и выше) частотой выходного сигнала. Их данные приведены в таблице 2.
Одним из таких приборов является высокочастотный транзистор VRF151, изображённый на рис. 18. Свои рабочие параметры он реализует при напряжении питания 50В.
Почти аналогичный транзистор VRF150 имеет мощность выходного сигнала 150Вт на немного более низкой частоте — 150 МГц. А транзистор VRF141 позволяет получать мощность 150Вт на частоте 175МГц при более низком напряжении питания — 28 В. VRF151 имеет рабочее напряжение на стоке до 170В, ток стока 16A, рассеиваемую на стоке мощность до 300Вт и температурный диапазон работы от -65 до +150°C. Выходные и передаточные характеристики прибора показаны на рис. 19.
Высокочастотные мощные полевые транзисторы имеют на порядок меньшие показатели емкости, чем их менее высокочастотные собратья. Это видно на представленном рис. 20. Средние значения емкостей составляют: входная — 375пФ, выходная — 200пФ и проходная емкость — 12пФ. Эти, вполне умеренные значения емкостей расширяют частотный диапазон работы транзисторов до частот примерно 200МГц.
Графики зависимости выходной мощности от мощности входного сигнала показаны на рис. 21 при двух значениях напряжения питания тестовой схемы — 50 и 40В. Вид этих графиков типовой, и каких-либо особенностей они не имеют.
Для ВЧ- и СВЧ-транзисторов часто указывают параметры вносимых ими искажений. На рис. 22 представлены кривые интермодуляционных искажений для транзистора VRF151.
Тестовая схема однотактного усилителя мощности на частоту 175МГц показана на рис. 23.
Ряд транзисторов этой группы выпускается в более дешевых пластмассовых корпусах, рассчитанных на меньшую мощность. Например, это транзистор ARF449 (рис. 24).
Он тестируется в схеме на частоте 81,36МГц. Зависимость мощности выходного сигнала от мощности входного сигнала для усилителя мощности на транзисторе ARF449 показана на рис. 25.
На рис. 26 представлена тестовая схема усилителя мощности на транзисторе ARF449, работающего в классе C. Усилитель обеспечивает мощность выходного сигнала 90Вт, КПД 75% и коэффициент усиления 13дБ.
Сдвоенный мощный низковольтный VDMOS транзистор VRF141G
Для создания двухтактных СВЧ-усилителей мощности с низковольтным 28В питанием (напряжение 28В) служит сдвоенный мощный низковольтный VDMOS VRF141G (рис. 27). Под маркой MRF141G этот прибор выпускает и другой производитель высокочастотных компонентов — компания Motorola. Усилители мощности на этих транзисторах обеспечивают мощность 300Вт на частоте 175 МГц при напряжении питания 28В.
Выходные ВАХ и передаточные характеристики одного транзистора VRF141G показаны на рис. 28, а зависимость емкостей этих приборов от напряжения «сток-исток» приведена на рис. 29. Это типичные характеристики для мощных низковольтных VDMOS полевых транзисторов.
Типовой является и характеристика зависимости параметров емкостей (для одного транзистора) от напряжения «сток-исток».
На рис. 30 представлена тестовая схема двухтактного усилителя мощности на сдвоенном мощном VDMOS VRF141G. Входной фазоинвертор и устройство согласования входного импеданса с импедансом источника входного сигнала выполнены по схеме широкополосного трансформатора на трех отрезках коаксиального кабеля. Выходной трансформатор также построен на трех отрезках коаксиального кабеля. Приняты меры по ослаблению проникновения гармоник выходного сигнала в цепь источника питания с напряжением 28В. Усилитель обеспечивает КПД в 50% и типовой коэффициент усиления 14дБ на частоте 175МГц.
Мощные высоковольтные сверхскоростные VDMOS транзисторы со встроенными драйверами
Особенно высокими энергетическими показателями обладают мощные высоковольтные VDMOS со встроенным драйвером управления затвором (табл. 3). По существу, это гибридные микросхемы, содержащие мощные транзисторы с драйверами и ряд бескорпусных компонентов внутри единого корпуса. Применение встроенного драйвера (или двух драйверов в приборах с двумя мощными транзисторами) обеспечивает время переключения мощных приборов в единицы нс, что позволяет использовать их в усилителях класса D (работающих в ключевом режиме) с частотой выше 10МГц с высоким КПД до 90%.
На рис. 31 показан одиночный (N = 1) мощный высоковольтный транзистор DRF1200 со встроенным драйвером управления затвором. Драйвер требует дополнительного напряжения питания 15–18В. Входное напряжение драйвера 3В. Прибор DRF1201 содержит два параллельно включенных VDMOS транзистора, что увеличивает ток стока до 26A.
Функциональная схема драйвера показана на рис. 32. Драйвер построен на основе скоростного триггера Шмитта и двухтактной схемы быстрого заряда-разряда входной емкости мощного полевого транзистора, куда входят комплементарные полевые транзисторы средней мощности.
На рис. 33 представлена схема, в которой тестируется прибор. По существу, это схема ключа на мощном полевом транзисторе с резистивной нагрузкой RL.
На рис. 34 приведены осциллограммы процессов переключения ключа на транзисторе DRF1200 с драйвером. Напряжение питания ключа 800В, сопротивление нагрузки 51Ом. Время выключения ключа в 3,4нс — это очень малое значение для такого мощного ключа. Сопротивление «сток-исток» включенного транзистора 0,9Ом. Максимальное напряжение на стоке полевого транзистора — 1000В, максимальная рассеиваемая транзистором мощность — 360Вт. Типовые значения емкостей: входная — 2000пФ, выходная — 165пФ, проходная — 75пФ.
Печатная плата тестовой схемы ключа на транзисторе DRF1200 показана на рис. 35. Благодаря тестированию во временной, а не в частотной области, конструкция платы заметно упрощена. Разумеется, прибор можно использовать и в частотной области для построения усилителей мощности с частотой до 30МГц. Транзистор DRF1200 предназначен для построения усилителей мощности класса E и преобразователей с импульсным регулированием.
Выпускаются также мощные двойные (N = 2) высоковольтные VDMOS DRF1301 (рис. 36) для двухтактных устройств. Их применение может упростить построение некоторых устройств мощной усилительной и преобразовательной техники.
Для демонстрации возможностей мощных VDMOS со встроенными драйверами фирма Microsemi выпускает ряд генераторов мощных синусоидальных сигналов с выходной мощностью от 600 до 2500Вт. Два из них показаны на рис. 37.
Прибор VDMOS DRF1400 содержит полумост из двух высоковольтных транзисторов с драйверами затвора [13]. Он предназначен для построения усилителей, работающих в классе D (в ключевом режиме) (рис. 38). Их транзисторы управляются прямоугольными импульсами с широтно-импульсной модуляцией. Когда верхний транзистор открыт, нижний — закрыт. И наоборот.
На рис. 39 показаны платы, образующие тестовый генератор c усилителем класса D на приборе DRF1400. Усилитель обеспечивает на рабочей частоте 13,56 МГц выходную мощность 1,7кВт при КПД 87%.
Моделирование устройств на VDMOS в системе MATLAB+Simulink
Сложность расчета и построения мощных высокоскоростных устройств и трудности их экспериментальной отладки делают важным математическое моделирование таких устройств. В последние годы одной из основных систем для такого моделирования является матричная система MATLAB с пакетом блочного имитационного моделирования Simulink [9–11].
В последней реализации этой системы MATLAB+Simulink R2012 a имеются пакеты расширения SimPowerSystem и SimElectronics, библиотеки моделей которых содержат мощные MOSFET и средства их контроля, в том числе расчета температуры внутренней области и рассеиваемой мощности. При этом есть как упрощенные модели, так и SPICE-совместимые. Встроенный пример моделирования характериографа позволяет легко подобрать параметры MOSFET c ВАХ нужного вида.
Для примера рассмотрим моделирование мощного усилителя звуковой частоты с широтно-импульсным регулятором. Диаграмма модели усилителя представлена на рис. 40. В правой ее части показано окно установки входного сигнала — две синусоиды с частотами 2000 и 2500Гц и амплитудой 15В. В диаграмме использован блок Feedback Controller широтно-импульсного регулятора из пакета расширения SimElectronics. Преобразование идет на частоте 1МГц.
Субмодель мостового регулятора на двух полумостах с мощными MOSFET представлена блоком MOSFETS&Filters. Сделав на этом блоке двойной щелчок правой клавишей мыши, можно вывести диаграмму моделей ключей: она показана на рис. 41 сверху. Там же показаны диаграммы субмоделей LC-фильтров, которые гасят пульсации сигнала, связанные с широтно-импульсным характером регулирования.
Эта модель с помощью виртуального осциллографа строит временные диаграммы работы усилителя (рис. 42 сверху) и спектр мощности частот входного и выходного сигналов. Он показан на рис. 42 снизу. Для получения этих данных модель запускают на исполнение кнопкой с изображением черного треугольника в панели инструментов диаграммы модели (рис. 40).
Входной сигнал в виде двух синусоид дает характерные биения, в результате чего он напоминает сигнал модуляции. Он позволяет оценить динамику и динамический диапазон усилителя. На осциллограммах (рис. 42) представлены выходной сигнал, сигнал ошибки и входной сигнал широтно-импульсного регулятора. Нетрудно заметить, что на глаз входной и выходной сигнал имеют одинаковую форму и отличаются только масштабом.
Заключение
Мощные полевые радиочастотные транзисторы класса VDMOS удачно сочетают достоинства VMOS-транзисторов с приборами класса DMOS. Несколько уступая приборам VMOS по значениям максимальной рабочей частоты, они заметно превосходят их по основным энергетическим параметрам — выходной мощности, рабочим напряжениям и токам стока. Обширная номенклатура выпускаемых фирмой Microsemi полевых транзисторов класса VDMOS позволяет строить на них усилители с мощностью выходного сигнала от единиц Вт до 1–2,5 кВт на частоте от 10 до 150 МГц. Такие усилители применяются в телевизионной, спутниковой, радиолокационной, медицинской аппаратуре и аппаратуре для связи, успешно заменяя применяемые ранее устройства на электронных лампах и биполярных транзисторах.
Литература
1. Бачурин В. В., Дьяконов В. П., Сопов О. В. Мощные высокочастотные и сверхвысокочастотные МДП-транзисторы // Электронная промышленность. 1979. № 8.
2. Бачурин В. В., Дьяконов В. П., Сопов О. В. Мощный высокочастотный МДП-транзистор КП904 // Электронная промышленность. 1979. № 5.
3. Бачурин В. В., Бычков С. С., Дьяконов В. П., Прушинский А. К. Мощный кремниевый сверхвысокочастотный МДП-транзистор КП908 // Электронная промышленность. 1980. № 1.
4. Асессоров В., Кожевников В., Дикарев В., Цоцорин А. Мощные ВЧ и СВЧ полевые транзисторы для аппаратуры средств радиосвязи // Компоненты и технологии. 2006. № 5.
5. Захаров В. Мощные СВЧ-транзисторы фирмы Philips Semicomductor // Компоненты и технологии. 2003. № 6.
6. Дьяконов В. П. Мощные полевые транзисторы: история, развитие и перспективы. Аналитический обзор // Силовая электроника. 2011. № 3.
7. Бачурин В. В., Ваксембург В. Я., Дьяконов В. П. и др. Схемотехника устройств на мощных полевых транзисторах: Справочник. М.: Радио и связь, 1994.
8. Дьяконов В. П., Максимчук А. А., Ремнев А. М., Смердов В. Ю. Энциклопедия устройств на полевых транзисторах. М.: СОЛОН-Р, 2002.
9. Дьяконов В. П. Физическое моделирование схем на полевых транзисторах в Simulink и SimElectronics // Компоненты и технологии. 2011. № 11.
10. Дьяконов В. П. Моделирование в MATLAB+Simulink электронных компонентов, систем и устройств // Компоненты и технологии. 2011. № 4.
11. Дьяконов В. П. MATLAB и Simulink для радиоинженеров. М.: ДМК-Пресс, 2011.
12. Ред Э. Справочное пособие по высокочастотной схемотехнике. М.: Мир, 1990.
13. Gui Shoi. 13.56 MHz. Class-D Half Bridge, RF Generator with EDF1400. Application Note 1817. Microsemi. March 2012.
Скачать в PDF
Полевой транзистор— обзор
Входные каскады полевых транзисторов
Полевые транзисторы (полевые транзисторы) имеют гораздо более высокий входной импеданс, чем биполярные переходные транзисторы (BJT), и поэтому кажутся идеальными устройствами для входных каскадов операционных усилителей. Однако они не могут быть изготовлены на всех процессах биполярных ИС, и когда процесс позволяет их производство, у них часто возникают собственные проблемы.
Полевые транзисторыобладают высоким входным сопротивлением, низким током смещения и хорошими высокочастотными характеристиками.(В операционном усилителе более низкий g m полевых транзисторов допускает более высокие хвостовые токи, тем самым увеличивая максимальную скорость нарастания напряжения.) Полевые транзисторы также имеют гораздо более низкий токовый шум.
С другой стороны, входное напряжение смещения пар полевых транзисторов с длинными хвостами не так хорошо, как смещение соответствующих BJT, и подстройка для минимального смещения одновременно не минимизирует дрейф. Для дрейфа требуется отдельная подстройка, и в результате смещение и дрейф в операционном усилителе с полевым транзистором с полевым транзистором хоть и хороши, но не так хороши, как лучшие биполярные транзисторы.Упрощенная процедура подстройки для входного каскада операционного усилителя на полевых транзисторах показана на рисунке 1-26.
Рисунок 1-26. Входной каскад операционного усилителя с полевым транзистором (JFET) с подстройкой смещения и дрейфа
Операционные усилители с полевым транзистором на полевых транзисторах (JFET) можно сделать с очень низким шумом напряжения, но задействованные устройства очень большие и имеют довольно высокую входную емкость, которая зависит от входа. напряжение, и поэтому существует компромисс между шумом напряжения и входной емкостью.
Ток смещения операционного усилителя на полевом транзисторе — это ток утечки диффузионного затвора (или утечка защитного диода затвора, который имеет аналогичные характеристики для полевого МОП-транзистора).Такие токи утечки удваиваются при повышении температуры кристалла на каждые 10 ° C, так что ток смещения операционного усилителя на полевых транзисторах в раз больше при 125 ° C, чем при 25 ° C. Очевидно, это может быть важно при выборе между операционным усилителем с биполярным или полевым транзистором, особенно в высокотемпературных приложениях, где входной ток смещения биполярного операционного усилителя фактически уменьшается.
До сих пор мы говорили в основном обо всех типах полевых транзисторов, то есть о переходах (JFET) и MOS (MOSFETS). На практике операционные усилители с комбинированной технологией биполярного / JFET-транзистора (т.е.е., BiFET) обеспечивают лучшую производительность, чем операционные усилители, использующие чисто MOSFET или CMOS технологию. Хотя ADI и другие производят высокопроизводительные операционные усилители с входными каскадами MOS или CMOS, в целом эти операционные усилители имеют худшие смещение и дрейф, шум напряжения и высокочастотные характеристики, чем биполярные аналоги. Потребляемая мощность обычно несколько ниже, чем у биполярных операционных усилителей с сопоставимой или даже лучшей производительностью.
JFET-устройства требуют большего запаса по сравнению с BJT, поскольку их напряжение отсечки обычно больше, чем напряжение BJT-базой-эмиттером.Следовательно, их труднее работать при очень низких напряжениях питания (1-2 В). В этом отношении КМОП имеет то преимущество, что требует меньшего запаса по сравнению с полевыми транзисторами.
[PDF] ПОЛЕВЫЕ ТРАНЗИСТОРЫ (FETS) — Скачать бесплатно PDF
1 8 ПОЛЕВЫЕ ТРАНЗИСТОРЫ (FETS) ОБЗОР ГЛАВЫ 81 JFET 82 Характеристики и параметры JFET 83 Смещение JFET 8 …
РАСИСТОРЫ F IELD -E FFECT T (FET S)8 ОБЗОР ГЛАВЫ
8–1 8–2 8–3 8–4 8–5 8–6 8–7 8–8 8–9
ПРОСМОТР ДЕЯТЕЛЬНОСТИ ПРИМЕНЕНИЯ
Характеристики и параметры JFET JFET Смещение JFET Омическая область Характеристики и параметры MOSFET Смещение MOSFET Устранение неисправностей IGBT Действия приложения
ЦЕЛИ ГЛАВЫ ◆
◆
Обсудите JFET и чем он отличается от BJ применить характеристики и параметры JFET Обсудить и проанализировать смещение JFET Обсудить омическую область на характеристической кривой JFET Объяснить работу MOSFET Обсудить и применить параметры MOSFET Описать и проанализировать схемы смещения MOSFET Обсудить IGBT
◆
Устранение неисправностей в цепях FET
◆ ◆ ◆ ◆ ◆
КЛЮЧЕВЫЕ УСЛОВИЯ ◆ ◆ ◆ ◆ ◆ ◆
JFET Сток затвор истока Напряжение отсечки Напряжение отсечки
◆ ◆ ◆ ◆ ◆
Омическая область MOSFET Depletion Enhance мент IGBT
Прикладная деятельность включает электронные схемы управления для системы очистки сточных вод.В частности, вы сосредоточитесь на применении полевых транзисторов в чувствительных схемах для химических измерений. ПОСЕТИТЕ ДОПОЛНИТЕЛЬНЫЙ ВЕБ-САЙТ
Учебные пособия и файлы Multisim для этой главы доступны по адресу http://www.pearsonhighered.com/electronics ВВЕДЕНИЕ
BJT (транзисторы с биполярным переходом) были рассмотрены в предыдущих главах. Теперь мы обсудим второй основной тип транзистора, FET (полевой транзистор). Полевые транзисторы являются униполярными устройствами, потому что, в отличие от BJT, которые используют как электронный, так и дырочный ток, они работают только с одним типом носителей заряда.Двумя основными типами полевых транзисторов являются полевой транзистор с переходным соединением (JFET) и полевой транзистор с металлооксидным полупроводником (MOSFET). Термин «полевой эффект» относится к области истощения, образованной в канале полевого транзистора в результате приложения напряжения к одному из его выводов (затвору). Напомним, что BJT — это устройство, управляемое током; то есть базовый ток контролирует величину тока коллектора. Полевой транзистор отличается. Это устройство, управляемое напряжением, где напряжение между двумя выводами (затвор и исток) управляет током через устройство.Основным преимуществом полевых транзисторов является их очень высокое входное сопротивление. Из-за своих нелинейных характеристик они обычно не так широко используются в усилителях, как BJT, за исключением случаев, когда требуются очень высокие входные сопротивления. Однако полевые транзисторы являются предпочтительным устройством в коммутационных приложениях низкого напряжения, потому что они, как правило, быстрее, чем BJT, при включении и выключении. БТИЗ обычно используется в высоковольтных коммутационных устройствах.
T HE JFET
8–1
◆
385
T HE JFET
JFET (переходный полевой транзистор) — это тип полевого транзистора, который работает с pn-переходом с обратным смещением для управления током в канал.В зависимости от своей структуры полевые транзисторы JFET делятся на две категории: n-канальный или p-канальный. После завершения этого раздела вы сможете ❏ ❏
❏ ❏
Обсудить JFET и его отличия от BJT Описать базовую структуру n-канальных и p-канальных JFET ◆ Назвать терминалы Объяснить канал ◆ Объяснить базовая операция JFET Идентификация условных обозначений JFET
Базовая структура На Рисунке 8–1 (a) показана базовая структура n-канального JFET (переходного полевого транзистора).К каждому концу n-канала подключаются выводы проводов; сток находится на верхнем конце, а исток — на нижнем. Две области p-типа рассеиваются в материале n-типа, образуя канал, и обе области p-типа соединяются с выводом затвора. Для простоты вывод затвора показан подключенным только к одной из p-областей. P-канальный JFET показан на Рисунке 8–1 (b). Дренаж
Дренаж
䊴
РИСУНОК 8– 1
p
n
Gate
p канал
p
Gate
n канал
Представление базовой структуры двух типов JFET .
n
Источник
Источник (b) p канал
(a) n канал
Основные операции Чтобы проиллюстрировать работу JFET, на рис. 8–2 показаны напряжения смещения постоянного тока, приложенные к n-канальному устройству. VDD обеспечивает напряжение сток-исток и подает ток от 䊴
RD
F I G U R E 8– 2
A смещенный n-канальный полевой транзистор JFET. D n G
+ p
p
— VGG
— +
n S
VDD
ИСТОРИЧЕСКАЯ СПРАВКА В 1952 году Иану Россу и Джорджу Дейси удалось создать униполярное устройство со структурой, аналогичной сегодняшнему JFET. .
386
◆
F IELD -E FFECT T RANSISTORS (FET S)
от истока до истока. VGG устанавливает напряжение обратного смещения между затвором и истоком, как показано. JFET всегда работает с обратным смещением pn перехода затвор-исток. Обратное смещение перехода затвор-исток с отрицательным напряжением затвора создает область обеднения вдоль pn-перехода, которая простирается в n-канал и, таким образом, увеличивает его сопротивление за счет ограничения ширины канала. Шириной канала и, следовательно, сопротивлением канала можно управлять, изменяя напряжение затвора, тем самым управляя величиной тока стока, I D.Рисунок 8–3 иллюстрирует эту концепцию. Белые области представляют собой область истощения, созданную обратным смещением. Он шире в направлении стока канала, потому что напряжение обратного смещения между затвором и стоком больше, чем между затвором и истоком. Мы обсудим характеристические кривые JFET и некоторые параметры в разделах 8–2.
RD —
VGS
—
+
p
VGG
RD ID
—
+
VGS
—
0005VDD
+
VGG
—
+
p
+
—
VDD
+
(a) JFET со смещением
000000 для проводимости Большой VGG сужает канал (между белыми областями), что увеличивает сопротивление канала и уменьшает ID.RD —VGS
—
+
p
VGG
— +
ID
+
p
+ VDD
—
канал между белые области), что снижает сопротивление канала и увеличивает ID.䊱FIG UR E 8 — 3
Влияние VGS на ширину канала, сопротивление и ток стока (VGG ⴝ VGS).
Символы JFET Схематические символы для n-канальных и p-канальных JFET показаны на Рисунке 8–4.Обратите внимание, что стрелка на затворе указывает «внутрь» для канала n и «выход» для канала p.
ХАРАКТЕРИСТИКИ JFET C
Дренаж (D)
Дренаж (D)
䊴
И
ПАРАМЕТРЫ
F I G U R E 8–4
Схематические символы JFET. Gate (G)
Gate (G)
Источник (S) n канал
РАЗДЕЛ 8–1 ПРОВЕРКА Ответы можно найти на сайте www. pearsonhighered.com/floyd.
8–2
Источник (S) p канал
1.Назовите три терминала JFET. 2. Требуется ли для n-канального JFET положительное или отрицательное значение для VGS? 3. Как регулируется ток стока в полевом транзисторе JFET?
ХАРАКТЕРИСТИКИ JFET C
И
ПАРАМЕТРЫJFET работает как управляемое напряжением устройство постоянного тока. В этом разделе рассматриваются характеристики отсечки и отсечки, а также переходные характеристики полевого транзистора. После завершения этого раздела вы сможете: ❏ ❏
❏ ❏ ❏ ❏ ❏ ❏
❏
❏ ❏
Обсудить, определить и применить характеристики и параметры JFET. , и области пробоя кривой. Определите напряжение отсечки. Обсудите пробой. Объясните, как напряжение затвор-исток управляет током стока. Обсудите напряжение отсечки. Сравните отсечку и отсечку. Объясните универсальную передаточную характеристику полевого транзистора. характеристическое уравнение ◆ Интерпретация таблицы данных JFET. Обсудить прямую крутизну JFET. ◆ Определить крутизну. ◆ Вычислить прямую крутизну. Обсудить входное сопротивление и емкость. ноль (VGS = 0 В).Это происходит путем замыкания затвора на источник, как показано на Рисунке 8–5 (a), где оба заземлены. По мере увеличения VDD (и, следовательно, VDS) с 0 В, ID будет увеличиваться пропорционально, как показано на графике на Рисунке 8–5 (b) между точками A и B. В этой области сопротивление канала практически постоянно, поскольку истощение область недостаточно велика, чтобы иметь значительный эффект. Это называется омической областью, потому что VDS и ID связаны по закону Ома. (Омическая область обсуждается далее в разделе 8–4.) В точке B на рисунке 8–5 (b) кривая выравнивается и входит в активную область, где ID становится практически постоянным. По мере увеличения VDS от точки B к точке C обратное смещение
◆
387
388
◆
F IELD -E FFECT T RANSISTORS (FET S)
ID
Омическая область VGS = 0
B
IDSS
C
RD VGD
ID
+
VDD
VDS VGS = 0
Активная область (постоянный ток)
— A 0
9000ET4 (a) JSF V и переменный VDS (VDD) 䊱VP (напряжение отсечки)
Пробой VDS
(b) Характеристики стока
FIG UR E 8-5
Кривая характеристики стока JFET для VGS ⴝ 0 показывает напряжение отсечки.
Напряжение между затвором и стоком (VGD) создает область обеднения, достаточно большую, чтобы компенсировать увеличение VDS, таким образом сохраняя ID относительно постоянным. Напряжение отсечки Для VGS = 0 В значение VDS, при котором ID становится практически постоянным (точка B на кривой на Рисунке 8–5 (b)), является напряжением отсечки, VP. Для данного JFET VP имеет фиксированное значение. Как видите, постоянное увеличение VDS выше напряжения отсечки обеспечивает почти постоянный ток стока. Это значение тока стока — IDSS (ток стока в источник с закороченным затвором) и всегда указывается в таблицах данных JFET.IDSS — это максимальный ток стока, который конкретный полевой транзистор JFET может производить независимо от внешней цепи, и он всегда указывается для условия, VGS = 0 В. Пробой Как показано на графике на Рисунке 8–5 (b), пробой происходит при точка C, когда ID начинает очень быстро увеличиваться при любом дальнейшем увеличении VDS. Поломка может привести к необратимому повреждению устройства, поэтому полевые транзисторы JFET всегда работают ниже уровня пробоя и в пределах активной области (постоянный ток) (между точками B и C на графике).Действие JFET, которое создает характеристическую кривую стока до точки пробоя для VGS = 0 В, показано на Рисунке 8–6.
VGS Controls ID Давайте подключим напряжение смещения VGG от затвора к источнику, как показано на Рисунке 8–7 (a). Поскольку VGS устанавливается на все более отрицательные значения путем регулировки VGG, создается семейство характеристических кривых стока, как показано на Рисунке 8-7 (b). Обратите внимание, что ID уменьшается, когда величина VGS увеличивается до больших отрицательных значений из-за сужения канала.Также обратите внимание, что при каждом увеличении VGS JFET достигает отсечки (где начинается постоянный ток) при значениях VDS меньше VP. Термин отсечка — это не то же самое, что и напряжение отсечки Vp. Следовательно, величина тока стока контролируется VGS, как показано на Рисунке 8–8.
Напряжение отсечки Значение VGS, которое делает ID приблизительно равным нулю, является напряжением отсечки, VGS (выключено), как показано на Рисунке 8-8 (d). JFET должен работать в диапазоне от VGS = 0 В до VGS (выключено). Для этого диапазона напряжений затвор-исток ID будет варьироваться от максимального значения IDSS до минимального почти нулевого.
ХАРАКТЕРИСТИКИ JFET C
И
ПАРАМЕТРЫ
0A RD
ID
—
RD
+
—
ID
+
DS
VDS
+
+ VDD = 0 В —
+ VDD —
(a) Когда VDS = 0, ID = 0.
(b) ID увеличивается пропорционально VDS в омической области. IDSS
RD
IDSS
ID
—
RD
+
—
ID
+
VP —
VDS
—
000000000 VDD —
+ VDD —
(c) Когда VDS = VP, ID постоянен и равен IDSS.䊱
(d) При дальнейшем увеличении VDS идентификатор остается на IDSS до тех пор, пока не произойдет сбой.
Ф ИГРА 8–6
Действие JFET, которое создает характеристическую кривую для VGS ⴝ 0 В.
ID IDSS
VGS = 0
VGS = –1 В
RD
VGS = –2 В + VDD VGG = 1 В
— +
(a) JFET смещен при VGS = –1 В 䊱
VGS = –3 В
—
VP = +5 В Отключение при VGS = –1 В (b ) Семейство характеристических кривых дренажа
РИСУНОК 8–7
Обрыв происходит при более низком VDS, когда VGS увеличивается до более отрицательных значений.
VGS = –4 В VGS = VGS (выкл.) = –5 В VDS
◆
389
390
◆
F IELD -E FFECT T RANSISTORS (FET S)
RD
—VGS
—
+
— VGG = 0 В +
RD
IDSS ID
—
+
VGS
—
+
VGDS = VGDS4 ≥ VP, ID = IDSS–
(b) Когда VGS отрицательный, ID уменьшается и остается постоянным выше отщипывания, которое меньше VP.VGS (выкл.)
RD VGS
—
+
—
ID
—
+
(c) По мере того, как VGS становится более отрицательным, ID продолжает уменьшаться, но остается постоянным выше защемления, который также снизился.䊱
—
+
ID
+
+ VDD
+
—
0A
VGS
VGG
VDD
0000004+
VDD
+
—
ID
+
VGG
VDD
—
—
+
— 9000V до
(выкл.), До
VG = ID продолжает уменьшаться.~ 0. Когда VGS ≥ –VGS (выкл.), ID =FIG UR E 8 — 8
ID контролей VGS.
Как вы видели, для n-канального JFET чем больше отрицательный VGS, тем меньший ID становится в активной области. Когда VGS имеет достаточно большое отрицательное значение, ID уменьшается до нуля. Этот эффект отсечки вызван расширением области истощения до точки, где она полностью закрывает канал, как показано на Рисунке 8–9.
䊳
FIG UR E 8 — 9
VGS (выкл.)
JFET в момент отсечки.-
— +
0A
VGS
—
+
p
VGG
RD
ID
+
p
+ 9000 pd4 — 9000 базовая операция -канальный JFET аналогичен n-канальному устройству, за исключением того, что для p-канального JFET требуется отрицательный VDD и положительный VGS, как показано на рис. 8–10.Сравнение напряжения отсечки и напряжения отсечки Как вы видели, существует разница между напряжениями отсечки и отсечки.Также есть связь. Напряжение отсечки VP — это значение VDS, при котором ток стока становится постоянным и равным IDSS и всегда измеряется при VGS = 0 В. Однако,
ХАРАКТЕРИСТИКИ JFET C
䊴
RD
И
ПАРАМЕТРЫ
◆
391
РИСУНОК 8–10
Полевой транзистор с р-каналом со смещением.
VGG
+
—
—
+
VDD
Отсечениепроисходит для значений VDS меньше VP, когда VGS не равно нулю.Таким образом, хотя VP является константой, минимальное значение VDS, при котором ID становится постоянным, зависит от VGS. VGS (выкл.) И VP всегда равны по величине, но противоположны по знаку. В таблице данных обычно указывается либо VGS (выкл.), Либо VP, но не оба сразу. Однако, когда вы знаете одно, у вас есть другое. Например, если VGS (выкл.) = -5 В, то VP = + 5 В, как показано на Рисунке 8–7 (b).
ПРИМЕР 8–1
Для JFET на Рисунке 8–11 VGS (выкл.) = -4 В и IDSS = 12 мА. Определите минимальное значение VDD, необходимое для перевода устройства в режим работы с постоянным током, когда VGS = 0 В.䊳
FIG UR E 8 — 1 1 RD 560 ⍀ + —
Решение
VDD
Так как VGS (выкл.) = -4 В, VP = 4 В. Минимальное значение VDS для JFET область постоянного тока составляет VDS = VP = 4 В В области постоянного тока с VGS ⫽ 0 В, ID = IDSS = 12 мА Падение на резисторе стока составляет VRD = IDRD = (12 мА) (560) = 6,72 V Примените закон Кирхгофа вокруг дренажного контура. VDD = VDS + VRD = 4 В + 6,72 В = 10,7 В Это значение VDD, чтобы сделать VDS = VP и перевести устройство в область постоянного тока.
Связанная проблема *
Если VDD увеличивается до 15 В, каков ток стока? *
Ответы можно найти на сайте www.pearsonhighered.com/floyd.
392
◆
F IELD -E FFECT T RANSISTORS (FET S)
ПРИМЕР 8–2
Конкретный p-канальный JFET имеет VGS (выкл.) = + 4 В. Что такое ID, когда VGS = + 6 В? Решение
Связанная проблема
Для p-канального JFET требуется положительное напряжение затвор-исток. Чем больше положительное напряжение, тем меньше ток стока.Когда VGS = 4 В, ID = 0. Любое дальнейшее увеличение VGS приводит к отключению JFET, поэтому ID остается 0. Что такое VP для JFET, описанного в этом примере?
Универсальная передаточная характеристика JFET Вы узнали, что диапазон значений VGS от нуля до VGS (выкл.) Управляет величиной тока стока. Для n-канального JFET VGS (выкл.) Отрицательно, а для p-канального JFET VGS (выкл.) Положительно. Поскольку VGS действительно контролирует ID, взаимосвязь между этими двумя величинами очень важна. На рис. 8–12 представлена общая кривая передаточной характеристики, которая графически иллюстрирует взаимосвязь между VGS и ID.Эта кривая также известна как кривая крутизны.䊳
FI G URE 8–12
ID
Универсальная передаточная характеристика JFET (n-канальный).
IDSS
IDSS 2 IDSS 4
–VGS
VGS (выкл.)
0,5VGS (выкл.) 0,3VGS (выкл.)
0
Обратите внимание, что нижний конец кривой находится в точке на Ось VGS равна VGS (выкл.), А верхний конец кривой находится в точке на оси ID, равной IDSS. Эта кривая показывает, что ID = 0, когда VGS = VGS (выкл.) IDSS ID =, когда VGS = 0.5VGS (выкл.) 4 IDSS ID = при VGS = 0,3VGS (выкл.) 2 и ID = IDSS
при VGS = 0
Кривая передаточной характеристики также может быть построена из характеристических кривых стока путем нанесения значений ID для значений VGS взяты из семейства дренажных кривых при отсечке, как показано на Рисунке 8–13 для конкретного набора кривых. Каждая точка на кривой передаточной характеристики соответствует определенным значениям VGS и ID на кривых стока. Например, когда VGS = -2 В, ID = 4.32 мА. Кроме того, для этого конкретного JFET VGS (выкл.) = -5 В и IDSS = 12 мА.
ХАРАКТЕРИСТИКИ JFET C
И
ПАРАМЕТРЫ
◆
ID (мА) IDSS
VGS = 0
12
7,68 мА
8
В
VGS = –2 В
4 1,92 мА
–VGS (В)
2
VGS = –3 В
0,48 мА 0 мА –5
–4
VGS = — 4 В –3
–2
–1
0
0
5
10
15
VDS (V)
VGS (выкл.) 䊱
ИЗОБРАЖЕНИЕ 8–13
Пример разработки Передаточная характеристика n-канального JFET (синяя) из характеристических кривых стока JFET (зеленая).
Кривая передаточной характеристики JFET приблизительно выражается как ID ⬵ IDSS a1 ⴚ
VGS VGS (off)
2
Уравнение 8–1
b
С помощью уравнения 8–1 можно определить ID для любого VGS. если известны VGS (выкл.) и IDSS. Эти количества обычно доступны из таблицы данных для данного JFET. Обратите внимание на квадрат в уравнении. Из-за своей формы параболическая зависимость известна как квадратичный закон, и поэтому полевые транзисторы JFET и MOSFET часто называют устройствами квадратичного закона.Таблица данных типичной серии полевых транзисторов JFET показана на рис. 8–14.
ПРИМЕР 8–3
Частичная таблица данных на Рисунке 8–14 для JFET 2N5459 показывает, что обычно IDSS 9 мА и VGS (выкл.) = -8 В (максимум). Используя эти значения, определите ток стока для VGS = 0 В, -1 В и -4 В. Решение
Для VGS ⫽ 0 В, ID = IDSS = 9 мА Для VGS = -1 В используйте уравнение 8–1. . -1 В 2 b VGS (выкл.) -8 В = (9 мА) (1 — 0,125) 2 = (9 мА) (0,766) = 6,89 мА
ID ⬵ IDSS a1 —
VGS
2
b = (9 мА) a1 —
Для VGS = -4 В, ID ⬵ (9 мА) a1 Связанная проблема
-4 В 2 b = (9 мА) (1 — 0.5) 2 = (9 мА) (0,25) = 2,25 мА -8 В
Определите ID для VGS = -3 В для 2N5459 JFET.
393
394
䊳
◆
F IELD -E FFECT T RANSISTORS (FET S)
FI G URE 8–14
JFET частичное техническое описание. Авторское право Fairchild Semiconductor Corporation. Используется с разрешения.
MMBF5457 MMBF5458 MMBF5459
2N5457 2N5458 2N5459
G
SG
S
TO-92
SOT-23
D
взаимозаменяемых 61S / 6LN-канальный усилитель общего назначения Это устройство представляет собой звуковой усилитель низкого уровня и переключающие транзисторы, и может использоваться для аналоговых коммутационных приложений.Источник процесса 55.
Абсолютные максимальные номинальные характеристики * Символ
TA = 25 ° C, если не указано иное
Параметр
Значение
VDG
Напряжение сток-затвор
VGS
Напряжение затвор-исток
IGF
Прямой ток затвора
TJ, Tstg
Диапазон температур перехода при эксплуатации и хранении
Ед.
* Эти номинальные значения являются предельными значениями, превышение которых может ухудшить работоспособность любого полупроводникового прибора.ПРИМЕЧАНИЯ: 1) Эти номинальные значения основаны на максимальной температуре перехода 150 градусов C. 2) Это пределы устойчивого состояния. По вопросам применения, включающего импульсные или малые рабочие циклы, следует проконсультироваться с заводом-изготовителем.
Тепловые характеристики Обозначение PD
TA = 25 ° C, если не указано иное
Характеристика
Макс.
RθJC
Снижение общего теплового излучения устройства выше 25 ° C Тепловое сопротивление, переход к корпусу
RθJA
Тепловое сопротивление к окружающей среде
Единицы
2N5457-5459 625 5.0 125
* MMBF5457-5459 350 2,8
357
556
мВт мВт / C C / Вт ⬚C / Вт
* Устройство установлено на печатной плате FR-4 1,6 «X 1,6″ X 0,06. »
Электрические характеристики
Символ
TA = 25 ° C, если не указано иное
Параметр
Условия испытаний
Мин.
IG = 10 A, VDS = 0 VGS = -15 V, VDS = 0 VGS = — 15 В, VDS = 0, TA = 100 C 5457 VDS = 15 В, ID = 10 нА 5458 5459 VDS = 15 В, ID = 100 A 5457 VDS = 15 В, ID = 200 A 5458 VDS = 15 В , ID = 400 A 5459
-25
Тип
Максимальное количество единиц
ХАРАКТЕРИСТИКИ ВЫКЛ V (BR) GSS
Напряжение пробоя затвор-исток
IGSS
Обратный ток затвора
VGS
(выкл.) Напряжение отсечки затвор-исток
VGS
Напряжение затвор-исток
В — 1.0 — 200 — 6,0 — 7,0 — 8,0
нА нА VVVVVV
3,0 6,0 9,0
5,0 9,0 16
мА мА мА
mhos mhos mhos mhos
pF
— 0,5 — 1,0 — 1,0 — — 2,5 — 3,5 — 4,5
ON ХАРАКТЕРИСТИКИ IDSS
Ток утечки напряжения с нулевым затвором *
VDS = 15 В, VGS = 0
5457 5458 5459
1.0 2.0 4.0
ХАРАКТЕРИСТИКИ МАЛЫХ СИГНАЛОВ * 9000 Проводимость прямого переключения
gos
Выходная проводимость *
VDS = 15 В, VGS = 0, f = 1.0 кГц 5457 5458 5459 VDS = 15 В, VGS = 0, f = 1,0 кГц
10
5000 5500 6000 50
Ciss
Входная емкость
VDS = 15 В, VGS = 0, f = 1,0 МГц
4,5
7,0
Crss NF
Обратная передаточная емкость
VDS = 15 В, VGS = 0, f = 1,0 МГц
1,5
3,0
пФ
Уровень шума
VGS = = 0, f = 1,0 кГц, RG = 1,0 МОм, BW = 1,0 Гц
3.0
дБ
gfs
* Импульсный тест: ширина импульса ≤ 300 мс, рабочий цикл ≤ 2%
1000 1500 2000
ХАРАКТЕРИСТИКИ JFET C
И
ПАРАМЕТРЫ
◆
прямая крутизна (передаточная проводимость), gm, представляет собой изменение тока стока (¢ ID) при заданном изменении напряжения затвор-исток (VGS) при постоянном напряжении сток-исток. Он выражается в виде отношения и измеряется в сименсах (S).gm =¢ ID ¢ VGS
Другие общие обозначения для этого параметра — gfs и yfs (прямая пропускная способность). Как вы увидите в главе 9, gm является важным фактором при определении коэффициента усиления по напряжению усилителя на полевых транзисторах. Поскольку кривая передаточной характеристики для полевого транзистора является нелинейным, значение gm изменяется в зависимости от положения на кривой, установленного VGS. Значение gm больше в верхней части кривой (около VGS 0), чем в нижней части (около VGS (выключено)), как показано на Рисунке 8–15.䊴
ID
г варьируется в зависимости от точки смещения (VGS).
IDSS
2
⌬ID2
РИСУНОК 8–15
гм2 =
⌬ID2 ⌬VGS
гм2> гм1 1 –VGS VGS (выкл.)
ID1ID1
gm1 =
⌬ID1 ⌬VGS
0 VGS = 0
Таблица данных обычно дает значение gm, измеренное при VGS ⫽ 0 В (gm0). Например, в таблице данных для JFET 2N5457 указано минимальное значение gm0 (gfs), равное 1000 mmhos (mho — это та же единица, что и сименс (S)) с VDS 15 В.Учитывая gm0, вы можете рассчитать приблизительное значение gm в любой точке кривой передаточной характеристики, используя следующую формулу: gm ⴝ gm0 a1 ⴚ
VGS VGS (off)
b
Уравнение 8–2
Когда значение gm0 недоступен, вы можете рассчитать его, используя значения IDSS и VGS (выкл.). Вертикальные линии указывают абсолютное значение (без знака). gm0 ⴝ
ПРИМЕР 8–4
2IDSS 円 VGS (выкл.) 円
Уравнение 8–3
Следующая информация включена в таблицу данных на рис. 8–14 для 2N5457 JFET: обычно IDSS ⫽ 3.0 мА, VGS (выкл.) = -6 В максимум и gfs (макс.) = 5000 мс. Используя эти значения, определите прямую крутизну для VGS = -4 В и найдите ID в этой точке.
395
396
◆
F IELD -E FFECT T RANSISTORS (FET S)
Solution
gm0 = gfs = 5000 мс. Используйте уравнение 8–2 для расчета gm. gm = gm0 a1 —
VGS VGS (off)
b = (5000 mS) a1 —
-4 V b = 1667 MS -6 V
Затем используйте уравнение 8–1 для вычисления ID при VGS = — 4 В.ID ⬵ IDSS a1 Проблема, связанная с
VGS VGS (выкл.)
2
b = (3,0 мА) a1 —
-4 В 2 b = 333 MA -6 В
Данный JFET имеет следующие характеристики: IDSS = 12 мА, VGS (выкл.) = -5 В и gm0 = gfs = 3000 мс. Найдите gm и ID, когда VGS = -2 В.
Входное сопротивление и емкость Как вы знаете, JFET работает с обратным смещением на переходе затвор-исток, что делает входное сопротивление затвора очень высоким. Такое высокое входное сопротивление является одним из преимуществ JFET над BJT.(Напомним, что биполярный транзистор работает с переходом база-эмиттер с прямым смещением.) В таблицах данных JFET часто указывается входное сопротивление, задавая значение обратного тока затвора, IGSS, при определенном напряжении затвор-исток. Входное сопротивление затем может быть определено с помощью следующего уравнения, где вертикальные линии указывают абсолютное значение (без знака): RIN = `
VGS` IGSS
Например, в таблице данных 2N5457 на рис. 8–14 указано максимальное значение IGSS. -1,0 нА для VGS = -15 В при 25 ° C.IGSS увеличивается с ростом температуры, поэтому входное сопротивление уменьшается. Входная емкость Ciss является результатом работы полевого транзистора с обратносмещенным pn переходом. Напомним, что pn-переход с обратным смещением действует как конденсатор, емкость которого зависит от величины обратного напряжения. Например, 2N5457 имеет максимальное значение Ciss 7 пФ для VGS 0.
ПРИМЕР 8–5
Определенный JFET имеет IGSS -2 нА для VGS = -20 В. Определите входное сопротивление. Решение
Связанная проблема
RIN = `
VGS 20 V` = = 10,000 Mæ IGSS 2 nA
Определите входное сопротивление для 2N5458 из таблицы на Рис. 8–14.
Сопротивление сток-исток переменного тока Из кривой характеристики стока вы узнали, что выше отсечки ток стока относительно постоянен в диапазоне напряжений сток-исток. Следовательно, большое изменение в VDS приводит только к очень маленькому изменению идентификатора. Отношение этих изменений и есть сопротивление сток-источник переменного тока устройства, r¿ds. r¿ds =
¢ VDS ¢ ID
В технических описаниях этот параметр часто указывается в терминах выходной проводимости, gos, или выходной проводимости, yos, для VGS ⫽ 0 В.
% PDF-1.2 % 124 0 объект > эндобдж xref 124 87 0000000016 00000 н. 0000002091 00000 н. 0000002784 00000 н. 0000003002 00000 п. 0000003176 00000 п. 0000003334 00000 н. 0000003512 00000 н. 0000003723 00000 н. 0000004064 00000 н. 0000004351 00000 п. 0000004590 00000 н. 0000004801 00000 п. 0000005027 00000 н. 0000005257 00000 н. 0000005486 00000 н. 0000005679 00000 н. 0000006126 00000 н. 0000006427 00000 н. 0000006730 00000 н. 0000007158 00000 н. 0000007537 00000 н. 0000007859 00000 п. 0000013480 00000 п. 0000013565 00000 п. 0000013669 00000 п. 0000014010 00000 п. 0000015139 00000 п. 0000015246 00000 п. 0000015358 00000 п. 0000015720 00000 п. 0000016139 00000 п. 0000016503 00000 п. 0000016744 00000 п. 0000016855 00000 п. 0000017024 00000 п. 0000017238 00000 п. 0000017397 00000 п. 0000017563 00000 п. 0000018071 00000 п. 0000018458 00000 п. 0000018852 00000 п. 0000019263 00000 п. 0000019580 00000 п. 0000019691 00000 п. 0000020055 00000 н. 0000020290 00000 н. 0000020446 00000 п. 0000020679 00000 п. 0000021010 00000 п. 0000021277 00000 п. 0000021485 00000 п. 0000021807 00000 п. 0000022194 00000 п. 0000022468 00000 п. 0000022813 00000 п. 0000023006 00000 п. 0000023304 00000 п. 0000023463 00000 п. 0000023766 00000 п. 0000024106 00000 п. 0000024530 00000 п. 0000024816 00000 п. 0000025189 00000 п. 0000025426 00000 п. 0000025721 00000 п. 0000026370 00000 п. 0000026678 00000 п. 0000026932 00000 п. 0000027226 00000 п. 0000027615 00000 н. 0000027638 00000 п. 0000030396 00000 п. 0000030419 00000 п. 0000032707 00000 п. 0000032730 00000 н. 0000035476 00000 п. 0000035499 00000 н. 0000037713 00000 п. 0000037736 00000 п. 0000040221 00000 п. 0000040244 00000 п. 0000042465 00000 п. 0000042488 00000 п. 0000044725 00000 п. 0000044748 00000 п. 0000002148 00000 н. 0000002762 00000 н. трейлер ] >> startxref 0 %% EOF 125 0 объект > эндобдж 209 0 объект > транслировать Hc«a`Ha`g`sd` @
Масштабирование длины канала в микроволновых графеновых полевых транзисторах
Аннотация
Чтобы работать на микроволновых частотах и выше, длина канала полевого транзистора должна быть очень короткой ($ \ sim25 $ нм при 1 ТГц), чтобы минимизировать входную емкость и время дрейфа носителей через канал.Однако это масштабирование не может продолжаться бесконечно, поскольку эффекты короткого канала ограничивают производительность полевого транзистора при очень малой длине затвора. Эти эффекты в значительной степени обусловлены ухудшением способности затвора электростатически управлять легированием канала, поскольку расстояние от затвора до канала и конечная толщина канала 2DEG становятся сопоставимыми с длиной канала. Этого геометрического ограничения можно избежать, используя графен, двумерный материал с нулевой запрещенной зоной, состоящий из атомов углерода на гексагональной решетке, в качестве материала канала из-за его высокой подвижности носителей, истинно атомной толщины и способности интегрироваться с другими элементами ванны. материалы дер Ваальса для сверхтонких диэлектриков затвора.В настоящее время трудность создания электрических контактов с низким сопротивлением к графену и отсутствие поведения насыщения в графеновых транзисторах с коротким каналом приводят к плохим характеристикам ВЧ, особенно для устройств с коротким каналом. В этой диссертации мы стремимся изучить поведение масштабирования длины канала в однослойных графеновых полевых транзисторах и изучить перспективы их использования в качестве высокочастотных транзисторов. Чтобы достичь наивысшей собственной подвижности и скорости насыщения, а также минимизировать паразитные эффекты контактного сопротивления, мы используем самые современные технологии изготовления для создания расслоенных гексагональных транзисторов с графеновым полевым эффектом, инкапсулированных гексагональным нитридом бора.Мы встраиваем эти транзисторы в микроволновую схему, предназначенную для точной калибровки и устранения встраивания. Измерения линейного отклика по постоянному и переменному току нескольких полевых транзисторов с длиной затвора от 1 до 140 нм были выполнены и проанализированы путем подгонки комплексных данных S-параметров к модели эквивалентной схемы малосигнального полевого транзистора. Эти измерения демонстрируют характеристики насыщения в устройстве 1 $ \ mu $ m, вероятно, вызванные насыщением скорости из-за зависящего от энергии излучения оптических фононов. Однако для устройств с коротким каналом наблюдается явная потеря характеристик насыщения, возможно, возникающая из-за большей, чем ожидалось, длины свободного пробега излучения оптических фононов или других механизмов индуцированной проводимости с высоким смещением, которые конкурируют с излучением оптических фононов.Даже в этом случае графеновые полевые транзисторы, изготовленные в этой диссертации, представляют собой современные характеристики f $ _T $ и f $ _ {max} $ для длины их каналов, в частности, 140-нм GFET с f $ _T> 300 $ ГГц. В отличие от работы усилителей GFET с сильным полем и высокой плотностью несущих, при смещении около точки Дирака с нулевой плотностью состояний проводимость графена с низким полем демонстрирует явно нелинейное поведение по отношению к напряжению на затворе. Используя эту нелинейность для выпрямления падающих волн напряжения, GFET может быть превращен в очень широкополосный детектор мощности.В GFET-транзисторе с длиной затвора 1 $ \ mu $ m при 30K, чувствительность от 1 до 20 ГГц, равная 55 В / Вт, достигается с эквивалентной мощностью шума, ограниченной показанием комнатной температуры до 1 нВт / $ \ sqrt {\ mathrm {Hz}. } $.Условия эксплуатации
Эта статья доступна в соответствии с условиями, применимыми к Другим размещенным материалам, как указано на http://nrs.harvard.edu/urn-3:HUL.InstRepos:dash.current.terms-of-use#LAAЦитируемая ссылка на эту страницу
http: // nrs.harvard.edu/urn-3:HUL.InstRepos:40050148 Металлооксидный полупроводниковый полевой транзисторс N-каналом, использующий либо Уравнение Шичмана-Ходжеса или модель на основе поверхностного потенциала
Описание
N-канальный блок MOSFET обеспечивает два основных моделирования варианты:
На основе порогового напряжения — использует уравнение Шичмана-Ходжеса для представления устройство. Этот подход к моделированию, основанный на пороговом напряжении, имеет преимущества простого параметризация и простые вольт-амперные выражения.Однако у этих моделей есть трудности. в точном захвате переходов через пороговое напряжение и отсутствии некоторых важных эффекты, такие как насыщение скорости. Для получения дополнительной информации см. Модель на основе пороговых значений.
Этот вариант предоставляет четыре способа параметризации N-канального MOSFET:
путем указания параметров из таблицы.
Путем прямого указания параметров уравнения.
Посредством аппроксимации двухмерной справочной таблицы для кривой I-V (ток-напряжение).Подробнее см. Представление двумерной таблицей поиска.
Посредством аппроксимации 3-D интерполяционной таблицы кривой I-V (ток-напряжение), которая включает данные о температуре. Подробнее см. В разделе «Представление с помощью трехмерной таблицы поиска».
На основе поверхностного потенциала — использует уравнение поверхностного потенциала для представления устройство. Такой подход к моделированию обеспечивает более высокий уровень точности модели, чем простой квадратичные модели (основанные на пороговом напряжении) могут обеспечить.Компромисс в том, что есть больше параметры, требующие извлечения. Для получения дополнительной информации см. Модель на основе поверхностного потенциала.
Вместе с вариантами теплового порта (см. Тепловой порт), Таким образом, блок предоставляет вам четыре варианта. Чтобы выбрать нужный вариант, щелкните правой кнопкой мыши блок в вашей модели. В контекстном меню выберите> , а затем один из следующих вариантов:
— Базовая модель, представляющая устройство, использующее уравнение Шичмана-Ходжеса (основанное на пороговом напряжении) и не моделирующее тепловые эффекты.Это значение по умолчанию.
— Модель на основе порога напряжение и с открытым тепловым портом.
— Модель на основе поверхности потенциал. Эта модель не моделирует тепловые эффекты.
— Тепловой вариант модели на основе поверхностного потенциала.
Модель на основе порогов
Вариант блока, основанный на порогах, использует уравнения Шичмана и Ходжеса [1] для полевого транзистора с изолированным затвором для представления N-канального MOSFET.
Ток сток-исток, I DS , зависит от регион присутствия:
В отключенном регионе ( В GS < В -й ) ток сток-исток:
В линейной области (0 < В DS < В GS — В -й ), ток сток-исток:
В насыщенной области (0 < В GS — V th < В DS ) ток сток-исток:
В предыдущих уравнениях:
K — коэффициент усиления транзистора.
В DS положительный сток-исток Напряжение.
В GS — напряжение затвор-исток.
V th — пороговое напряжение. Для четырех параметрирование клемм, V th получается с помощью эти уравнения:
V BS Диапазон V th Уравнение VBS≤0 Vth = VTϕ0 + −VS (−2 ) 0 Vth = VT0 − γVBS2ϕB VBS> 4ϕB Vth = VT0 + γ (−2ϕB) - модуляция канала λ900.
Модель заряда для порогового варианта
Емкости перехода блочного блока моделируются либо фиксированными значениями емкости, либо табулированными значениями емкости. значения как функция напряжения сток-исток. В любом случае вы можете либо напрямую укажите значения емкости переходов затвор-исток и затвор-сток или позвольте блоку получить их от значений входной и обратной передаточной емкости. Следовательно Параметрирование вариантов модели заряда на Емкость Вкладка :
Укажите фиксированную входную, обратную передаточную и выходную емкость— Предоставьте фиксированные значения параметров из таблицы и позвольте блоку преобразовать ввод и значения емкости обратного перехода к значениям емкости перехода, как описано ниже.Этот это метод по умолчанию.Укажите фиксированные затвор-исток, затвор-сток и сток-исток емкость— Обеспечьте фиксированные значения для параметров емкости перехода напрямую.Укажите табулированный ввод, обратный перенос и вывод емкость— Укажите емкость и напряжение сток-исток в таблице. значения основаны на графиках таблицы данных. Блок преобразует входную и обратную передаточную емкость. значения к значениям емкости перехода, как описано ниже.Укажите табулированные затвор-исток, затвор-сток и сток-исток емкость— Укажите табличные значения емкостей перехода и напряжение сток-исток.
Используйте одну из табличных опций емкости ( Укажите табулированный вход, обратное
передаточная и выходная емкость или Укажите в таблице затвор-исток,
емкость затвор-сток и сток-исток ), когда в таблице данных приводится график
емкости перехода как функция напряжения сток-исток.Использование табличных значений емкости
дает более точные динамические характеристики и исключает необходимость интерактивной настройки
параметры подгонять под динамику.
Если вы используете Укажите фиксированные затвор-исток, затвор-сток и сток-исток
емкость или Укажите табулированные затвор-исток, затвор-сток и
Емкость сток-исток , вкладка Емкость позволяет
вы указываете емкость перехода затвор-сток , затвор-исток
емкость перехода и емкость перехода сток-исток значения параметров (фиксированные или табличные) напрямую.В противном случае блок выводит их из Входная емкость, Ciss , Обратная передаточная емкость,
Crss и Выходная емкость, значения параметра Coss . Эти двое
методы параметризации связаны следующим образом:
C GD = Crss
C GS = Ciss — Crss
C DS = Coss — Crss
Для параметризации четырех клемм входная емкость , Ciss , Обратная передаточная емкость, Crss и Выходная емкость, Coss получаются с помощью следующих уравнений:
Упрощенная модель емкости Мейера используется для описания емкости затвор-исток, C GS , объемная емкость затвора, C GB , а емкость затвор-сток, С ГД .Эти цифры показывают, как ворота-насыпь и Емкости затвор-исток изменяются мгновенно, в то время как
Емкость затвор-затвор и затвор-исток изменяются мгновенно.
Два варианта фиксированной емкости ( Укажите фиксированный вход, обратную передачу и
выходная емкость или Укажите фиксированные затвор-исток, затвор-сток и
емкость сток-исток ) позволяют моделировать емкость затворного перехода как фиксированную
емкость затвор-исток C GS и либо фиксированная, либо
нелинейная емкость затвор-сток C GD .Если вы выберете функция заряда затвор-сток является нелинейной опцией для Линейность заряда-напряжения затвор-сток параметр, затем заряд затвор-сток
взаимосвязь определяется кусочно-линейной функцией, показанной на следующем рисунке.
Для получения инструкций о том, как сопоставить временную характеристику со значениями емкости устройства, см. Справочная страница блока N-Channel IGBT. Однако это отображение является лишь приблизительным. потому что напряжение Миллера обычно больше отличается от порогового напряжения, чем в случае БТИЗ.
Примечание
Поскольку эта блочная реализация включает модель заряда, вы должны смоделировать импеданс схема, управляющая воротами, для получения репрезентативной динамики включения и выключения. Следовательно, если вы упрощаете схему управления затвором, представляя ее как управляемое напряжение источник, вы должны включить подходящий последовательный резистор между источником напряжения и ворота.
Представление в виде двухмерной таблицы поиска
Для представления подробного варианта блока в таблице поиска вы предоставляете табличную значения токов сток-исток в зависимости от напряжения затвор-исток и напряжения сток-исток.Основное преимущество использования этой опции — скорость моделирования. Это также позволяет вам параметризовать устройство либо из измеренных данных, либо из данных, полученных в результате другого моделирования среда.
На этом рисунке показана реализация опции двумерной таблицы поиска при установке Параметризация Ids-Vds — Обеспечивает отрицательный и положительный Vds
данные :
На этом рисунке показана реализация опции двумерной таблицы поиска при установке Параметризация Ids-Vds от до Обеспечивает положительные данные Vds
только :
Для четырехполюсного МОП-транзистора вычисляются значения поверхностного потенциала и объемного фактора. на основе ближайшего порогового напряжения, как показано на этом рисунке:
Представление в виде трехмерной таблицы поиска
Для представления зависимой от температуры таблицы поиска подробного варианта блока, вы предоставляете табличные значения токов сток-исток в зависимости от напряжения затвор-исток, напряжение сток-исток и температура.
Модель на основе поверхностного потенциала
Вариант блока на основе поверхностного потенциала обеспечивает более высокий уровень точности модели чем простая квадратичная (основанная на пороговом напряжении) модель. Блок на основе поверхностного потенциала Вариант включает следующие эффекты:
Полностью нелинейная модель емкости (включая нелинейную емкость Миллера)
Сохранение заряда внутри модели, поэтому вы можете использовать модель для чувствительных к заряду моделирования
Насыщение скорости и модуляция длины канала
Внутренний диод
Обратное восстановление в модели основного диода
Температурное масштабирование физических параметров
- динамический вариант
самонагревание (то есть можно смоделировать действие самонагрев на электрических характеристиках устройства)
Данная модель является минимальной версией модели PSP мирового стандарта (см. https: //riefs.techconnect.org/papers/introduction-to-psp-mosfet-model/), включая только определенные эффекты из модели PSP, чтобы найти баланс между моделями верность и сложность. Для получения подробной информации о физических предпосылках явлений, включенных в эту модель см. [2].
В основе модели лежит уравнение Пуассона:
где:
ψ — электростатический потенциал.
q — величина электронного заряда.
N A — плотность акцепторов в субстрат.
ɛ Si — диэлектрическая проницаемость полупроводниковый материал (например, кремний).
ϕ B — разница между внутренним Уровень Ферми и уровень Ферми в объемном кремнии.
V CB — квазиферми-потенциал поверхностный слой относительно массы.
ϕ T — тепловое напряжение.
k B — постоянная Больцмана.
T — температура.
Уравнение Пуассона используется для вывода уравнения поверхностного потенциала:
где:
В GB — это приложенное напряжение затвора.
В FB — напряжение плоской полосы.
ψ s — потенциал поверхности.
γ — фактор тела,
Блок использует явную аппроксимацию уравнения поверхностного потенциала, чтобы избежать необходимость численного решения этого неявного уравнения.
Как только поверхностный потенциал известен, ток стока I D определяется как
, где:
W — ширина устройства.
L — длина канала.
μ 0 — подвижность в низком поле.
θ sat — насыщение скорости.
Δψ — разность поверхностного потенциала между стоком и источник.
Q inv0 и В invL являются плотностью инверсии заряда на исток и сток соответственно.
Q¯inv — средняя плотность инверсионного заряда в канале.
G mob — коэффициент снижения мобильности. Для для получения дополнительной информации см. параметр Коэффициент рассеяния шероховатости поверхности описание в главном разделе (вариант на основе поверхностного потенциала).
G ΔL — модуляция длины канала.
где:
α — коэффициент модуляции длины канала.
В DB — напряжение сток-тело.
V DB, eff — напряжение стока, ограниченное максимальное значение, соответствующее насыщению скорости или отсечке (в зависимости от того, что происходит первый).
V p — модуляция длины канала Напряжение.
Блок вычисляет плотности инверсионных зарядов непосредственно с поверхности потенциал.
Блок также вычисляет нелинейные емкости из поверхностного потенциала. Источник и Вклады в плату за сток назначаются через разделение заряда по Уорду-Даттону, зависящее от смещения. схема, как описано в [3]. Эти сборы рассчитываются явно, поэтому эта модель сохраняет заряд. Емкостный токи вычисляются путем взятия производных по времени соответствующих зарядов. На практике заряды в моделировании нормируются на емкость оксида и вычисляются в единицах вольт.
Коэффициент усиления полевого МОП-транзистора β определяется как
Пороговое напряжение для короткозамкнутого соединения исток-массив приблизительно равно по
, где:
Общие модели с тремя и четырьмя клеммами состоят из внутреннего полевого МОП-транзистора, определяемого формула поверхностного потенциала, корпусный диод, последовательные сопротивления и фиксированные емкости перекрытия, как показано на схемах.
Modeling Body Diode
Блок моделирует основной диод либо как идеальный экспоненциальный диод, либо как табулированный диод.
Экспоненциальный диод Когда вы устанавливаете модельный диод корпуса на Экспоненциальная , переходная и диффузионная емкости равны:
где:
I dio — ток через диод.
I с — обратный ток насыщения.
В DB — напряжение сток-тело.
n — коэффициент идеальности.
ϕ T — тепловое напряжение.
C j — емкость перехода диод.
C j0 — переход без смещения емкость.
V bi — встроенное напряжение.
C diff — диффузионная емкость диод.
τ — время прохождения.
Емкости определяются путем явного расчета зарядов, которые затем дифференцированы, чтобы дать емкостные выражения выше. Блок вычисляет емкостную токи диодов как производные по времени соответствующих зарядов, аналогично вычислению в Модель MOSFET на основе поверхностного потенциала.
Табулированный диод Чтобы смоделировать табулированный диод, установите для параметра Body diode значение Таблица ВАХ .На этом рисунке показана реализация
вариант табличного диода:
При выборе этой параметризации необходимо предоставить данные для прямого смещения. Только.
Блок реализует диод с использованием опции плавной интерполяции. Если диод превышает предоставленный диапазон табличных данных, блок использует метод линейной экстраполяции на последнем точка данных напряжение-ток.
Примечание
Табулированный диод не моделирует обратный пробой.
Моделирование температурной зависимости
По умолчанию зависимость от температуры не моделируется, а устройство
моделируется при температуре, для которой вы указываете параметры блока. Для моделирования зависимости от
температура во время моделирования, выберите Температурная зависимость модели для параметра Параметризация на Температура
Зависимость табл.
Модель на основе порога
Для варианта на основе порога вы можете включить моделирование зависимости транзистора статическое поведение при изменении температуры во время моделирования.Температурная зависимость спая емкости не моделируются, это гораздо меньший эффект.
При учете температурной зависимости уравнения, определяющие транзистор, остаются прежними. Коэффициент усиления К и пороговое напряжение V th , становится функцией температуры в соответствии с следующие уравнения:
V тыс. = В th2 + α ( T с — T m1 )
где:
T m1 — температура, при которой транзистор параметры указаны, как определено в Измерение температуры значение параметра.
T с — температура моделирования.
K Tm1 — коэффициент усиления транзистора при измерении. температура.
K Ts — коэффициент усиления транзистора при моделировании. температура. Это значение усиления транзистора, используемое в уравнениях MOSFET, когда температура моделируется зависимость.
В th2 — пороговое напряжение на температура измерения.
В тыс. — пороговое напряжение на температура моделирования. Это значение порогового напряжения, используемое в уравнениях MOSFET, когда моделируется температурная зависимость.
BEX — температурный показатель подвижности. Типичное значение BEX составляет -1,5.
α — температурный коэффициент порогового напряжения затвора, d V th / d T .
Для параметризации четырех клемм В th получено с помощью этих уравнений: